Der Chip ist auf der Leiterplatte verpackt, Der Halbleiterchip wird auf der Leiterplatte platziert, die elektrische Verbindung zwischen dem Chip und dem PCB-Substrat wird durch Drahtnähen realisiert, und die elektrische Verbindung zwischen dem Chip und dem Substrat wird durch Drahtnähen realisiert, und es ist mit Harz bedeckt, um Zuverlässigkeit zu gewährleisten. Obwohl COB die einfachste Bare-Chip-Montagetechnologie ist, Die Verpackungsdichte ist der TAB- und Flip-Chip-Klebetechnik weit unterlegen.
Das Chip-on-Board-Verfahren (COB) besteht darin, zuerst den Siliziumwafer-Platzierungspunkt mit einem thermisch leitfähigen Epoxidharz (im Allgemeinen silberdotiertes Epoxidharz) auf der Oberfläche des Substrats zu bedecken und dann den Siliziumwafer direkt auf der Oberfläche des Substrats und Wärmebehandlung zu platzieren, bis der Siliziumchip fest auf dem Substrat befestigt ist. Dann wird Drahtbonding verwendet, um direkt eine elektrische Verbindung zwischen dem Siliziumchip und dem Substrat herzustellen.
Im Vergleich zu anderen Verpackungstechnologien, COB-Technologie ist kostengünstig, platzsparend, und reif. Allerdings, any* technology was impossible to be perfect when it first appeared. Die COB-Technologie hat auch Nachteile wie die Notwendigkeit zusätzlicher Schweißmaschinen und Verpackungsmaschinen, Manchmal kann die Geschwindigkeit nicht mithalten, und die strengeren Umweltanforderungen der PCB Patch und die Unfähigkeit, es aufrechtzuerhalten.
Bestimmte Chip-on-Board (CoB)-Layouts können die Leistung des IC-Signals verbessern, da sie den Großteil oder das gesamte Paket entfernen, d.h. die meisten oder alle parasitären Komponenten entfernen. Bei diesen Technologien kann es jedoch zu Leistungsproblemen kommen. In all diesen Ausführungen kann das Substrat aufgrund des Lead Frame Chips oder BGA Logos nicht gut mit VCC oder Masse verbunden sein. Mögliche Probleme sind Probleme mit Wärmeausdehnungskoeffizienten (CTE) und schlechte Substratverbindungen.
Die wichtigsten Schweißmethoden von COB:
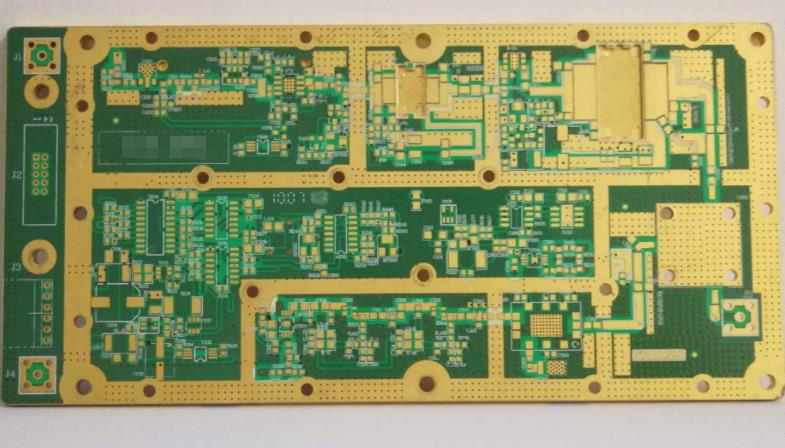
(1) Heißdruckschweißen
Der Metalldraht und die Schweißzone werden durch Heizung und Druck druckverschweißt. Das Prinzip besteht darin, den Schweißbereich (wie AI) plastisch zu verformen und die Oxidschicht an der Druckschweißschnittstelle durch Erwärmung und Druck zu zerstören, so dass die Anziehung zwischen Atomen erreicht wird, um den Zweck des "Klebens" zu erreichen. Beim Nivellieren, Erhitzen und Druckbeaufschlagen können die oberen und unteren Metalle miteinander eingelegt werden. Diese Technologie wird im Allgemeinen als Chip-on-Glass COG verwendet.
(2) Ultraschallschweißen
Ultraschallschweißen nutzt die Energie, die von einem Ultraschallgenerator erzeugt wird. Der Wandler dehnt sich schnell aus und zieht sich unter der Induktion eines ultrahochfrequenten Magnetfeldes zusammen, um elastische Vibrationen zu erzeugen, die den Keil entsprechend vibrieren lassen und gleichzeitig einen bestimmten Druck auf den Keil ausüben, so dass der Keil in der Lage ist, unter der kombinierten Wirkung dieser beiden Kräfte, Der AI-Draht wird schnell auf der Oberfläche der metallisierten Schicht (AI-Film) im geschweißten Bereich gerieben, was eine plastische Verformung der Oberfläche des AI-Drahtes und des AI-Films verursacht. Diese Verformung zerstört auch die Schnittstelle der KI-Schicht. Die Oxidschicht bringt die beiden reinen Metalloberflächen in engen Kontakt, um die Bindung zwischen Atomen zu erreichen und so eine Schweißnaht zu bilden. Das Hauptschweißenmaterial ist Aluminiumdrahtschweißkopf, im Allgemeinen keilförmig.
(3) Golddrahtschweißen
Kugelbonden ist die repräsentativste Bondtechnologie im Drahtbonden, da die aktuellen Halbleiterpakete Sekundär- und Triodenpakete alle AU Drahtkugelbonden verwenden. Darüber hinaus ist es einfach zu bedienen, flexibel, stark in Schweißpunkten (die Schweißfestigkeit des AU-Drahtes mit einem Durchmesser von 25UM ist im Allgemeinen 0.07ï½0.09N/Punkt), und es hat keine Richtung, und die Schweißgeschwindigkeit kann so hoch wie 15-Punkte/sek sein. Golddrahtkleben wird auch heißes (Druck) (Ultra) akustisches Schweißen genannt. Das wichtigste Bondmaterial ist Gold (AU) Draht. Der Kopf ist kugelförmig, also ist er kugelgebunden.
COB-Verpackungsverfahren
Der erste Schritt: Kristallausdehnung. Die Expansionsmaschine wird verwendet, um den gesamten LED-Chipfilm des Herstellers gleichmäßig zu erweitern, so dass die fest angeordneten LED-Matrizen, die an der Oberfläche der Folie befestigt sind, auseinandergezogen werden, was für Dornen bequem ist.
Schritt 2: Klebstoff. Legen Sie den expandierten Kristallring auf die Oberfläche der Trägermaschine, wo die Silberpastenschicht abgeschabt wurde, und legen Sie die Silberpaste auf die Rückseite. Etwas Silberpaste. Geeignet für Bulk LED Chips. Verwenden Sie eine Dosiermaschine, um eine angemessene Menge Silberpaste auf der Leiterplatte zu erkennen.
Der dritte Schritt: Setzen Sie den mit Silberpaste vorbereiteten Kristallausdehnungsring in den durchstechenden Kristallhalter, und der Bediener wird den LED-Chip auf der Leiterplatte mit einem Piercingstift unter dem Mikroskop durchstechen.
Schritt 4: Legen Sie die durchbohrte Leiterplatte in einen Wärmekreisofen und lassen Sie sie für einen Zeitraum stehen. Nachdem die Silberpaste ausgehärtet ist, nehmen Sie sie heraus (nicht für eine lange Zeit, sonst wird die Beschichtung des LED-Chips vergilbt, das heißt oxidiert. Verursachen Sie Schwierigkeiten). Wenn es LED-Chip-Bonding gibt, sind die oben genannten Schritte erforderlich; Wenn es nur IC-Chip-Bonding gibt, werden die obigen Schritte abgebrochen.
Der fünfte Schritt: Stecken Sie den Chip. Verwenden Sie einen Spender, um eine angemessene Menge an rotem Kleber (oder schwarzem Kleber) auf die IC-Position auf der Leiterplatte der Leiterplatte zu legen, und verwenden Sie dann eine antistatische Vorrichtung (Vakuumsaugstift oder -sub), um die IC-Matrize korrekt auf den roten Kleber oder schwarzen Kleber zu platzieren.
Der sechste Schritt: Trocknen. Legen Sie die geklebte Matrize in einen Wärmekreisofen auf eine große flache Heizplatte und lassen Sie sie für einen Zeitraum bei konstanter Temperatur stehen, oder es kann natürlich (für eine längere Zeit) ausgehärtet werden.
Schritt 7: Kleben (Drahtkleben). Die Aluminiumdraht-Bondmaschine wird verwendet, um den Chip (LED-Matrize oder IC-Chip) mit dem Aluminiumdraht des entsprechenden Pads auf der Leiterplatte zu überbrücken, das heißt, die innere Leitung der COB wird geschweißt.
Der achte Schritt: Vortest. Verwenden Sie spezielle Prüfwerkzeuge (verschiedene Ausrüstung für COB für verschiedene Zwecke, einfach hochpräzise geregelte Stromversorgung), um die COB-Platine zu testen, und reparieren Sie die unqualifizierte Platine erneut.
Schritt 9: Abgabe. Ein Leimspender wird verwendet, um eine angemessene Menge des vorbereiteten AB-Klebers auf die geklebte LED-Matrize zu legen, und der IC wird mit schwarzem Kleber verpackt und dann im Aussehen nach Kundenwunsch verpackt.
Der zehnte Schritt: Heilung. Setzen Sie die versiegelte Leiterplatte in einen Wärmekreisofen und lassen Sie sie bei konstanter Temperatur stehen. Je nach Anforderung können unterschiedliche Trocknungszeiten eingestellt werden.
Der elfte Schritt: Post-Test. Die verpackten PCB gedruckt Leiterplatten werden dann mit speziellen Prüfwerkzeugen auf elektrische Leistung getestet, um zwischen gut und schlecht zu unterscheiden.