Les trous d'air sont souvent un problème lié aux joints soudés. En particulier, lors de l'utilisation d'une pâte à braser par refusion de la technologie PCB, dans le cas d'une puce céramique sans fil, la plupart des grands pores (> 00005 pouce / 0,01 mm) sont situés entre le point de soudure lccc et le point de soudure de la carte de circuit imprimé. Dans le même temps, il n'y a que quelques petits trous dans les soudures d'angle près du château lccc. La présence de trous d'air affecte les propriétés mécaniques des joints soudés et peut nuire à la résistance, à la ductilité et à la durée de vie en fatigue des joints. C'est parce que la croissance des pores peut s'accumuler en fissures extensibles et causer de la fatigue. Les trous d'air augmentent également la contrainte et la covariance de la soudure, ce qui est également responsable des dommages. L'usine de traitement des puces SMT de Shanghai a noté que, en outre, le rétrécissement de la soudure pendant le processus de solidification, la stratification des gaz d'échappement et le flux entraîné lors du soudage des trous de passage galvaniques sont également responsables des trous de gaz.
Le mécanisme de formation des pores est plus complexe lors du soudage de PCB. D'une manière générale, la formation de pores (2, 13) causée par l'expulsion du flux entraîné dans la soudure dans la structure sandwich lors du reflux est principalement déterminée par la soudabilité des zones métallisées et varie avec la diminution de l'activité du flux, l'augmentation de la charge en métal pulvérulent et l'augmentation du volume de recouvrement sous le joint de plomb.
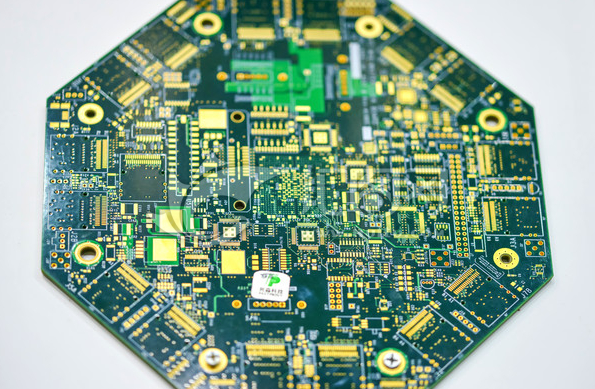
Réduire la taille des particules de soudure ne peut qu'augmenter la porosité. De plus, la formation de pores est également liée au partage du temps entre la Coalescence de la poudre de soudure et l'élimination de l'oxyde métallique fixe. Plus tôt la pâte à souder coalescent, plus les vides se forment. En général, la proportion de macropores augmente avec la porosité totale. Ces facteurs directeurs qui conduisent à la stomatisation auront un impact plus important sur la fiabilité des joints soudés que ce que montrent les résultats de l'analyse STOMATIQUE totale. Certaines sociétés de soudage de cartes de circuits imprimés indiquent que les méthodes de contrôle de la formation de trous d'air comprennent:
1. Améliorer la soudabilité des éléments de PCB / bas de chemise;
2. Utiliser des flux avec une activité de flux plus élevée;
3. Réduire l'oxyde de poudre de soudure;
4. Utilisez une atmosphère de chauffage inerte.
5. Ralentissez le processus de préchauffage avant le reflux. La formation de pores dans l'assemblage BGA suit un schéma légèrement différent par rapport au cas précédent. En général. Dans les assemblages BGA utilisant des blocs de soudure en étain 63, les pores sont principalement générés au stade de l'assemblage au niveau de la plaque. Sur une carte de circuit imprimé pré - étamée, le nombre de pores dans le connecteur BGA augmente avec la volatilité du solvant, la composition métallique et la température de reflux, ainsi qu'avec la diminution de la taille des particules; Cela peut s'expliquer par la viscosité qui détermine le taux de décharge du flux. Selon ce modèle, un milieu de flux ayant une viscosité plus élevée à la température de reflux empêchera le flux d'être expulsé de la soudure fondue. Ainsi, l'augmentation de la quantité de flux d'entraînement augmentera le taux d'émission. Possibilité de gaz, conduisant à une plus grande porosité dans les assemblages BGA. L'effet de l'activité du flux et de l'atmosphère de reflux sur les pores apparaît négligeable sans tenir compte de la soudabilité de la zone de métallisation fixe; la proportion de macropores augmentera avec l'augmentation de la porosité totale, Cela montre que les facteurs qui provoquent la porosité dans le BGA ont un impact plus important sur la fiabilité des joints soudés que ne le montrent les résultats de l'analyse de la porosité totale. Cet effet est similaire à ce qui se passe avec les villes creuses dans le processus SMT.
Lorsque la pâte à souder est dans un environnement chauffé, le reflux de la pâte à souder est divisé en cinq étapes. Tout d'abord, le solvant utilisé pour obtenir la viscosité et les propriétés de sérigraphie souhaitées commence à s'évaporer et la montée en température doit être lente (environ 3°c par seconde) pour limiter l'ébullition et les éclaboussures et éviter la formation de petites billes d'étain. De plus, certains composants sont plus sensibles aux contraintes internes. Si la température extérieure du composant PCB augmente trop rapidement, cela entraînera des dommages.
Le flux est actif et l'action de nettoyage chimique commence. Les flux solubles dans l'eau et les flux sans nettoyage ont le même effet nettoyant, mais à des températures légèrement différentes. Enlever les oxydes métalliques et certains contaminants des particules de métal et de soudure à coller. Un bon joint de soudure à l'étain métallurgique nécessite une surface "propre"
Lorsque la température continue d'augmenter, les particules de soudure fondent d'abord individuellement et commencent le processus de « l'herbe sombre» de liquéfaction et d'absorption de l'étain de surface. Cela couvre toutes les surfaces possibles et commence à former des points de soudure.
Cette phase est la plus importante. Lorsque les particules de soudure individuelles fondent toutes, elles se combinent pour former de l'étain liquide. À ce stade, la tension superficielle commence à former la surface du pied de soudure. Si l'écart entre les broches de l'élément et les plots de PCB est supérieur à 4 mils, il est probable que cela soit dû à la tension superficielle du PCB qui sépare les broches des plots, ce qui entraîne un circuit ouvert de points d'étain. Pendant la phase de refroidissement, si le refroidissement est rapide, la force du point d'étain sera légèrement supérieure, mais il ne faut pas aller trop vite pour ne pas provoquer de contraintes de température à l'intérieur du composant.