本手稿介紹 COG齒輪齒輪齒輪(玻璃碎片) 和 COF公司公司公司(柔性晶片) 包裝材料 technologies. 隨著高密度封裝技術的發展, COG齒輪齒輪齒輪 和 COF公司公司公司 科技已廣泛應用於各種平板顯示器和個人移動產品中. COG齒輪齒輪齒輪 和 COF公司公司公司 由於其高密度,科技已成為LCD製造中使用的主要封裝技術, 多個I/O, 主要採用導電膠包裝.
【關鍵字】COG齒輪齒輪齒輪、COF公司公司公司、各向異性導電膠、LCD封裝
1.前言
移動電子產品和大螢幕顯示器的普及促進了低成本的快速發展, 高密度和高密度電子生產科技. LCD顯示器等大型電子產品, 液晶電視, 等離子電視, 手機等中小型電子產品, 數位相機, 數位攝像機, 和其他3.C產品都趨向於輕量化, 薄和短. 這需要高密度和小尺寸. 新一代包裝科技,可自由安裝,以滿足上述需求. 在這種情況下,COG齒輪齒輪齒輪齒輪 和 COF公司公司公司公司 科技發展迅速, 成為駕駛員的主要包裝形式 集成電路用於LCD和PDP等平板顯示器, 然後成為這些顯示模塊的重要組成部分. 同時, 具有 异方性導電膠 包裝科技, 其應用領域正在迅速擴大, 並已在RFID中得到應用, 醫用電子設備, 移動個人電子產品和其他微電子產品.
2結構 COG齒輪齒輪齒輪齒輪 和 COF公司公司公司公司
的全名 COG齒輪齒輪齒輪 玻璃上有碎屑, 在中國,這被稱為玻璃晶片科技. 它直接封裝 集成電路 通過玻璃 异方性導電膠((ACF)), 並實現了 集成電路 玻璃上的導電凸塊和ITO透明導電墊. 的全名 COF公司公司公司 是貼片還是貼片, 哪個是晶片科技 柔性基板 中文版, 它也成為軟膜組裝科技. 類似於 COG齒輪齒輪齒輪 科技, 這個 集成電路 晶片直接封裝在柔性印刷電路板上,達到高封裝密度的目的, 重量減輕, 體積减小, 可自由彎曲和安裝.
如果 集成電路, 柔性基板, 玻璃面板, 印刷電路板, 和 other passive components (capacit或s, 電阻器, 等.) are connected in an appropriate way (such as the 集成電路 通過ACF直接連接到玻璃面板, 或柔性基板和 集成電路 和 glass panel use ACF) For connection, 柔性基板和無源元件可以通過傳統的回流焊連接, 柔性基板和 印刷電路板 can be connected by traditional soldering or plugging) to form a display module with COG齒輪齒輪齒輪 or COF公司公司公司 packaging.
COG齒輪齒輪齒輪 和 COF公司公司公司 包裝主要用途 异方性導電膠 實現 集成電路 和玻璃基板或柔性基板, 以及 集成電路 主要採用倒裝晶片結構. 倒裝晶片的碰撞科技和基板上的碰撞科技將在未來的專題文章中專業介紹給讀者. 以下主要介紹基本的柔性製造和ACF互連工藝科技.
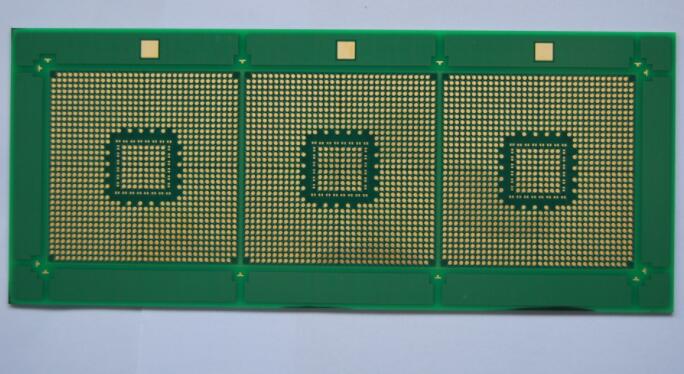
3生產精細電路 柔性基板
隨著顯示器顯示密度的新增,驅動晶片I/O需要大幅增加,引線焊盤之間的間距小於30mm。囙此,對柔性基板精細電路圖案的要求也在新增,互連焊盤間距也在新增。 它已達到15mm,並繼續减少。 囙此,柔性電路板的製造技術成為研究的重點。 現時,柔性基板上的精細電路生產主要包括減法、半加法和加法。
3.1 減法圖層 r 方法
The subtractive層 方法是傳統的 柔性線路板 生產. 粘貼一個層 光敏抗蝕劑幹膜或塗層a層 FCCL上的液體光敏抗蝕劑, 然後通過曝光, 發展, 蝕刻, 剝離, 最終形成所需的電路圖. 減法所能獲得的線寬間距與光敏抗蝕劑的分辯率密切相關層. 光敏抗蝕劑的分辯率層 由抗蝕劑的厚度决定層. 厚度越薄, 可以在光敏抗蝕劑上形成更精細的電路圖案層. 這是因為光通過抗蝕劑時會散射層. 抗蝕劑越厚層, 散射程度越大,形成的線的誤差越大. 使線寬小於50mm, 幹膜厚度必須低於20mm, 但是很難製造出太薄的幹膜, 囙此,人們更願意使用比干膜薄的濕膜工藝,並且可以自己控制. 該公司甚至可以使用滾筒塗覆液體光致抗蝕劑,以生產5mm濕膜. 但過薄的濕膜不可避免地會有針孔等缺陷, 泡沫, 劃痕, 其均勻性不如幹膜, 囙此短期內無法替代幹膜. 由於上述原因, 再加上刻蝕過程中不可避免的側面刻蝕現象, 減法的極限線寬為20mm. 如果你想得到更薄的電路, 必須配合稀釋劑9mm, 5mm甚至3mm超薄銅箔, 以盡可能縮短蝕刻時間, 减少側面腐蝕, 並獲得細紋. 然而, 這些厚銅箔和相關工藝均處於試驗階段,無法大規模生產.
3.2 半添加劑層 method
If you want to make a more refined circuit, 可以考慮使用半加法層 method. This
The base 材料 of the semi-additive method is mostly 5mm thin copper foil, 和 some時間s the conventional copper foil can be used after being thinned by 等hing [9]. 在此方法中, 光散射對電路圖沒有不利影響, 和更厚的抗蝕劑層 可用於使電路低於20mm.
3.3 添加劑層 method
The層-添加方法是一種直接處理絕緣基板以形成電路圖案的方法.
濺射薄膜的原因層 PI和後續銅之間的Cr層 是為了新增PI和銅之間的結合力層 防止後續銅層 從剝離. 此方法可以生成當前可用的最佳電路, 線間距高達3mm. 這種方法的另一個優點是,可以使用較厚的光敏幹膜來新增電路的厚度, 例如厚度與寬度之比為8倍, which can suppress the increase in DC resistance (R) when the circuit is refined. 然而, 這種方法需要使用電晶體製造設備, 工藝複雜,成本較高.
4 Interconnection technology of chip and substrate
現時,柔性基板與集成電路的互連科技主要有Au-Sn共晶互連、各向異性導電膠互連和非導電膠互連。
4.1金錫共晶連接工藝
此過程利用 集成電路 晶片和鍍錫 柔性線路板 內部引線通過加熱和加壓在接觸面上形成金錫共晶,達到連接的目的. The soldering temperature of this method must be above the formation temperature of the gold-tin eutectic (325-330°C), 這是對基板耐熱性的嚴格測試. 此外, 正確的焊接溫度很難掌握. 連接部位溫度較低時, 內部鉛的共晶形成不足, 導致內部導線斷路. 然而, 連接件溫度過高時, 當金錫共晶仍處於熔融狀態時,焊接工具將上升並離開, 容易導致內部導線斷路. 而且, 當溫度較低且內部引線上的鍍錫層較厚時, the tin will not be absorbed by the gold (no eutectic formation), 會導致短路和洩漏. 選擇合適的溫度非常重要, 而現在400攝氏度的溫度更常用.
為了滿足窄間距鍵合的需要,人們還研究開發了金與金接觸件的熱壓縮鍵合工藝,利用金屬擴散機制形成局部金屬鍵合。 然而,由於金的熔點很高,為了形成擴散,金-金鍵合需要比金-錫鍵合更高的鍵合溫度和更長的鍵合時間。 此時,基板的變形可能極其嚴重。 然而,使用超聲波輔助焊接技術和等離子表面清洗科技可以有效降低焊接所需的溫度。 業界普遍認為,共晶工藝可以滿足線間距大於20um的連接,否則容易發生短路。
4.2 各向異性導電膠膜(ACF) connection process
ACF資料在樹脂資料中分散細金屬顆粒或鍍金屬的塑膠球,並以B級狀態的薄膜形式存在。 在集成電路的凸點和基板上的電路之間粘合ACF後,使用適當的壓力、溫度和時間使樹脂流動,導電顆粒接觸凸點和基板上的電路以實現導電。 同時,由於選擇了合適的導電顆粒尺寸和添加量,凸點和凸點不能相互接觸,從而實現各向異性導電特性。
市場上有各種類型的ACF,但最常用的是直徑為3-5mm的鍍金塑膠顆粒,其通過分散在密度為40000-60000件/平方毫米的熱固性環氧樹脂系統中形成。 由於熱壓後環氧樹脂固化收縮,集成電路凸點與基板電路之間的結合强度良好,導電顆粒被擠壓變形,產生的彈力使導電顆粒與上下介面接觸更緊密,導電性更好。 此外,由於導電顆粒是彈性的,即使連接表面不是很平坦,導電顆粒產生的壓差也可以被導電顆粒的彈力抵消。 然而,由於導電顆粒,ACF存在短路問題,並且線寬過小導致接觸處可捕獲的導電顆粒非常少,使其無法處理線寬間距低於17mm的集成電路連接。ACF連接的電力可靠性不如共晶過程。 在隨後的回流焊接過程中,它也可能由於熱應力而變形,導致電導率降低甚至開路。 然而,只要掌握ACF粘接過程中的各種參數(壓縮溫度、壓力、時間、加熱速率等),ACF的可靠性完全可以滿足要求。 此外,ACF工藝具有壓制溫度低(200℃以下)、加工簡單、收率高、環保等優點。 它已成為COG齒輪齒輪齒輪和COF公司公司公司的主要互連管道。 同時,ACF也是連接柔性基板和玻璃面板的主要管道。
4.3 非導電粘合劑(NCA) connection process
NCA鍵合方法主要依靠晶片與基板兩側電極之間的直接接觸來實現導電,而NCA的目的是通過樹脂硬化和收縮來完成電極壓接,並利用樹脂的機械效能來保持電極之間的接觸和導電。 所需的壓迫力量。 NCA資料的作用是在凸點和基板電路的間接點之間提供粘合力,保護觸點並保持良好的可靠性。 囙此,資料必須具有以下特性:良好的機械物理性能,包括高Tg、高彈性模量、高收縮率和低熱膨脹係數、良好的潤濕效果、防潮效能、粘接效能和抗衝擊效能; 可在高溫(20攝氏度,150~250攝氏度)下短時間固化; 它具有優异的電力絕緣效能。 NCA工藝與ACF工藝相容,只需在校準設備前面添加電粘合裝置即可。 在NCA工藝中,凸點與基板電路直接機械接觸,發生橫向短路的概率很小。 囙此,NCA可以處理小於共晶和ACF工藝極限間距的集成電路連接(17mm或更小)。 然而,NCA對資料的要求高於ACF。 例如,晶片凸點高度的平整度必須良好,基板表面必須非常平整,基材必須具有較高的尺寸穩定性,連接線必須鍍金以避免形成氧化層。 NCA的連接可靠性有待檢驗。 這些因素限制了NCA的使用,使其暫時無法成為主流流程。
6結論
隨著高密度封裝技術的發展, COG齒輪齒輪齒輪齒輪 and COF公司公司公司公司 科技已廣泛應用於各種平板顯示器和個人移動產品中. COG齒輪齒輪齒輪 and COF公司公司公司 科技已成為LCD驅動程序的主要封裝形式 集成電路由於其許多優點,如高密度, 多個I/O主要採用導電膠包裝. COF公司公司公司 是一種很有前途的包裝科技. 由於柔性電路製造技術的進步, 抗彎強度高, 可以添加無源組件, 無需製作懸掛式引線, 面板面積利用率高. 它已擴展到高密度包裝領域,而不是 LCD封裝, combined with ACF 互聯互通 technology, COF公司公司公司 科技已成為現時包裝密度最高的一種包裝形式.