Der vollständige Name von BGA ist "Ball Grid Array", was eine Leiterplatte mit einer Kugelgitter-Array-Struktur bedeutet. Es handelt sich um ein Verpackungsverfahren für integrierte Schaltkreise mit organischen Trägern. Leiterplatten mit BGA haben im Allgemeinen mehr kleine Löcher, und das untere BGA-Durchgangsloch ist normalerweise als fertiges Loch mit einem Durchmesser von 8-12mil ausgelegt. Das untere BGA-Durchgangsloch muss gesteckt werden, das Lötpad darf nicht eingefärbt werden und das Lötpad ist nicht gebohrt.
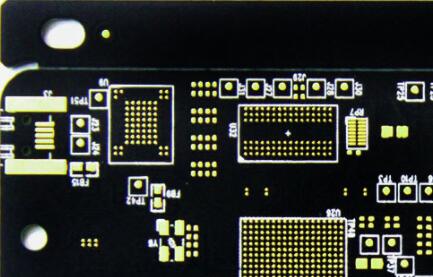
BGA ist eine Art von Bauteil, die das Lötkugel-Array-Verpackungsverfahren verwendet. Es produziert Lötkugeln an der Unterseite des Verpackungssubstrats als Schnittstelle der Leiterplatte, die mit der Leiterplatte verbunden ist. BGA-Komponenten eignen sich für Oberflächenmontage-Komponenten mit einer großen Anzahl von Pins in der Schaltung, höherer Packungsdichte, stärkerer Funktionalität und höherer Zuverlässigkeit. Die CPU von BGA wird hauptsächlich auf Laptops eingesetzt.
Allgemeine Regeln für BGA Pad Design
1) Der Durchmesser des Lötpads ist normalerweise kleiner als der Durchmesser der Lötkugel. Um eine zuverlässige Haftung zu erhalten, wird sie in der Regel um 20%-25% reduziert. Je größer der Lötpad, desto kleiner der Verdrahtungsraum zwischen den beiden Pads.
2) Das Pad auf dem BGA-Substrat hat den gleichen Durchmesser wie das Pad auf der Leiterplatte.
3) Das Lötpads-Design von BGA sollte sicherstellen, dass die Schablonenöffnung Lötpastenleckage von ⥠0.08mm3 verursacht, was die Mindestanforderung ist, um die Zuverlässigkeit der Lötstelle sicherzustellen.
BGA Verpackungsverfahren
Der Hauptprozessfluss von BGA-Verpackungen umfasst die Herstellung von Lötkugeln, Substratherstellung, Chipbonding, Verpackungsverfestigung und Schlitzverpackungen.
1) Lötkugelproduktion: Verwenden Sie hochreine Zinn-Blei-Legierung oder bleifreie Materialien, um Lötkugeln zu produzieren, die eine regelmäßige sphärische Stiftanordnung bilden.
2) Substratproduktion: Verwendung von mehrschichtigen Leiterplatten als Substrate, um elektrische Verbindungen mit hoher Dichte und hoher Leistung zu erreichen.
3) Chip Bonding: Befestigen Sie den Chip am Substrat und verbinden Sie ihn mit dem Substrat mit bleifreiem oder bleifreiem Lot.
4) Verpackung und Aushärtung: Der Chip ist mit Epoxidharz verkapselt, um ihn vor Umwelteinflüssen zu schützen.
5) Teilverpackung: Schneiden Sie den verpackten Chip in separate BGA-Pakete.
BGA-Verpackungstechniken
1. Pad Design: Um Schweißenqualität und Zuverlässigkeit sicherzustellen, muss Pad Design bestimmten Richtlinien folgen. Zunächst muss sichergestellt werden, dass die Größe des Lötpads mit der der Lötkugel übereinstimmt. Zweitens muss der Einfluss der Padform und des Layouts auf die thermische Ausdehnung und Kontraktion berücksichtigt werden. Schließlich sollte auch auf die Oberflächenbehandlung des Lötpads geachtet werden, um die Zuverlässigkeit des Schweißens zu verbessern.
2. Schweißprozess: BGA-Schweißen verwendet normalerweise Reflow-Löttechnologie. Um die Schweißqualität sicherzustellen, ist es notwendig, die Schweißtemperatur, Zeit und Ofentemperaturkurve zu steuern. Darüber hinaus sollte auch auf die thermische Belastung im Moment des Schweißens geachtet werden, um Schweißfehler zu vermeiden.
3. Qualitätskontrolle: Nach BGA-Verpackung und Schweißen ist Qualitätskontrolle erforderlich, um die Zuverlässigkeit der Verbindung sicherzustellen. Die allgemein verwendeten Erkennungsmethoden umfassen Röntgenprüfung, Schallemissionsprüfung usw. Röntgenprüfung kann die innere Struktur von Schweißpunkten visuell beobachten und Schweißfehler erkennen. Die akustische Emissionsprüfung bestimmt die Schweißqualität durch Analyse akustischer Signale.
4. Reparatur und Wartung: Für BGA-Verpackungen mit schlechtem Schweißen können spezielle Reparaturgeräte zum erneuten Schweißen verwendet werden. Normalerweise umfasst der Reparaturprozess Schritte wie Pad-Reinigung, Lotkugelauffüllung und Chip-Neubefestigung. Während des Reparaturprozesses ist es notwendig, die Heiztemperatur und -zeit zu kontrollieren, um Schäden am Chip zu vermeiden.
5. Design und Layout: Im Schaltungsdesign sind das Layout und die Verdrahtung von BGA-Verpackungen entscheidend. Faktoren wie elektrische Leistung, thermische Leistung und mechanische Festigkeit sollten vollständig berücksichtigt werden. Während des Layoutprozesses sollte auf Aspekte wie Signalintegrität, Leistungsstabilität und Wärmemanagement geachtet werden, um leistungsfähige elektronische Systeme zu erreichen.
Vor- und Nachteile von BGA Verpackungen
Vorteile:
1) Hohe Dichte: BGA-Verpackung hat einen größeren Stiftabstand, der eine höhere Anzahl von I/O-Pins erreichen kann und die Anforderungen von Hochleistungs-integrierten Schaltungen erfüllt.
2) Ausgezeichnete Signalübertragungsleistung: Aufgrund des kurzen Verbindungsweges von Lötkugeln hat BGA-Verpackung eine niedrigere parasitäre Induktivität und Kapazität, die zur Hochgeschwindigkeitssignalübertragung förderlich ist.
3) Gute thermische Leistung: BGA-gekapselte Lötkugeln können Wärme effektiv leiten und helfen, die Betriebstemperatur des Chips zu reduzieren.
Nachteile:
Hochgefragter Produktionsprozess: BGA-Verpackungen stellen hohe Anforderungen an Schweißprozesse und -geräte, was die Produktionskosten erhöht.
BGA-Verpackung ist eine Oberflächenmontage-Technologie, die sich durch die Bildung eines regelmäßigen kugelförmigen Pin-Arrays am Boden der Verpackung auszeichnet. Diese Verpackungsmethode hat Vorteile wie großen Stiftabstand, gute thermische Leistung und überlegene Signalübertragungsleistung, wodurch sie in Hochgeschwindigkeits- und Hochleistungsintegrierten Schaltungen weit verbreitet ist.