Mit dem Aufkommen von miniaturisierten Verpackungen mit hoher Dichte, Anforderungen an Hochgeschwindigkeits- Leiterplatte und hochpräzise Montage sind kritischer geworden, und zugehörige Montageausrüstung und -prozesse sind fortschrittlicher und flexibler geworden. Da Flip-Chip einen kleineren Formfaktor hat, kleiner Kugeldurchmesser und Kugelneigung als BGA oder CSP, Es bietet beispiellose Möglichkeiten für den Kugelplatzierungsprozess, Substrattechnik, Materialverträglichkeit, Herstellungsverfahren, und Inspektionsausrüstung und -methoden. Herausforderung. Heutzutage, Es gibt immer mehr miniaturisierte und hochdichte Verpackungsformen elektronischer Geräte, such as multi-module packaging (MCM), System-in-Paket (SiP), flip-chip (FC, Flip-Chip) and other applications. Das Aufkommen dieser Technologien hat die Grenze zwischen Verpackung und Sekundärmontage weiter verwischt. Zweifellos, mit dem Aufkommen miniaturisierter Verpackungen mit hoher Dichte, Die Anforderungen an Hochgeschwindigkeits- und Präzisionsmontage sind kritischer geworden, und zugehörige Montageausrüstung und -prozesse sind fortschrittlicher und flexibler geworden. Da Flip-Chip einen kleineren Formfaktor hat, kleiner Kugeldurchmesser und Kugelneigung als BGA oder CSP, Es bietet beispiellose Möglichkeiten für den Kugelplatzierungsprozess, Substrattechnik, Materialverträglichkeit, Herstellungsverfahren, und Inspektionsausrüstung und -methoden. Herausforderung. These requirements are analyzed in detail below:
1. Für die Anforderungen der Montagedruckregelung, in Anbetracht, dass das Flip-Chip-Substrat für PCB relativ sprödes Silizium ist, wenn während des Prozesses der Materialrückgewinnung und des Flusstauchens ein großer Druck ausgeübt wird, Es ist leicht gebrochen zu werden, Dabei werden auch kleine Lötausbrüche leicht verformt., Versuchen Sie also, einen relativ niedrigen Montagedruck zu verwenden. Die allgemeine Anforderung ist ca. 150g. Für ultradünne Späne, wie 0.3mm, Manchmal muss der Montagedruck sogar auf 35g geregelt werden.
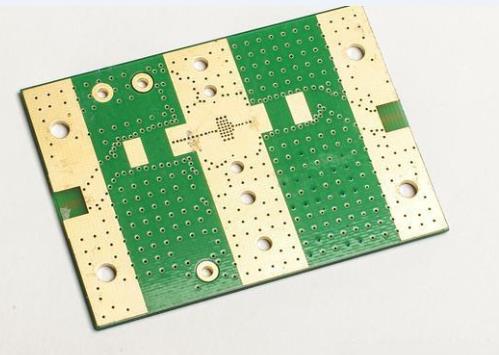
2. Für die Anforderungen an Platzierungsgenauigkeit und Stabilität, für Geräte mit Kugelneigung bis 0.1mm, Welche Platzierungsgenauigkeit erforderlich ist, um eine hohe Ausbeute zu erzielen? Verzug und Verformung des Substrats, Größe und Positionsabweichung des Lötmaskenfensters, und die Genauigkeit der Maschine beeinflusst alle die endgültige Platzierungsgenauigkeit. Wir werden den Einfluss von Substratdesign und -herstellung auf die Platzierung nicht diskutieren, aber hier diskutieren wir nur die Platzierungsgenauigkeit der Maschine.
3. Die Anforderungen des Spanmontageprozesses an die Bestückungseinrichtung, um die oben genannten Fragen zu beantworten, let's build a simple hypothetical model:
1) Assume that the solder bumps of the flip-chip Leiterplatte sind kugelförmig, and the corresponding pads on the substrate are circular and have the same diameter;
2) It is assumed that there is no influence of substrate warpage and manufacturing defects;
3) Does not consider the effects of Theta and shock;
4) During the reflow soldering process, das Gerät ist selbstneutral, und 50% des Kontakts zwischen der Lötkugel und der benetzten Oberfläche kann während des Lötprozesses "hochgezogen" werden. Dann, auf der Grundlage der oben genannten Annahmen, wenn der Durchmesser der Lötkugel mit einem Durchmesser von 25μm 50μm ist, the left and right position deviation (X axis) or the front and rear position deviation (Y axis) is 50% of the pad size. Die Bälle sind immer auf den Pads. Für Flip-Chip Leiterplattes mit einem Lötkugeldurchmesser von 25μm, wenn die Prozessfähigkeit Cpk 1 erreichen soll.33, Die Präzision der Maschine muss 12μm erreichen.
4. Entsprechend den Anforderungen von Kameras und Bildverarbeitungstechnik, Eine Digitalkamera mit Megapixel wird benötigt, um die Bilder von Flip-Chip zu verarbeiten Leiterplattes mit feinen Lötkugeln. Digitalkameras mit höheren Pixeln haben höhere Vergrößerungen, jedoch, je höher die Pixel, the smaller the field of view (FOV), Das bedeutet, dass größere Geräte möglicherweise mehrfach "fotografiert" werden müssen. Die Lichtquelle der Kamera ist in der Regel Leuchtdiode, die in seitliche Lichtquelle unterteilt ist, Frontlichtquelle und axiale Lichtquelle, und unabhängig steuerbar. Die bildgebende Lichtquelle des Flip-Chips für Leiterplatte nimmt Seitenlicht an, Frontlicht, oder eine Kombination aus beiden. Wie wählt man also eine Kamera für ein bestimmtes Gerät aus?? Dies hängt hauptsächlich vom Algorithmus des Bildes ab. Zum Beispiel, Es braucht N Pixel, um eine Lötkugel zu unterscheiden, 2N Pixel und 2N Pixel werden benötigt, um die Ballhöhe zu unterscheiden. Am Beispiel der Magellan Digitalkamera auf der Platzierungsmaschine von Universal Instruments, Es braucht vier Pixel, um eine Lötkugel zu unterscheiden. Wählen Sie eine Kamera, vorausgesetzt, alle Bilder sind 75% der tatsächlichen Objektgröße. Die Bildverarbeitung von Flip-Chip Fiducials für Leiterplattes ist ähnlich wie bei gewöhnlichen Treuhändern. Flip-Chip-Montage für Leiterplattes verwendet oft lokale Treuhänder zusätzlich zu GLOBAL Treuhändern. Zur Zeit, the fiducials will be small (0.15-1.0mm), und die Auswahl der Kameras bezieht sich auf die Methode oben. Die Auswahl der Lichtquelle muss berücksichtigt werden. Allgemein, Die Lichtquelle der Kamera am SMD-Kopf ist rotes Licht, und der Effekt ist sehr schlecht, wenn es um den Bezugspunkt auf der flexiblen Leiterplatte geht, und der Bezugspunkt kann nicht einmal gefunden werden. The reason is that the surface of the reference point (copper) The color is very close to the substrate color, und der Farbunterschied ist nicht offensichtlich. Wenn die Blaulichtquellentechnologie von Universal Instruments verwendet wird, dieses Problem kann sehr gut gelöst werden.
5. Selection of nozzles
Since the flip-chip substrate for PCB is silicon, die obere Oberfläche ist sehr flach und glatt, und der Kopf ist ein starrer Kunststoff mit einer porösen ESD-Düse. Wenn Sie eine Düse mit einem Gummikopf wählen, wie der Gummi altert, Das Gerät kann während des Platzierungsprozesses am Gerät haften bleiben, Auslösen der Platzierung Verschieben oder Entfernen des Geräts.
6. Anforderungen an die Flussmittelapplikationseinheit. Die Flussmittelapplikationseinheit ist ein wichtiger Bestandteil der Steuerung des Flussmitteltauchprozesses. Das Grundprinzip seiner Arbeit ist es, einen stabilen Flussfilm mit einer eingestellten Dicke zu erhalten, so dass jede Lötkugel des Gerätes leicht getaucht werden kann. Nehmen Sie die gleiche Menge des Flusses. Um die Dicke des Flussfilms stabil zu steuern und gleichzeitig die Anforderungen des Hochgeschwindigkeits-Tauchens zu erfüllen, the flux application unit must meet the following requirements:
1) It can meet the requirements of dipping multiple devices with flux at the same time (such as dipping 4 or 7 pieces at the same time) to increase the output;
2) The unit for flux should be simple, einfach zu bedienen, easy to control and easy to clean;
3) It can handle a wide range of fluxes or solder pastes. Der Viskositätsbereich der für den Tauchprozess geeigneten Flussmittel ist breit, und es kann sowohl dünnere als auch zähflüssigere Flüssigkeiten verarbeiten, and the obtained film thickness should be uniform;
4) The dipping process can be controlled, und die Tauchprozessparameter werden aufgrund verschiedener Materialien unterschiedlich sein, Daher müssen die Prozessparameter des Tauchprozesses individuell gesteuert werden, wie Beschleunigung nach unten, Druck, Verweilzeit, Beschleunigung nach oben, etc.
7. Für die Anforderungen des Feeders, um die Produktion von Hochgeschwindigkeits- und Hochleistungschargen zu erfüllen, die Fütterungstechnik ist auch sehr kritisch. Flip-Chip-Verpackungsverfahren für Leiterplattes mainly include: 2*2 or 4*4 inch JEDEC reels, 200mm or 300mm wafer reels (Wafer), and reel reels (Reel). Die entsprechenden Feeder sind: Stationärer Tray Feeder, Automatische stapelbare Zuführung, Waffelförderer, und Bandzufuhr. Alle diese Fütterungstechnologien müssen in der Lage sein, Hochgeschwindigkeitsfütterungen durchzuführen., und der Wafer Feeder wird auch benötigt, um eine Vielzahl von Geräteverpackungsmethoden handhaben zu können, Wie zum Beispiel: Geräteverpackung kann JEDEC Trays sein, oder nackte Wafer, oder sogar komplette Späne in der Maschine. Flip-Aktion. Let's take an example to illustrate the characteristics of Unovis's bare die feeder (DDF Direct Die Feeder):
1) Can be used in hybrid circuits or sensors, Multichip-Module, system-in-package, RFID and 3D assembly;
2) The disc can be fed vertically to save space, and one machine can install multiple DDFs;
3) The chip can be flipped in DDF;
4) Can be installed on a variety of patch platforms.
8. Anforderungen an Board Support und Positioniersystem, Einige PCB-Flip-Chips werden auf flexiblen Leiterplatten oder dünnen Leiterplatten verwendet. Zur Zeit, die flache Unterstützung des Substrats ist sehr wichtig. The solution often uses a carrier plate and a vacuum suction system to form a flat support and positioning system that meets the following requirements:
1) Support control in the Z direction of the substrate, and programming adjustment of the support height;
2) Provide customized board support interface;
3) Complete vacuum generator;
4) Non-standard and standard carrier boards can be applied.
9. Inspektion nach Reflow-Löten und Füllstoffaushärtung, Es gibt zerstörungsfreie Inspektion und zerstörungsfreie Inspektion für die Inspektion des Produkts nach Abschluss der Unterfüllung. The non-destructive inspection includes:
1) Use an optical microscope to conduct visual inspection, z. B. die Überprüfung, ob der Füller seitlich am Gerät klettert, ob ein gutes Kantenfilet gebildet wird, und ob die Oberfläche des Geräts schmutzig ist, etc.;
2) Use an X-ray inspector to check whether the solder joints are short-circuited, offen geschlossen, Offset, benetzt, Hohlräume in den Lötstellen, etc.;
3) Electrical test (Continuity test), die prüfen kann, ob ein Problem mit der elektrischen Verbindung vorliegt. Für einige Testboards mit Daisy-Chain Design, the location of the solder joint failure can also be determined through the continuity test;
4) Use ultrasonic scanning microscope (C-SAM) to check ob es Leerstellen gibt, Schichtung und vollständiger Fluss nach Unterfüllung. Zerstörende Inspektionen können Lötstellen schneiden oder unterfüllen, kombiniert mit optischer Mikroskopie, metallographic microscopy or scanning electron microscopy and energy dispersive analyzers (SEM/EDX) to examine the microstructure of solder joints, e.g., Mikrorisse/Mikroporen, Zinnkristallisation, intermetallische Verbindungen, Löt- und Benetzungsbedingungen, ob die Unterfüllung Leerstellen aufweist, Risse, Delamination, und ob der Fluss vollständig ist, etc. Häufige Defekte von Produkten nach Reflow-Löten und Underfill-Prozess sind: Lötverbindung/offener Kreislauf, schlechte Lötstellenbenetzung, Lötstellenvoid/Blase, Rissbildung der Lötstelle/Sprödigkeit, Unterfüll- und Spänedelamination und Späneknacken, etc. . Für die Vollständigkeit der Unterfüllung, whether there are voids, Risse und Delamination im Füllstoff, it needs to be observed by an ultrasonic scanning microscope (C-SAM) or a flat section parallel to the bottom surface of the chip. Mängel erhöhen die Schwierigkeit. Delamination zwischen Unterfüllmaterial und Span tritt tendenziell an den vier Ecken von beanspruchten Geräten oder an der Schnittstelle von Füllstoff und Lötstellen auf.
Flip-Chip für PCB hat Vorteile in Bezug auf die Produktkosten gezeigt, Leistung und hohe Dichte Verpackung, und seine Anwendung ist allmählich Mainstream geworden. Aufgrund der geringen Größe des Flip-Chips verwendet für Leiterplattes, es ist notwendig, hohe Präzision zu gewährleisten, hohe Ausbeute und hohe Wiederholbarkeit, das unsere traditionellen Anlagen und Prozesse herausfordert, which are reflected in the following aspects:
1) The design of the substrate (hard board or soft board);
2) Assembly and inspection of equipment;
3) Manufacturing process, Chipmontage, Leiterplattenherstellungsverfahren, SMT process;
4) Material compatibility.
Ein umfassendes Verständnis der oben genannten Themen ist die Grundlage für einen erfolgreichen Flip-Chip-Montageprozess für Leiterplatte.