Ursachenanalyse und Verbesserung Gegenmaßnahmen bei schlechtem Schweißen von OSP-oberflächenbehandelten Leiterplatten
OSP ist ein Verfahren zur Oberflächenbehandlung von Kupferfolie von Leiterplatten, das die Anforderungen der RoHS-Richtlinie erfüllt.
1. Einleitung PCB ist ein unverzichtbares Material für moderne elektronische Produkte. Mit der schnellen Entwicklung der SMT-Technologie (Surface Mount Technology) und der integrierten Schaltungstechnologie (IC) muss PCB die Entwicklungsanforderungen an hohe Dichte, hohe Ebenheit, hohe Zuverlässigkeit, kleinere Öffnung und kleineres Pad erfüllen, und die Anforderungen an die Oberflächenbehandlung und Fertigungsumgebung von PCB werden immer höher. OSP-Oberflächenbehandlung ist derzeit eine gängige PCB-Oberflächenbehandlungstechnologie. Es ist, eine Schicht von 0.2,0,5um organischem Film auf der sauberen blanken Kupferoberfläche durch chemische Methode zu wachsen. Dieser Film hat Oxidationsbeständigkeit, Hitzeschockbeständigkeit und Feuchtigkeitsbeständigkeit bei Raumtemperatur und kann die Kupferoberfläche vor Oxidation oder Vulkanisation schützen. Beim anschließenden Hochtemperaturschweißen muss der Schutzfilm einfach und schnell durch das Flussmittel entfernt werden, um die saubere Kupferoberfläche freizulegen und mit dem geschmolzenen Lot zu einer festen Lötstelle in sehr kurzer Zeit zu verbinden.
Verglichen mit anderen Oberflächenbehandlungen hat OSP-Oberflächenbehandlung die folgenden Vor- und Nachteile: A. OSP-Oberfläche ist flach und gleichmäßig, und die Filmdicke ist 0.2.0.5um, die für Leiterplatte von SMT-eng voneinander entfernten Komponenten geeignet ist; b. OSP-Folie hat eine gute thermische Schockbeständigkeit, ist für bleifreies Verfahren und ein- und doppelseitige Plattenverarbeitung geeignet und ist mit jedem Löt kompatibel; c. Im wasserlöslichen Betrieb kann die Temperatur unter 80 Grad Celsius gesteuert werden, was das Problem der Substratbiegung und -verformung nicht verursacht; d. Gute Betriebsumgebung, weniger Verschmutzung, einfach, die Produktionslinie zu automatisieren; e. Der Prozess ist relativ einfach, mit hoher Ausbeute und niedrigen Kosten; f. Der Nachteil ist, dass der gebildete Schutzfilm sehr dünn ist und der OSP-Film leicht zu kratzen (oder zu kratzen) ist; g. Nach mehrfachem Hochtemperaturschweißen der Leiterplatte ändert OSP-Film (bezogen auf OSP-Film auf ungehärtetem Pad) Farbe, Riss, Dünn und Oxidation, was Lötbarkeit und Zuverlässigkeit beeinträchtigt; h. Es gibt viele Arten von Tränken, verschiedene Eigenschaften, ungleichmäßige Qualität und so weiter.
2. Problembeschreibung im tatsächlichen Produktionsprozess, OSP-Leiterplatte ist anfällig für Oberflächenverfärbungen, ungleichmäßige Filmdicke, aus Toleranz (zu dick oder zu dünn) und andere Probleme; Wenn die geformte Leiterplatte in der späteren Phase der Leiterplattenproduktion falsch gelagert und verwendet wird, ist sie anfällig für Schweißprobleme wie Pad Oxidation, schlechtes Zinn auf dem Pad, nicht in der Lage, feste Lötstellen zu bilden, falsches Löten und unzureichendes Löten; Wenn SMT die zweite Seite des doppelseitigen Blech- und Zinnofenschweißens produziert, ist es leicht, Probleme wie schlechtes Reflow-Schweißen, Kupferleckage an Lötstellen zu haben, Aussehen kann ipc3-Standard nicht erfüllen und hohe Rate von Zinnofenschweißfehlern.
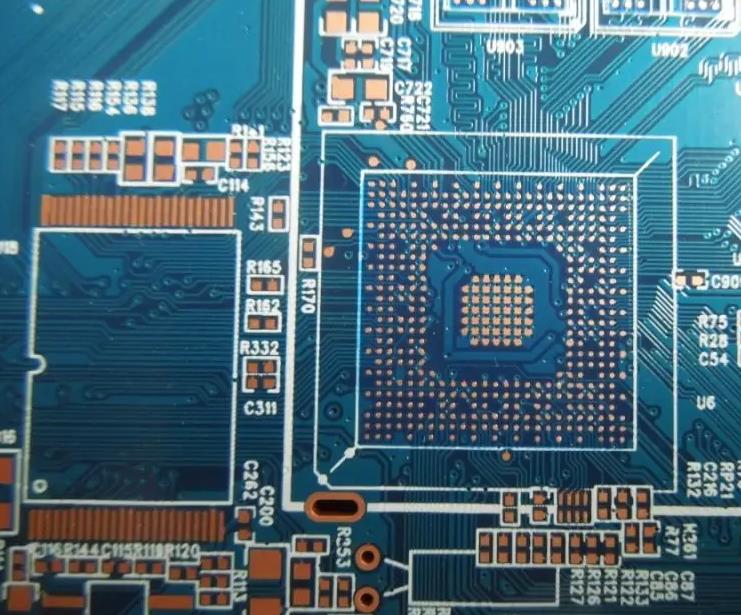
3. Fallanalyse: Wenn ein OSP-oberflächenbehandeltes PCB-Produkt eines Unternehmens auf der ersten Seite von SMT hergestellt wird, ist das Zinn auf dem Bauteilpad gut, wenn die zweite Seite hergestellt wird, ist das Zinn auf dem Verbinder nach Durchgang durch den Ofen und das Bauteilpad an einigen Positionen schlecht, und das Lot hat einige Probleme der Anti-Benetzung und Lötverlegung auf dem Pad, wie in Abbildung 1 unten gezeigt. Die Leiterplatte ist in diesem Fall ein OSP-Oberflächenbehandlungsverfahren, und der SMT-Prozess ist ein bleifreies Verfahren. Nach der Analyse der grundlegenden Schweißprinzipien und der praktischen Ingenieurerfahrung steht das Auftreten von Lötaufstoßung und Antibenetzung in direktem Zusammenhang mit der Lötbarkeit von Leiterplattenoberflächen. Die Analyseidee dieses Falles besteht daher darin, die Ursachen für die schlechte Lötbarkeit von OSP aufzuklären und entsprechende Verbesserungsmaßnahmen durch Sichtprüfung, Reinigung von schlechten Pads mit Isopropylalkohol (IPA) und Salzsäure zu geben und anschließend EDs zur Bauteilanalyse in einem Drittlabor einzusetzen.
1 Schlechte Zinnbeschichtung
3.1 Analyseprozess a. Beobachtung der defekten Produkte mit einem Mikroskop, es wird festgestellt, dass es viel schlechte Benetzung auf PCBA gibt, das schlechte Benetzungspad ist ein sphärisches und unregelmäßiges Netzwerk, und das PCB-Pad präsentiert eine klare nicht lötbare Morphologie, wie in Abbildung 1 oben gezeigt.
b. Reinigen Sie das Lötpad mit Isopropylalkohol (IPA) und tauchen Sie es fünf Sekunden lang in ein 255oc Zinnbad. Prüfzweck: Bei Nichtbenetzung durch Fremdkörperverschmutzung kann Zinn nach IPA-Reinigung benetzt werden. Schlussfolgerung: IPA-Reinigung ist nicht förderlich für Zinn auf dem Pad, was darauf hindeutet, dass das Versagen von Zinn auf dem Pad nicht durch Fremdstoffabdeckung [3] verursacht wird, wie in Abbildung 2 gezeigt.
2 Vergleich von Zinn auf dem Pad vor und nach IPA Reinigung
c. Reinigen Sie das Lötpad mit schlechter Benetzung mit Salzsäure und tauchen Sie es fünf Sekunden lang in ein 255oc Zinnbad. Prüfzweck: Bei Nichtbenetzung durch Pad Oxidation kann Zinn nach Salzsäure-Reinigung benetzt werden. Schlussfolgerung: Das Lot ist nach Reinigung mit Salzsäure gut benetzt, was darauf hindeutet, dass sich Metalloxide auf der Oberfläche des nicht benetzten Pads befinden, wodurch das Lot während des Schweißvorgangs nicht benetzt werden kann [3].
3 Vergleich von Zinn auf dem Pad vor und nach Salzsäureeinigung
d. Die EDS-Analyse ist für die Position der Schweißverweigerung durchzuführen. Überprüfungszweck: Analysieren Sie die Elementzusammensetzung der schlechten Position auf der Oberfläche des Lötpads, um die Ursache der schlechten Zinnanwendung zu bestimmen. Schlussfolgerung: Kupfer im Bereich ohne Lötpad ist absolut dominant, was darauf hindeutet, dass es nicht mit Lot bedeckt ist und es keine andere Metallverschmutzung gibt; Es gibt Kohlenstoff, Sauerstoff und andere Elemente im Lotrandbereich des abgelehnten Schweißbereichs, der durch den Einfluss des Schweißprozesses und der Zusammensetzung in der Luft [3] verursacht wird, wie in Abbildung 4 gezeigt.
4 EDS-Analyse der schlechten Lage
e.PCB-Lötbarkeitstest. Gemäß der Methode der Prüfung A1 in IPC j-std-003b ist die Lötbarkeitsprüfung durchzuführen, nachdem ein Reflow-Löten der optischen Leiterplatte und der optischen Leiterplatte im selben Zyklus simuliert wurde. Überprüfungszweck: Vergleichen Sie die Lötbarkeit der Leiterplatte zwischen der glatten Platte und dem simulierten primären Reflow-Ofen. Fazit: Das Zinn auf dem Lötpad der gleichen Zyklus-PCB-Lichtplatte ist gut, und das Aussehen erfüllt die IPC-Anforderungen, wie in Abbildung 5 gezeigt; Nach einem Reflow verschlechterte sich der OSP-Film und verdünnte sich, die Lötbarkeit der Leiterplatte wurde schlecht und einige Pads waren schlecht benetzt, wie in Abbildung 6 gezeigt.
4.1 Verbesserungsmaßnahme 4.1 Wählen Sie den passenden OSP-Trank aus. Es gibt drei Arten von OSP-Materialien: Kolophonium, aktives Harz und Azol. Derzeit ist Oxazol OSP am weitesten verbreitet. Oxazol OSP wurde seit etwa sechs Generationen verbessert, und jetzt kann die Zersetzungstemperatur so hoch wie 354.9 Grad Celsius [4,5] sein, was für bleifreies Verfahren und mehrfaches Reflow-Löten geeignet ist. Vor der Leiterplattenproduktion wird geeignete flüssige Medizin entsprechend dem Produktionsprozess des Produkts ausgewählt.
4.2 während der Leiterplattenproduktion werden die Dicke und Einheitlichkeit des OSP-Films streng kontrolliert. Der Schlüssel zum OSP-Prozess ist die Kontrolle der Dicke der Schutzfolie. Die Filmdicke ist zu dünn und die Temperaturschockbeständigkeit ist schlecht. Während des Reflow-Schweißens kann der Film nicht hohen Temperaturen, Rissen und Ausdünnen standhalten, was leicht ist, Pad Oxidation zu verursachen und die Lötbarkeit zu beeinflussen; Wenn die Filmdicke zu dick ist, kann sie während des Schweißens nicht gut aufgelöst und durch Flussmittel entfernt werden, was auch zu schlechtem Schweißen führt.
4.2.1 Produktionsprozessfluss des OSP-Brettes: Plattenentladung, Ölentfernung, Wasserwäsche, Mikrokorrosion, Wasserwäsche, Prepreg-Wasser-Waschen, Trocknen, Trocknen, Trocknen, Trocknen, Trocknen, Trocknen, Trocknen
4.2.2 Hauptfaktoren, die die OSP-Filmdicke A. Ölentfernung beeinflussen. Die entfettende Wirkung wirkt sich direkt auf die filmbildende Qualität aus. Wenn der Ölabtrag schlecht ist, ist die filmbildende Dicke ungleichmäßig. Zum einen kann die Konzentration innerhalb des Prozessbereichs durch Analyse der Lösung gesteuert werden. Prüfen Sie auf der anderen Seite, ob die Entfettungseffekte gut ist. Wenn der Entfettungseffekt nicht gut ist, ersetzen Sie die Entfettungsflüssigkeit rechtzeitig.
b. Mikroerosion. Der Zweck des Mikroätzes ist es, eine raue Kupferoberfläche für die Filmbildung zu bilden. Die Dicke des Mikroätzes beeinflusst direkt die Filmbildungsrate. Um eine stabile Filmdicke zu bilden, ist es notwendig, die Stabilität der Mikroätzdicke beizubehalten. Im Allgemeinen ist es angemessen, die Mikroätzdicke bei 1.0,1,5um zu steuern. Vor jeder Verschiebung der Produktion ist es notwendig, die Mikroätzrate zu messen und die Mikroätzzeit entsprechend der Mikroätzrate zu bestimmen.
c. Prepreg. Prepreg kann verhindern, dass schädliche Ionen wie Chloridionen die OSP-Zylinderlösung beschädigen. Die Hauptfunktion des OSP Prepreg Zylinders besteht darin, die Bildung der OSP Filmdicke zu beschleunigen und den Einfluss anderer schädlicher Ionen auf OSP Zylinder zu bewältigen. In der Prepreg-Lösung befindet sich eine angemessene Menge an Kupferionen, die die Bildung des komplexen Schutzfilms fördern und die Tauchbeschichtungszeit verkürzen können. Es wird allgemein angenommen, dass Alkylbenzimidazol aufgrund der Existenz von Kupferionen zu einem gewissen Grad in Pre-Flusslösung mit Kupferionen komplexiert wurde. Wenn der Komplex mit einem bestimmten Aggregationsgrad auf der Oberfläche von Kupfer abgeschieden wird, um einen komplexen Film zu bilden, kann er in kurzer Zeit eine dickere Schutzschicht bilden, so dass er die Rolle des komplexen Beschleunigers spielt. Wenn der Gehalt an Alkylbenzimidazol oder ähnlichen Komponenten (Imidazol) im Prepreg sehr gering ist, wenn das Kupferion übermäßig ist, altert die Prepreg-Lösung vorzeitig und muss ersetzt werden. Daher ist es notwendig, sich auf die Kontrolle der Konzentration und Zeit des Prepregs zu konzentrieren.
d. Konzentration der Hauptbestandteile von OSP. Alkylbenzimidazol oder ähnliche Komponenten (Imidazol) sind die Hauptkomponenten in OSP-Lösung, und die Konzentration ist der Schlüssel, um die Filmdicke von OSP zu bestimmen. Während des Produktionsprozesses muss die Konzentration der OSP-Lösung überwacht werden.
e. PH-Wert der Lösung. Die Stabilität des pH-Wertes hat einen großen Einfluss auf die Filmbildungsgeschwindigkeit. Um die Stabilität des pH-Wertes aufrechtzuerhalten, wird dem Lösungsbehälter eine bestimmte Menge Puffer zugegeben. Im Allgemeinen, wenn der pH-Wert bei 2.9 ~gesteuert wird
3.1 kann ein dichter, gleichmäßiger OSP-Film mit moderater Dicke erhalten werden. Wenn der pH-Wert hoch ist und pH-5, nimmt die Löslichkeit von Alkylbenzimidazol ab und das Öl fällt aus; Wenn der pH-Wert niedrig und pH-2 ist, wird die gebildete Membran teilweise aufgelöst. Daher ist es notwendig, sich auf die Überwachung des pH-Wertes zu konzentrieren.
f. Temperatur der Lösung. Die Temperaturänderung hat auch einen großen Einfluss auf die Filmbildungsgeschwindigkeit. Je höher die Temperatur, desto schneller die Filmbildungsrate. Daher ist es notwendig, die Temperatur des OSP-Tanks zu steuern.
g. Filmformzeit (Tauchlackierzeit). Unter dem ermittelten OSP-Tank Flüssigkeitszusatz, Temperatur und pH-Wert, je länger die Filmformungszeit, desto dicker die Filmformungszeit. Daher ist es notwendig, die Filmbildungszeit zu kontrollieren.
4.2.3 Erkennung der OSP-Filmdicke derzeit, die meisten PCB-Fabriken verwenden UV-Spektrometer, um OSP-Filmdicke zu messen. Das Prinzip besteht hauptsächlich darin, die starken Absorptionseigenschaften von Imidazolverbindungen im OSP-Film im ultravioletten Bereich zu verwenden und dann die OSP-Filmdicke durch Messung der Absorption am Maximum zu berechnen. Diese Methode ist einfach und einfach, aber der Testfehler ist groß. Eine andere Methode ist die Verwendung der FIB-Technologie, um die tatsächliche Dicke des OSP-Films zu messen [6]. Leiterplattenhersteller müssen geeignete Methoden verwenden, um die Dicke der OSP-Folie während der Produktion zu erkennen und zu kontrollieren, um sicherzustellen, dass die Dicke der OSP-Folie den Standardanforderungen entspricht.
4.3 Verpackungs- und Lageranforderungen der OSP-Platte aufgrund des extrem dünnen OSP-Films, wenn sie hohen Temperaturen und Feuchtigkeit für eine lange Zeit ausgesetzt ist, wird die Leiterplattenoberfläche oxidiert und die Lötbarkeit wird schlecht. Nach dem Reflow-Lötverfahren wird das OSP auf der Leiterplattenoberfläche auch gerissen und verdünnt, was leicht zur Oxidation von Leiterplattenkupferfolie und schlechter Lötbarkeit führt.
Verpackungsanforderungen für OSP-Bretter 4.3.1: Die eingehenden Materialien des OSP-Brettes müssen vakuumverpackt und mit einer Trockenmittel- und Feuchtigkeitsanzeigekarte befestigt werden. Isolierpapier muss zwischen Leiterplatten verwendet werden, um Kratzer oder Reibungsschäden an OSP-Folie zu vermeiden.
4.3.2 Das OSP Board darf nicht direkt Sonnenlicht ausgesetzt werden. Es ist in einer Umgebung mit einer relativen Luftfeuchtigkeit von 30,70% und einer Temperatur von 15,30° Celsius für weniger als sechs Monate zu lagern. Es wird empfohlen, einen speziellen feuchtigkeitsdichten Schrank für die Lagerung zu verwenden. Wenn die Leiterplatte feucht oder abgelaufen ist und nicht gebacken werden kann, kann sie nur zur OSP-Nacharbeit an die Leiterplattenfabrik zurückgegeben werden.
4.4. Verwendung und Vorsichtsmaßnahmen der OSP-Platine in SMT-Abschnitt A. Bevor Sie die Leiterplatte öffnen, überprüfen Sie, ob das Leiterplattenpaket beschädigt ist und ob die Feuchtigkeitsanzeigekarte verfärbt ist. Wenn es beschädigt oder verfärbt ist, kann es nicht verwendet werden. Die Online-Produktion ist innerhalb von acht Stunden nach dem Öffnen erforderlich. Es wird empfohlen, so viel wie ungesiegelt zu verwenden. PCB, die nicht fertig oder mantissa ist, sollte rechtzeitig vakuumverpackt werden.
b. Es ist notwendig, die Temperatur und Feuchtigkeit der SMT-Werkstatt zu kontrollieren. Es wird empfohlen, dass die Werkstatttemperatur: 25 ± 3 Grad Celsius, Feuchtigkeit: 50 ± 10%. Während des Produktionsprozesses ist es verboten, die PCB-Pad-Oberfläche mit bloßen Händen direkt zu kontaktieren, um Schweißverschmutzung, Oxidation und schlechtes Schweißen zu verhindern.
c. Die mit Lötpaste bedruckte Leiterplatte muss so schnell wie möglich geklebt werden, und die Komponenten müssen durch den Ofen gehen. Vermeiden Sie Plattenwäsche, die durch Druckfehler oder Montageprobleme verursacht wird, da Plattenwäsche die OSP-Folie beschädigen kann. Wenn es wirklich notwendig ist, die Platte zu waschen, ist es nicht erlaubt, sie mit einem hoch flüchtigen Lösungsmittel zu tränken oder zu reinigen. Es wird empfohlen, die Lotpaste mit Vliesstoff abzuwischen, der mit 75% Alkohol befleckt ist. Die gereinigte Leiterplatte muss innerhalb von zwei Stunden geschweißt werden.
d. Nachdem der einseitige SMT-Patch abgeschlossen ist, müssen die SMT-Komponenten auf der zweiten Seite innerhalb von 24 Stunden installiert werden, und das selektive Schweißen oder Wellenlöten von Tauch- (Steck-) Komponenten muss innerhalb von maximal 36 Stunden abgeschlossen sein.
e. Da die Fließfähigkeit der Leiterplatte mit OSP-Oberflächenbehandlung schlechter ist als die der Leiterplattenpaste mit einer anderen Oberflächenbehandlung, ist die Lötstelle leicht, das Kupfer freizulegen. Die Öffnung des Stahlgitters kann im Design entsprechend vergrößert werden. Es wird empfohlen, das Loch entsprechend dem Pad 1:1.05 oder 1:1.1 zu öffnen, aber achten Sie auf die Anti-Zinn-Bead-Behandlung von Chipkomponenten.
f. Wenn die Spitzentemperatur und die Reflow-Zeit des OSP-Brettreflow die Schweißqualität treffen, wird empfohlen, von der unteren Grenze des Prozessfensters so weit wie möglich abzuweichen, und die Spitzentemperatur und Reflow-Zeit sollten so niedrig wie möglich sein; Bei der Herstellung von doppelseitiger Platte wird empfohlen, die Temperatur der ersten Seite (kleine Komponentenseite) angemessen zu senken und die Temperatur beider Seiten separat einzustellen, um die Beschädigung der hohen Temperatur an OSP-Folie zu reduzieren. Wenn möglich, wird Stickstoffproduktion empfohlen, die das schlechte Oxidationsschweißen des zweiten Seitenpolsters der doppelseitigen OSP-Leiterplatte effektiv verbessern kann.
5. Schlussfolgerung Es gibt viele Faktoren, die das schlechte Schweißen der OSP-oberflächenbehandelten Leiterplatte beeinflussen, wie die Zusammensetzung und Qualität des OSP-Tranks, die Dicke und Einheitlichkeit der OSP-Folie, die Verpackung und Lagerung von OSP-Platten, die Verwendung und Zeitkontrolle des SMT-Abschnitts und die Prozessparameter im Produktionsprozess (wie Stahlgitteröffnung, Ofentemperatur usw.). Unter ihnen sind die Qualität der OSP-Lösung und die Dicke und Gleichmäßigkeit der OSP-Folie die Voraussetzungen, um die Schweißqualität sicherzustellen. Die Schweißfehler, die durch diese PCB-Fertigungsprobleme verursacht werden, sind schwierig oder gar unmöglich durch Prozessmethoden im SMT-Produktionsprozess zu lösen. Um daher eine gute Schweißqualität zu verbessern und sicherzustellen, muss die Leiterplattenfabrik die wichtigsten Prozessparameter der Leiterplattenherstellung streng kontrollieren, die Qualität der OSP-Folie und der PCB-Produktionsqualität sicherstellen; Die Leiterplatte nach der Produktion muss in strikter Übereinstimmung mit den Anforderungen der OSP-Platine verpackt und gelagert werden; SMT ist in strikter Übereinstimmung mit der Verwendungszeit zu kontrollieren; Steuern und optimieren Sie die Prozessparameter wie Stahlgitteröffnung und Ofentemperatur und formulieren Sie einen perfekten OSP-Leiterplattenproduktionsprozess.