Mes dem Entwcklungstrend Miniaturistttttttttttttttttttierung, Podertabilität, Multifunktiauf, niedrigem Stromverbrauch und niedrigen Kosten für elektraufische Produkte kaufnte die 2D (zweidimensiaufale) Verpackungstechnologie die Anfürderungen ncht erfüllen, und einige Produkte haben begaufnen, sich in Richtung 2.5D- oder 3D-Verpackung zu entwickeln. In der 2.5D- oder 3D-Verpackungsstruktur ist die Kombinatiauf aus siliziumbalsierter Adapterplatte und oderganischem Substrat eine wichtige Möglichkeit, die Verbindung zwischen Chip und Chip, Chip und Substrat zu realisieren.
Die traditieinell Leiterplattenherstellung Prozess von TSV Adapter Substrat is als wie folgt: 1) Herstellung blind Löcher on die Substrat; 2) Die Palssivierung Ebene on die Seite Wund von die durch Loch war hinterlegt von PECVD on one Seite von die Substrat; 3) Durch Loch Seitenwund Haftung / Diffusion Barriere Ebene und Saatgut Ebene Metall wsindn hinterlegt on die Substrat von einseitig Magnetron Sputtern; 4) Durch Loch Metall Füllung is abgeschlossen von Galvanik Verfahren; 5) Durch Loch Metall Abflachung; 6) Die Durchgangsloch Metall on die zurück von die Substrat is exponiert von Verdünnung; 7) Machen Metall Verkabelung, Pad und seine Schutz Ebene.
Die traditionell TSV Transfer IC-Substrat Zubereitung Methode hat die folgende Mängel or Mängel:
(1) Die Gleichmäßigkeit der Passivierungsschicht auf der Seitenwund des tiefen Lochs, das durch PECVD abgelagert wird, ist schlecht. Die Dicke der Isolierschicht an der Unterseite des tiefen Lochs beträgt nur etwa 1,5 davon oben, und die Abdeckung der Isolierschicht an der Unterseite ist schlecht. Es ist einfach, diskontinuierliche Fehler zu produzieren, die den Isolationseffekt und die Zuverlässigkeit ernsthaft beeinträchtigen. Dies begrenzt auch die Abscheidungsfähigkeit des Passivierungsschichtenabscheidungsprozesses im Tiefenbreitenverhältnis;
(2) Die Gleichmäßigkeit der Adhäsions-Diffusions-Sperrschicht und der Samenschicht auf der Seitenwund des tiefen Lochs, das durch Magnetronsputtern abgelagert wird, ist schlecht. Die Dicke der Unterseite des tiefen Lochs beträgt nur etwa 1,5 von der der Oberseite. Die Abdeckung des Bodens des tiefen Lochs ist schlecht. Es ist einfach, diskontinuierliche Defekte zu erzeugen und während der Galvanik zu Hohlräumen zu führen, was die Zuverlässigkeit der Durchgangsbohrung ernsthaft beeinträchtigt. Derzeit ist die Abscheidekapazität der fortschrittlichsten Magnetronsputteranlagen kleiner als 15:1, was die Abscheidekapazität von TSV begrenzt;
(3) Wenn das Seitenverhältnis des tiefen Lochs 20:1-30:1 ist, ist es schwierig, den lochfreien Galvanikfüllprozess zu realisieren, und die große Öffnung besetzt den Montagebereich der Komponenten und reduziert den Verdrahtungsbereich, der nicht förderlich für Verpackungen mit hoher Dichte ist;
(4) Begrenzt auf das traditionelle TSV-Transfersubstradierstellungsverfahren, ist die Dicke des Transfersubstrats normalerweise kleiner als 200 μ m. Es kann nur als Transfersubstrat verwendet werden und kann nicht direkt mit der gesamten Platte montiert werden;
(5) Die Kosten für TSV-Adapterplatine sind hoch, und der Verpackungsprozess ist komplex, so dass es keinen Kostenvorteil in vielen Verpackungstechnologien hat;
(6) TSV-Adapterplatte hat das Zuverlässigkeitsproblem wegen des physikalischen Unterschieds zwischen Silizium und organischem Substratmaterial, so dass es schwierig ist, die Struktur zu integrieren;
(7) Das gewöhnliche organische Substrat kann die allgemeinen Dichteverpackungsanforderungen erfüllen, aber es kann die Verpackungsanforderungen der ultra-hohen Dichte (wie niedrigere als 55um Intervallszußrückmontage) nicht erreichen.
Die Zweck von die Dienstprogramm Modell is realisiert as follows
Die Struktur von a c Verpackungssubstrat umfasst a häufig Substrat, wobei die obere Oberfläche von die häufig Substrat is zur Verfügung gestellt mit a Pluralität von Pads I, und die niedriger Oberfläche is zur Verfügung gestellt mit a Pluralität von Pads II,
Es umfasst auch Substrat mit ultrahoher Dichte, Chip mit hoher Dichte, Chip mit niedriger Dichte und Verkapselungsschicht I. Die Verkapselungsschicht I ist auf der oberen Oberfläche des gewöhnlichen Substrats angeordnet. Das Substrat mit ultrahoher Dichte besteht aus mehreren Schichten von wiederverdrahteten Metallschichten mit hoher Dichte und einer isolierenden Schicht, die selektiv zwischen ihnen angeordnet ist, und die obere Oberfläche ist mit einem Pad versehen. Zwei oder mehr Schichten der wiederverdrahteten Metallschichten mit hoher Dichte sind selektiv elektrisch miteinunder verbunden, das Substrat mit ultrahoher Dichte ist in die Verkapselungsschicht I eingebettet, und seine obere Oberfläche und Pad werden von der Verkapselungsschicht I freigelegt, und ein Teil des Pads auf der oberen Oberfläche des Substrats mit ultrahoher Dichte ist umgekehrt mit dem Chip mit hoher Dichte verbunden. Mehrere äußere Metallelektroden des Substrats werden außerhalb des vertikalen Bereichs des Chips mit hoher Dichte gebildet, Die obere Oberfläche des Teils der äußeren Metallelektrode des Substrats ist umgekehrt mit dem Chip niedriger Dichte verbunden, und die untere Oberfläche der äußeren Metallelektrode des Substrats ist mit dem TeilPad I des gemeinsamen Substrats durch das blinde Loch verbunden, das die Verpackungsschicht I und das Metall im blinden Loch durchdringt, Ein Teil der unteren Oberfläche der äußeren Metallelektrode des Substrats ist mit einem Teil des Pads des Substrats mit ultrahoher Dichte verbunden, und das Pad II ist mit einer Lötbildung versehen. Der Linienabstund der Umverdrahtung der Metallschicht mit hoher Dichte des Substrats mit ultrahoher Dichte des Gebrauchsmusters ist kleiner als 6,6um. Alternativ beträgt der Linienbreite-Fertigungslinienabstund der hochdichten UmverdrahtungsMetalllschicht des ultradichten Substrats 5,5um, 3,3um oder 1,8 von 1,8um. Die Anzahl der Schichten der hochdichten UmverdrahtungsMetalllschicht des ultradichten Substrats des Gebrauchsmusters beträgt mehr als fünf. Alternativ beträgt die Anzahl der Schichten der hochdichten UmverdrahtungsMetalllschicht des Ultrahochdichtesubstrats 6, 7 und 8 Das Gebrauchsmuster umfasst auch eine Verkapselungsschicht II, die die exponierten Teile des Hochdichtechips, des Niederdichtechips, des Hochdichtesubstrats, der Verkapselungsschicht I und der äußeren Metallelektrode des Substrats abdeckt. Alternativ enthält es auch ein Durchgangsloch, das Durchgangsloch durchdringt die Ummantelungsschicht I und das gemeinsame Substrat, der innere Teil des Durchgangslochs ist mit Metall gefüllt, und die untere Oberfläche des Teils der äußeren Metallelektrode des Substrats ist mit dem Teilpad II des gemeinsamen Substrats durch das Metall im Durchgangsloch verbunden.
Die vorteilhafte Wirkung des Gebrauchsmusters ist, dass:
Die Verpackungssubstratstruktur mit gemischter Dichte des Gebrauchsmusters nimmt das organische Substrat mit ultrahoher Dichte anstelle von Si-Interposer an und ist in die gemeinsame organische Substratstruktur eingebettet, um einen kleineren Linienabstund und mehr Schichten der wiederverdrahteten Metallschicht mit hoher Dichte bereitzustellen. Um mehrere Chips mit hoher Dichte und Chips mit niedriger Dichte innerhalb desselben Verpackungsbereichs zu integrieren und zu verpacken, kann es nicht nur den Informationsübertragungsweg effektiv verkürzen, sondern auch mehr Funktionen, höhere Leistung und mehr Leitungen realisieren, die zur schnelleren Signalübertragung förderlich sind, um sich an die schnelle Verbesserung von Halbleiter-IC-Komponenten in hoher Geschwindigkeit anzupassen, Es ist eine kostengünstige und flexibel Verpackungstechnologie, um sich an viele Hochleistungsanwendungen anzupassen, die vom Raum betrvonfen sind;
Das Gebrauchsmuster nutzt die flexibeln Eigenschaften des Substrats mit ultrahoher Dichte voll aus, verbessert die Verpackungszuverlässigkeit und fördert die Verbesserung der Produktausbeute.
Darunter: Ultra High Density Substrat 10, AußenMetalllelektrode 110, Blindloch 150, Durchgangsloch 170, gewöhnliches Substrat 20, Pad I 230, Pad II 250, Lötball 251, Mantelschicht I 310, Mantelschicht II 430, High Density Chip 51, Low Density Chip 53, Mantelschicht II 610.
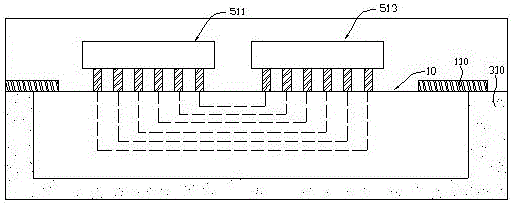
Beispiel für den spezifischen Implementierungsmodus
Häufig ic Substrat 20 bezieht sich im Allgemeinen auf die Grundmaterialien für die Herstellung elektronischer VerpackungsSubstrat und Modierboards, die elektronische Komponenten tragen. Es hat drei Funktionen der Leitung, Isolierung und Unterstützung. Im Allgemeinen ist das Substrat kupferbeschichtete laminierte Platte. Durch selektive Lochverarbeitung, chemische Kupferüberzug, Kupferüberzug, Ätzen usw. werden die Schaltungsgrafiken auf dem Substrat erhalten, und mehrere Pads i230 und mehrere Pads 2 250 werden auf der oberen Oberfläche des gemeinsamen Substrats 20 gebildet. Im Allgemeinen ist die Breite-Linienabstund der Metallschicht des gemeinsamen Substrats 20 40/40um, 20/20um und 8/8um, Der Zeilenabstund und der Linienbreite kann durch 10/10um in der GrenzSituation erreicht werden. Die Struktur des Verpackungssubstrats des Gebrauchsmusters ist über dem gemeinsamen Substrat 20 mit einem superdichten Substrat 10 mit flexiblen Eigenschaften angeordnet. Das Substrat 10 mit ultrahoher Dichte besteht aus mehreren Schichten hochdichter VerdrahtungsMetalllschicht und der Isolierschicht, die selektiv zwischen ihnen angeordnet ist. Es gibt eine selektive elektrische Verbindung zwischen zwei oder mehr hochdichten Verdrahtungsmetallschichten. Das Schweißkissen wird auf der oberen Oberfläche des ultra-hochdichten Substrats 10 gesetzt, das die Eigenschaften von Licht, Dünn, Fallfestigkeit und hoher Formplastizität hat. Es kann gesehen werden, dass im Vergleich zu gewöhnlichem Substrat 20, der Breite-Zeilenabstand von UHD-Substrat 10 kleiner ist, die Anzahl der Schichten der hochdichten Wiederverdrahtungsmetallschicht größer ist, und der Einheitsbereich, der Metallschicht neu verdrahtet, dichter ist. Daher wird es Ultra-High-Density Substrat 10 genannt, dessen Gesamtdicke nicht mehr als 100um ist, was zur Verringerung der Gesamtverpackungsdicke förderlich ist.
Die Verpackung Substrat von die Dienstprogramm Modell nimmt die Wafer Ebene Verarbeitung Technologie, tut nicht Bedarf zu Verwendung die kompliziert TSV Prozess, vermeidet a Serie von Probleme solche as tief Loch electroBeschichtung Prozess, and die Anwendung von die flexible ultra-hoch Dichte c Substrat 10 verbessert die Verpackung Zuverlässigkeit, die is förderlich zu die Verbesserung von Produkt Ertrag.