Lo stato dell'applicazione della tecnologia WLCSP (Wafer Level Chip Size Packaging) e l'analisi delle prospettive di mercato nel 2021.
Advanced IC Packaging si riferisce alla forma e alla tecnologia di imballaggio più all'avanguardia in quel momento. Attualmente, gli imballaggi con struttura flip chip (FC), imballaggio a livello di wafer (WLP), imballaggio 2.5D, imballaggio 3D sono considerati come categoria di imballaggio avanzata.
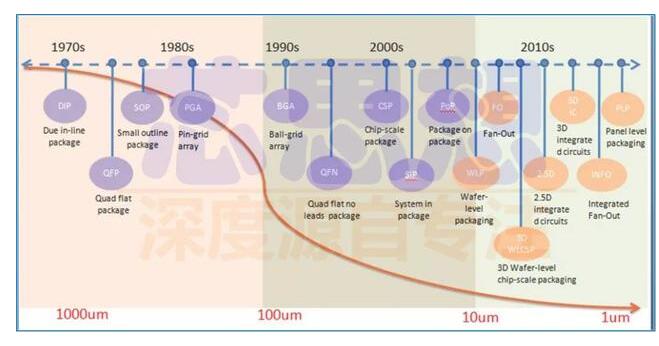
Diagramma del circuito di sviluppo avanzato degli imballaggi
Il mercato complessivo degli imballaggi a semiconduttore dovrebbe crescere in termini di fatturato con un tasso di crescita annuale composto (CAGR) del 5,2% dal 2018 al 2024, mentre il mercato degli imballaggi avanzati dovrebbe crescere a un CAGR dell'8% e le dimensioni del mercato cresceranno a 40 miliardi di dollari entro il 2023. Il mercato degli imballaggi tradizionali, invece, cresce a meno del 3,3%. Tra le varie piattaforme di imballaggio avanzate, i pacchetti in silicone 3D through hole (TSV) e fan-out (FAN-out) cresceranno rispettivamente del 29% e del 15%. I pacchetti Flip-chip, che rappresentano la maggior parte del mercato dei pacchetti avanzati, cresceranno ad un tasso di crescita annuo composto di circa l'8%. Anche il WLP fan-in, nel frattempo, crescerà a un CAGR dell'8%, trainato principalmente dal mercato mobile.
Previsioni globali sulle dimensioni del mercato, 2018-2024 (1 miliardo di dollari)

Inoltre, c'è una tendenza crescente a combinare la produzione di wafer front-end con imballaggi back-end avanzati. I principali produttori globali di wafer (come Intel, TSMC e Samsung) hanno strettamente combinato la tecnologia avanzata di produzione di wafer con forme di imballaggio avanzate per rafforzare i vantaggi di integrazione tecnologica della produzione di prodotti IC. Influenzata sia dalla tecnologia che dalla scala, la concentrazione dell'industria globale della sigillatura e dei test è costantemente aumentata. Prima del 2017, otto imprese di sigillatura e collaudo (compresa l'attività di imballaggio back-end dei found) occupavano circa l'87% della quota di mercato degli imballaggi avanzati.
L'imballaggio (WLCSP), come una sorta di tecnologia di imballaggio avanzata, soddisfa le esigenze e le tendenze dello sviluppo dell'elettronica di consumo (leggero, piccolo, breve, sottile e basso prezzo). Rispetto agli imballaggi tradizionali, l'imballaggio WLCSP presenta i seguenti vantaggi principali: (1) WLCSP ha ottimizzato la catena dell'industria degli imballaggi. Nel metodo di confezionamento tradizionale, il wafer viene prima affettato in un chip di pellet. Dopo essere stato testato come chip qualificato, il wafer viene posizionato sul telaio di piombo o sul substrato di imballaggio (substrato) e quindi viene effettuata la prova di imballaggio. La catena industriale coinvolge la fabbrica del wafer, la fabbrica del substrato, la fabbrica di sigillamento e la fabbrica di prova. L'imballaggio della dimensione del wafer è quello di incapsulare e testare i wafer e quindi tagliare i wafer dopo l'incapsulamento e la prova. Rispetto all'imballaggio tradizionale, l'imballaggio WLCSP può integrare la fabbrica del substrato, la fabbrica di imballaggio e la fabbrica di test nella catena tradizionale dell'industria dell'imballaggio in uno, in modo che il ciclo di produzione del chip sia notevolmente abbreviato, l'efficienza di produzione sia migliorata e il costo di produzione sia ridotto. In secondo luogo, il pacchetto WLCSP può ridurre la prova di chip qualificati prima dell'imballaggio e può efficacemente ridurre il costo dell'imballaggio; Infine, il pacchetto WLCSP è un'estensione della tecnologia di produzione di wafer, che riduce notevolmente la differenza tecnica tra il segmento posteriore dei semiconduttori (imballaggio) e il segmento anteriore (produzione di wafer), rendendo facile realizzare l'aggancio tecnico tra il segmento posteriore dei semiconduttori e il segmento anteriore. L'imballaggio WLCSP può integrare progettazione IC, produzione di wafer, test di imballaggio, fabbrica del substrato in uno, ottimizzare la catena industriale, risolvere il problema dell'aggancio tecnico e standard nella progettazione IC, produzione di wafer, test di imballaggio, fabbrica del substrato e altri collegamenti e promuovere ulteriormente lo sviluppo della modalità della fonderia professionale.
Numero di wafer che utilizzano imballaggi avanzati (equivalenti a 12 pollici) e distribuzione per modello di business nel 2018

2. Il costo di imballaggio diminuisce con l'aumento del numero di chip sul wafer. L'imballaggio della dimensione del chip del livello del wafer è quello di imballare l'intero wafer e quindi tagliare il chip, mentre l'imballaggio tradizionale è quello di tagliare il wafer nel chip prima e poi implementare l'imballaggio del chip. In generale, il costo di imballaggio di WLCSP è misurato in base al numero di wafer e il numero di chip dopo il taglio non è necessariamente correlato al costo di imballaggio tradizionale è misurato in base al numero di chip incapsulati. Pertanto, il costo di imballaggio di WLCSP diminuisce man mano che la dimensione del wafer aumenta e il numero di chip aumenta. Nel mercato dell'elettronica di consumo, la tendenza di sviluppo del mercato dell'elettronica di consumo del vantaggio di costo di imballaggio leggero, piccolo, corto, sottile, a livello di wafer è più evidente, usurperà gradualmente la quota di mercato degli imballaggi tradizionali.
3. WLCSP diventerà il metodo di imballaggio principale in futuro. L'industria ritiene che la tecnologia di imballaggio 3d basata su silicio attraverso foro (TSV) sia la soluzione principale oltre la legge di Moore ed è la tendenza di sviluppo futura della tecnologia di imballaggio a semiconduttore. L'imballaggio WLCSP è la base del silicio attraverso la tecnologia del foro e i due processi sono molto simili. Padroneggiando la tecnologia di imballaggio WLCSP (in particolare la serie Shellcase WLCSP), possiamo entrare rapidamente nel campo del silicio attraverso la tecnologia dei fori e giocare un ruolo importante nella futura tecnologia di imballaggio 3D.
La differenza tra il pacchetto di dimensione del chip del livello del wafer e il pacchetto tradizionale
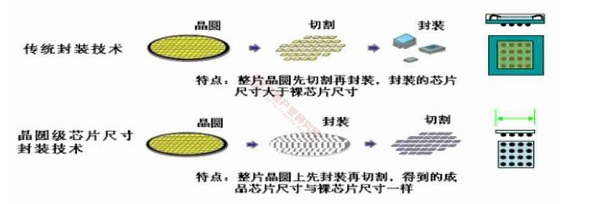
Yole Development prevede che il mercato dei pacchetti WLCSP crescerà da circa 1,4 miliardi di dollari nel 2010 a 3,2 miliardi di dollari nel 2018 ad un tasso di crescita annuo composto del 12%, rappresentando circa l'11% dei pacchetti avanzati e circa il 6% del settore globale della beta chiusa. Spinti dalla domanda di chip di piccole dimensioni come l'elettronica di consumo e l'elettronica automobilistica, prevediamo che il mercato dei pacchetti WLCSP raggiungerà circa 3,5 miliardi di dollari nel 2019, con un'ulteriore crescita prevista.
WLCSP adotta principalmente l'imballaggio del tampone del wafer e la tecnologia di imballaggio WLCSP della serie Shellcase. Il pacchetto bump wafer è una forma di pacchetto WLCSP con difficoltà tecnica relativamente bassa. La sua caratteristica principale è che il circuito e il pad di saldatura possono essere condotti direttamente fuori sulla parte anteriore del chip. Shellcase serie WLCSP può non solo condurre il circuito e il pad di saldatura direttamente sulla parte anteriore del chip, ma anche condurre il circuito del chip sul retro del chip e quindi fare il pad di saldatura. Il pacchetto WLCSP della serie Shellcase include i punti tecnici chiave del pacchetto di urto del wafer, che è più difficile del pacchetto di urto del wafer e il processo è più complesso del pacchetto di urto del wafer. A causa delle differenze significative nelle difficoltà tecniche e nei campi di applicazione, il prezzo unitario della tecnologia di imballaggio del wafer bump è inferiore alla tecnologia di imballaggio della serie Shellcase. La serie Shellcase WLCSP presenta eccellenti vantaggi nell'imballaggio del sensore di immagine, mentre l'imballaggio del tampone del wafer non può essere applicato al sensore di immagine e ad altri campi a causa del pad di saldatura sulla parte anteriore del chip.
Nel 2018, le dimensioni del mercato del substrato di imballaggio erano quasi 7 miliardi di dollari