ウェハ上から単一のセルを切断し、それをカプセル化する技術は、半導体集積回路をカプセル化するための規範として数十年にわたって行われてきた。しかし、高い製造コストと現在のモジュールのRFコンポーネントが増加しているため、現在の主要半導体メーカーはこの方法を採用していない。そのため、ウェハレベルパッケージ(WLP)の出現は低コストパッケージの発展のパラダイムシフトを招いた。WLPは、ウェハパッケージデバイスを切断する前のウェハレベルパッケージ技術である。
標準的なツールとプロセスを使用して、WLPはウェハ製造プロセスの延長として使用されます。最終的には、製造されたWLP DIEは、チップ表面に金属化パッドを有し、ウェハを切断する前に各パッド上にパッドを堆積する。これにより、WLPを従来のPCB組立プロセスと互換性を持たせ、ウェハ自体でのデバイステストを可能にする。したがって、これは比較的低コストで効率的なプロセスであり、特にウェハサイズが増加し、チップDIEが収縮した場合には効果的である。過去数十年間、ウェハのサイズは直径の4インチ、6インチ、8インチから12インチに増加してきた。これにより、ウェハ当たりのDIE数が増加し、製造コストが削減される。電気的性能の点で、WLPは他のパッケージ技術より優れている。WLPデバイスが密集したRFモジュールに統合されると、デバイスとPCBとの間の相互接続が比較的短く、CSP技術で使用されるリード結合相互接続とは異なり、EM寄生結合が大幅に減少するためだ。
WLPチップフリップチップ技術
フリップチップ技術は、制御可能な折り畳みチップ接続(C 4)とも呼ばれ、IBMが1960年代に開発したいくつかのチップ組み立て技術の1つである。ワイヤボンディングに基づくパッケージ技術は、ハードウェア構築後の実験室で調整された自由誘導能力の面でより柔軟で、良好な熱伝導性を提供しているが、フリップチップパッケージ技術では半田バンプを使用して、パッケージ基板とチップ間の電気的接続をその入出力ピンの面で相対的な寸法低減、遅延低減、より良い分離を提供している。図1は、基板上のチップDIEの基本的な構造を示しており、チップ表面に成長したCuピラーの上部に溶接ボールがある。溶接点は通常充填型化合物でカプセル化され、溶接点に機械的支持を提供する。
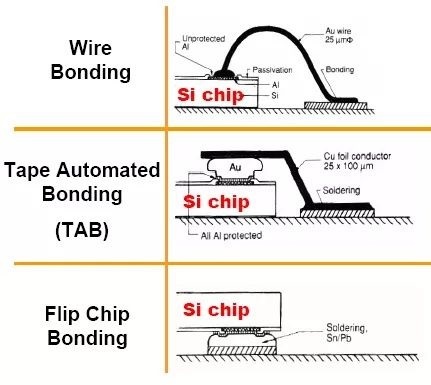
WLPチップレベルパッケージ
チップレベルパッケージ(CSP)は、マイクロエレクトロニクスおよび半導体産業において最も一般的なパッケージ方法の1つである。マイクロチップ製造業者はすでにいくつかのタイプのCSP技術を使用することができるが、新しいタイプのCSPは、新しい機能をサポートし、特定の製品を新たに適用するための需要を満たすために絶えず登場している。これらのパッケージ要件は、必要な信頼性、コスト、追加機能、全体的なサイズによって異なります。その名の通り、CSPのパッケージサイズはチップDIEサイズとほぼ同じであることが主な利点の1つです。WLP製造プロセスを採用することにより、CSPはできるだけ小さいパッケージダイの寸法比を実現するために発展している。図2に示すように、パッケージ中のボールグリッドアレイ(BGA)型CSPは複数の相互接続を可能にするとともに、PCB配線を簡略化し、PCB組立スループットを向上させ、製造コストを削減した。
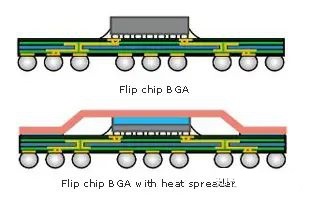
その他のパッケージ技術
他にもいくつかの形式の統合ICパッケージがあり、アプリケーションカスタマイズのモジュールパッケージにシームレスに統合することができます。4平面パッケージ(QFP)は、図3(a)に示すように、拡張された相互接続リードを有する4つの側面からなるパッケージの構造を有する、最も古い表面実装ICパッケージ技術の1つである。バンプされたリード線は、リード線とチップDIE金属との間に金属−絶縁体−金属(MIM)型キャパシタを形成するためのパッケージフレームに接続され、このキャパシタは整合素子として使用することができる。この技術はミリメートルサイズのICに適しており、パッケージ内の周辺ピンの数は100以上に達することができる。使用する材料によって、このタイプのパッケージにはいくつかの誘導体があります。例えば、セラミック四角平板パッケージ、薄い四角平板パッケージ、プラスチック四角平板パッケージ(プラスチック四角平板パッケージ)、金属四角平板パッケージ(MQFP)。QFN、Quad Flat No Lead、図に示すように。3(b)はいくつかの表面実装パッケージ技術の1つで、平らな銅リードフレームと放熱器の伝熱パッドとして使用されるプラスチックパッケージから形成されている。ワイヤボンディングは相互接続にも使用できます。ワイヤボンディングは導体だけでなくインダクタでもあるため、パッケージ技術におけるデバイスの性能に影響を与えることが多いので、全体的な設計の一部として扱わない限りです。QFNは4つの側面からなる相互接続であるが、2平面無リードリードリード線(DFN)もすでに現れ、相互接続平面リード線の両側を形成している。
