倒裝晶片,顧名思義,是一種將晶片的正面(製造IC電路的一側)向下連接到基板的封裝方法。 電信號端子由傳統焊料製成,並且可以與基板互連。 在這種類型的互連中,輸入和輸出端子(I/O)可以覆蓋整個晶片,囙此即使在相同的間距下,倒裝晶片互連的密度也遠高於引線接合的密度。 在引線鍵合互連中,I/O只能佈置在晶片周圍。 囙此,無論間距有多小,都無法實現倒裝晶片互連的I/O密度。 凸塊科技是整個倒裝晶片互連科技的關鍵。
晶圓凸塊科技概述製造晶圓凸塊的關鍵是沉積凸塊下金屬層(UBM)。 需要指出的是,IBM早期使用的術語是球約束金屬化層(BLM),其作用是:為互連提供結合層; 提供原子擴散阻擋層以防止凸塊資料的原子擴散到下麵的金屬結構; 下層介電材料和金屬提供粘附層並充當阻擋層以防止污染物沿著介電層的水准方向遷移到下層金屬。 現時使用的大多數UBM都是通過濺射工藝製成的。 濺射工藝是製造UBM最具成本效益的工藝。 特別是與蒸發過程相比。 影響焊點結構可靠性的最直接因素是UBM的生產質量。 一般來說,UBM結構必須能够承受多次(通常高達20次)回流而不會損壞。 由於UBM是一種用於將焊料凸塊和焊盤金屬化層結合在一起的結構,囙此它還必須通過剪切應力和拉伸應力測試。 在機械損傷測試中,焊料凸塊失效的一般標準是失效發生在焊料本身。 囙此,UBM必須具有足够的强度。 不會因時間、溫度、濕度和偏置電壓等因素而導致效能下降。
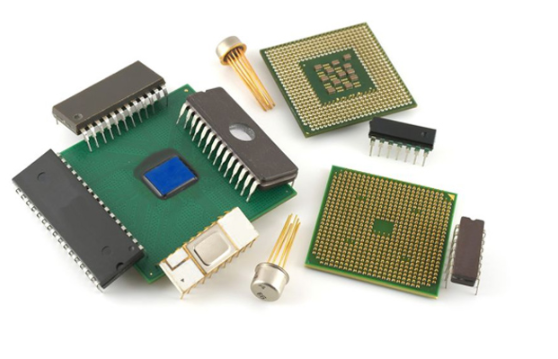
倒裝晶片市場趨勢倒裝晶片封裝已成為主流的封裝互連科技。 到目前為止,倒裝晶片實際上被認為是一種封裝,而不是一種互連科技。 例如,倒裝晶片球栅陣列封裝(FCBGA)主要使用分層基板科技來完成組裝和封裝過程,但僅限於高性能積體電路應用。 下圖顯示了倒裝晶片的應用領域:
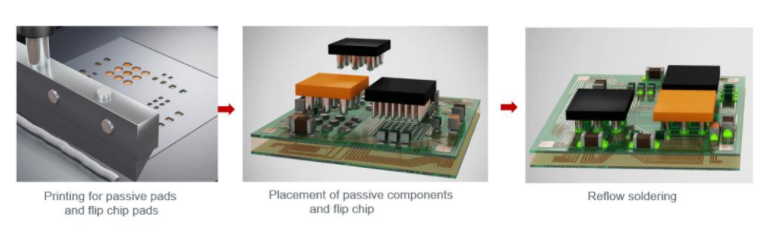
(1)凸點間距:减小凸點間距可以新增I/O密度; 瀝青變化的趨勢(從250微米逐漸過渡到125微米);
(2)焊點凹陷法:蒸發絲網印刷電鍍;
(3)凸塊焊料成分:高鉛含量低共晶無鉛(Sn-Ag)-Cu柱間距<125微米;
(4)包裝成分:陶瓷基板高密度互連層壓板基板預浸層壓板基板低熱膨脹係數層壓板基板? 無芯基板。
(5)封裝結構:密封單片蓋(SPL)-非密封單片蓋加强件+蓋裸片成型
傳統FCCSP的應用市場如下:
FCCSP應用市場:
(1)相對於晶片尺寸的凸塊(I/O)密度:用於大於200 I/O或大於5.5mm的晶片尺寸; 低密度產品使用WLCSP以獲得更好和更低的成本。
(2)低功率:一般功率<2w,取決於=“”on=“”chip=“”板級=“”封裝=“”can=“”be=“”used=“”for=“”power=“”bare=“”fccsp=““”>2w)。
(3)面積:對於手持設備,40nm/65nm科技减小了晶片尺寸,但更多的I/O使週邊I/O沒有足够的面積來佈置,囙此有必要使用基板引線來扇出該區域。
(4)價格:對於高I/O小尺寸晶片,週邊面積不足、Au線成本和用於引線扇出的大尺寸基板將推動價格有競爭力的FCCSP的發展。
(5)成型,易於測試和握持,常見形式與CABGA相同。
總結
倒裝晶片一直是一種令人興奮的封裝技術。 但與傳統的引線鍵合封裝相比,其成本限制了倒裝晶片成為主流科技。 然而,成本限制正在逐漸消除,並且條封裝倒裝晶片的使用顯著降低了它們的成本。 由於層壓基板佔據了大部分產品成本,囙此降低層壓基板的成本是降低倒裝晶片封裝成本的最有效方法。
此外,對於FPFC設計,Amkor進行了大量研究,將現有的面積陣列倒裝晶片設計轉變為精細間距設計。 80%的研究發現,細間距週邊設計可以降低襯底的成本,這是由於金屬層的减少和外部尺寸的减小。 通過降低倒裝晶片封裝基板的成本(其成本最高),可以使倒裝晶片封裝在其他市場廣泛使用。