晶圓級晶片封裝科技
WLCSP, 亦稱為 晶圓級晶片級封裝技術 用英語, 與傳統晶片不同 包裝材料 method (cutting and then sealing, 之後,至少新增了原晶片體積的20% 包裝材料). 這項最新技術是首先對整個晶圓進行封裝和測試, 然後將其逐個切割成IC顆粒, 因此, 之後的卷 包裝材料 等於IC裸晶體的原始尺寸. 它被稱為未來的主流 包裝科技. Manufacturers that have been invested in R & D include FCT, Aptos公司, 卡西歐, 敘事詩, 富士通, 3菱電子, 等.
它直接完成晶圓上的所有操作,從而結束前端晶圓製造過程. In the 晶片封裝 過程, 晶片與晶圓分離, 因此 WLCSP 可以達到最小值 包裝材料 具有相同晶片大小的卷, 幾乎是決賽了 包裝材料 miniaturization 科技.
晶圓級晶片級封裝技術, integrating thin-film passive device 科技 and large-area specification manufacturing technology, 不僅提供了節約成本的解決方案, 而且還提供與現有表面貼裝裝配工藝一致的形狀因數. 切屑秤 包裝材料 科技不僅提供了效能改進路線圖, 同時也减小了集成無源器件的尺寸.
自1.998年宣佈WLCSP科技的可行性以來,近年來市場上出現了各種類型的WLCSP。 該科技已用於移動電子設備,如手機電源晶片,並擴展到邏輯產品的應用。
WLCSP 是倒裝晶片互連科技的一種變體. 借助於 WLCSP科技, 將裸晶片的活動表面倒置,並用錫球連接到PCB. The size of these solder balls is usually large enough (300 at 0.5mm spacing and pre reflow) m m), 倒裝晶片互連所需的底部填充工藝可以省略
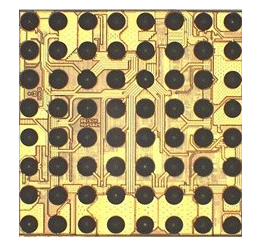
WLCSP包裝
WLCSP可分為兩種結構類型:直接凹凸層和重分佈層(RDL)
直接碰撞
直接碰撞 WLCSP contains an optional organic layer (polyimide) that acts as a stress buffer on the surface of the active die. 聚醯亞胺覆蓋整個裸晶片區域,除了連接墊周圍的視窗區域. A subbump metal layer (UBM) is sputtered or electroplated over 這 windowed area. UBM是一堆不同的金屬層, 包括擴散層, 阻擋層, 潤濕層和抗氧化層. The solder ball falls on the UBM (so called drop ball), 再通過回流焊形成焊料凸點.
再分配層(RDL)
再分配層(RDL) WLCSP this technology can convert bare chips designed for bonding lines (bonding pads are arranged around) into WLCSP. 與直接碰撞不同, this WLCSP 使用兩層聚醯亞胺. 第一聚醯亞胺層沉積在裸晶片上,並將焊盤保持在視窗狀態. RDL層通過濺射或電鍍將週邊陣列轉換為面陣列. 後續結構類似於直接凹凸-包括第二聚醯亞胺層, UBM和一個落球.
WLCSP的優勢:
The 包裝材料 的模式 WLCSP 不僅有效地减小了記憶體模組的大小, 同時也滿足了移動設備對人體空間的高密度要求; 另一方面, 在效能方面, 它提高了資料傳輸的速度和穩定性. 可使用標準SMT組裝設備,無需底充工藝.
1、原晶片封裝方法的最小尺寸:
The biggest feature of WLCSP 晶圓級晶片封裝 有效减小包裝體積,使包裝形狀更輕更薄. 因此, 它可以與移動設備相匹配,以滿足羽量級和短小便攜產品的特性要求.
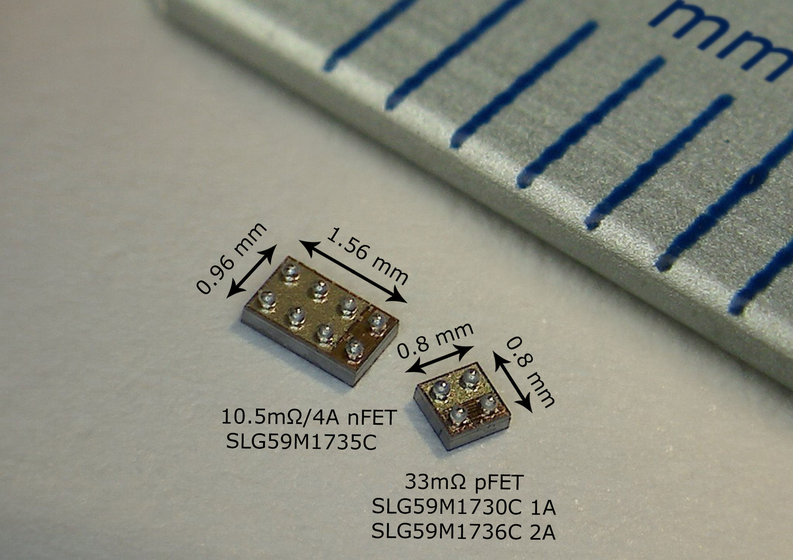
最小尺寸包裝
2、資料傳輸路徑短,穩定性高:
使用時 WLCSP包裝, due to the short and thick circuit wiring (yellow line marked a to b), 它可以有效地提高資料傳輸的頻率, 降低電流消耗,提高資料傳輸的穩定性. 由於焊接過程中輕型裸板的自校準特性, 裝配成品率高.
3、良好的散熱特性
因為 WLCSP 具有較不傳統的密封塑膠或陶瓷 包裝材料, IC晶片運行期間的熱能可以在不新增主體溫度的情况下有效耗散. 此功能對移動設備的散熱有很大幫助. 它可以降低電感,改善電力效能.
WLCSP不僅可以實現高密度、高性能封裝和sip的重要科技,而且在器件嵌入PCB科技中起著關鍵作用。 雖然引線鍵合工藝非常成熟和靈活,但多層電路、精細圖形以及WLCSP科技與引線鍵合的結合表明,它將有更廣泛的應用和新的機遇。
WLCSP的缺點:WLCSP的成本來自晶圓或封裝加工。 如果需要大規模生產,則需要新增勞動力數量。 這將相應地新增生產成本。
的未來 WLCSP科技
WLCSP 已應用於手機, 存儲卡, 汽車導航器和數位設備自2000年應用於電子手錶以來. 未來幾年, 將有更多的晶片使用 WLCSP科技 在手機等高效能移動市場.
WLCSP科技與晶片嵌入PCB工藝相結合,可以保證PCB組裝質量的穩定性。 這是因為WLCSP不僅易於安裝PCB,而且具有“已知良好模具”的特點。
WLCSP科技 為生產輕質緊湊的電子設備帶來更多可能性. WLCSP 已應用於電路板組裝. 不久前, 它也已成為SIP的重要組成部分. MCP組合 WLCSP 傳統的引線鍵合科技也已進入批量生產.
展望 WLCSP 近年來, 我們完全可以相信 WLCSP 將在不久的將來繼續發展並擴展到更多領域.