Das Prinzip und die Anwendung von 3D IC Packaging
Die 2.5D-Vermittlungsschicht ist eine Konfiguration, bei der die Rohrkerne nebeneinander auf einer Silizium-, Glas- oder organischen Vermittlungsschicht unter Verwendung eines Silizium-Durchgangslochs (TSV) durch die Vermittlungsschicht installiert werden. (Wenn Glas oder organische Laminate als Substrat für die Zwischenschicht verwendet werden, werden sie durch Glas durch Löcher (TGV) bzw. Substrat durch Löcher (TSV) genannt.) Die Kommunikation zwischen den Kernen erfolgt über eine Schaltung, die auf der Zwischenschicht hergestellt wird.
CMOS-Bildsensoren (CIS) verfügen über TSV als rückseitige Bohrungen, um Verbindungen zu bilden, wodurch Lead Key Merges eliminiert werden, was eine geringere Größe und eine höhere Dichte ermöglicht. In allen Arten von 3D-Gehäusen kommunizieren die Chips im Gehäuse über Off-Chip-Signale, als wären sie in einem separaten Gehäuse auf einer normalen Leiterplatte montiert.
3D-IC kann in 3D gestapelte IC (3D-sic) unterteilt werden, was bedeutet, dass der IC-Chip gestapelt und mit TSV verbunden ist; Und echte 3D-ICS, die das FAB-Verfahren verwenden, um mehrere Geräteschichten auf einem einzigen Chip zu stapeln, können sehr fein angeordnete TSVS verwenden, um Verbindungen zu bilden.
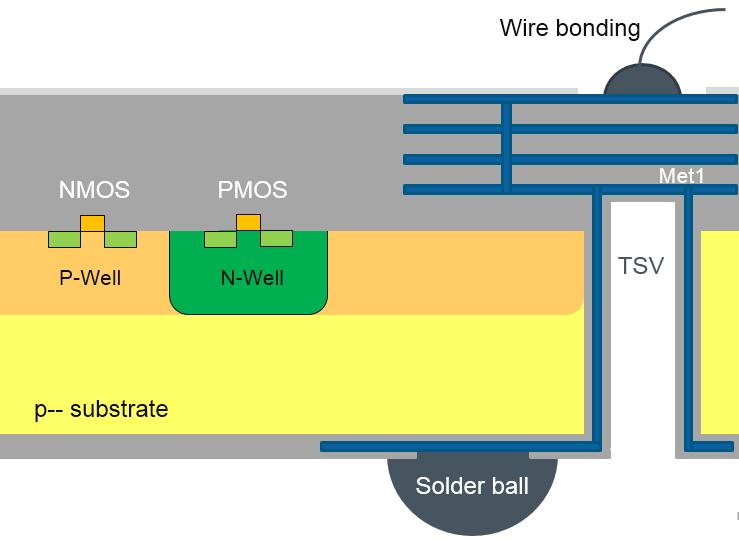
Silicon Through Holes (TSV) sind Löcher, die in Siliziumwafern durch Ätzverfahren erzeugt werden. Die Verbindung entsteht durch Befüllen des TSV mit einem leitfähigen Material wie Kupfer, Wolfram oder Polysilicium (Abbildung 2). Der Hauptvorteil von TSV-Verbindungen besteht darin, dass sie den Weg verkürzen, durch den Signale von einem Chip zum nächsten oder von einer Schaltungsschicht zur nächsten reisen. Dies ermöglicht eine reduzierte Leistung und die Fähigkeit, die Verbindungsdichte zu erhöhen, wodurch Funktion und Leistung verbessert werden. Der TSV selbst ist kein 3D IC. Stattdessen sind sie die Basis, um 3D-ics zu ermöglichen. Die rückseitigen Durchgangslöcher werden auch in anderen Geräten wie Bildsensoren, mikroelektromechanischen Systemen (MEMS) und Verbundhalbleitern verwendet.
Was ist die Bedeutung von monolithischem 3D IC?
Anstatt Wafer oder Module zu stapeln, um einen 3D-IC zu erstellen, beginnt ein monolithischer 3D-IC mit einem Basiswafer, auf dem zusätzliche Schichten wie kristallines Silizium, Metallschichten sowie aktive und passive Schaltkreise mit traditionellen FAB-Geräten hinzugefügt werden (Abbildung 2). Vertikale Verbindungen werden zwischen Schichten und nicht zwischen Chips gebildet, die Durchgangslöcher im Nanometer- und nicht im Mikronbereich verwenden; Dasselbe wie TSV. Es werden verschiedene Ansätze entwickelt, vor allem für In-Memory-Anwendungen. Integrales 3D wird manchmal als sequentielles 3D bezeichnet.
Was ist 3D-Speicher?
Viele Methoden wurden entwickelt, um Speicher senkrecht zu zwei nichtflüchtigen (NAND Flash) und flüchtigen (DRAM) Speichergeräten zu stapeln. DRAM-Methoden umfassen High Bandbreitenspeicher (HBM), Microns Mixed Memory Cube und Tezzarons integriertes RAM (DiRAM). All dies basiert auf einem 3D IC mit TSV (Abbildung 3). Samsung, Toshiba und viele andere entwickeln 3D NAND Flash basierend auf ganzheitlichen 3D Ansätzen.
Was sind die Vorteile der 2.5D Inserter Technologie?
Ursprünglich als Brückentechnologie für 3D-ics entwickelt, hat sich die 2.5D-Technologie zu einer Verpackungsplattform entwickelt, die voraussichtlich mit 3D-ics koexistieren wird. Im Gegensatz zu 3D-IC benötigt nur die Zwischenschicht (nicht der Kern selbst) das TSV, um den aktiven Kern mit dem Paketsubstrat zu verbinden. Dies ermöglicht die Verwendung bestehender Formendesigns.
Was sind die wichtigsten technischen Treiber der 3D-Integration?
Die gestiegenen Kosten für diesen Lithographieschritt und die Waferverarbeitung im Allgemeinen am Knoten der Chips der nächsten Generation treiben die Industrie dazu an, nach Alternativen zu suchen, um die Leistung und Funktionalität unserer elektronischen Geräte zu verbessern und Kosten zu senken. Die Notwendigkeit, verschiedene Technologien (Logik, Speicher, HF, Sensoren usw.) in kleinen Größen zu integrieren, treibt die Industrie dazu an, die 3D-Integration als Lösung zu nutzen.
Was sind die Markttreiber für die 3D-Integration?
Der Markttrieb für 3D-Integration (3D-Integration) beginnt mit High-End-Computing, Servern und Rechenzentren, Militär- und Luft- und Raumfahrt sowie medizinischen Geräten, da diese am meisten nachgefragt sind und die Kosten aktueller 3D-Integrationstechnologien tragen können. Auch Tablets, Smartphones und Gaming-Geräte treiben die Technologie an.
Welche Herausforderungen stehen vor 3D-ics?
Während viele behaupten, dass es keine weiteren technischen Herausforderungen gibt und dass die verbleibenden Probleme leicht behoben werden können, erfordern einige Prozessschritte immer noch bessere Lösungen, wie Entwurfswerkzeuge für die Planung, Implementierung und Verifizierung von 2,5D- und 3D-IC, Waferverarbeitung, Thermomanagement und Tests. Die größten Herausforderungen sind aktuelle Stückkosten, geringe Mengen und Implementierungsrisiken aufgrund der Reifung des Ökosystems. Es werden Anstrengungen unternommen, die Prozesskosten zu senken und die Zusammenarbeit in der gesamten Branche zu vereinfachen. Eine höhere Produktion wird dazu beitragen, die Kosten zu senken. Viele 3D-Experten glauben jedoch, dass die Implementierung von 3D-IC die Systemkosten erheblich senken wird, und dass die verbleibende Herausforderung darin besteht, Systemingenieure über die Vorteile des Entwurfs von 3D-ics in ihren Systemen aufzuklären.
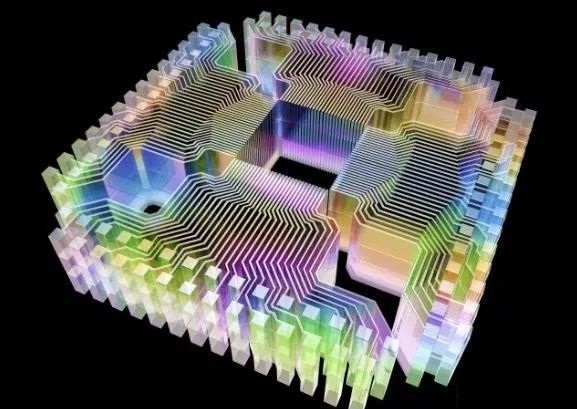
Der CMOS-Bildsensor (CIS) ist eines der ersten Geräte, das Durchgangsloch-zurück-Durchgangsloch in großen Mengen implementiert. CIS mit Hintergrundbeleuchtung (BSI) ist jetzt in Produktion, und da der CIS auf dem IC gestapelt ist, handelt es sich um ein 3D-IC-Gerät (Abbildung 2). Xilinx stellte im 2011 ein 2,5D Plug-in Design für alle programmierbaren FPgas seiner Virtex-7 Serie vor. In den letzten Jahren hat Tezzaron kleine Mengen DiRAM geliefert.
Ende 2014 beginnen Micron und Samsung mit der Produktion von Hybrid Storage Cubes (HMCS), die 3D DRAM Stacks auf Logikgeräten sind. SK Hynix stellt sowohl HMC als auch HIGH Bandbreitenspeicher (HBM) zur Verfügung. Die Massenproduktion dieser integrierten 3D-Speichergeräte erfolgte in 2014/15 und setzte danach noch einige Jahre Logikstacks und heterogene Geräte ein.
iPCB wird alle Informationen mit Ihnen teilen!