In den letzten hundert Jahren wurde mit der schnellen Entwicklung der integrierten Schaltung die IC-Verpackungsplattentechnologie auch verbessert, DER Anwendungsbedarf der IC-Industrie wird größer und größer, die Integration wird höher und höher. Der allgemeine Entwicklungsprozess des Verpackens: TO-DIP-PLCC-QFP-PGA-BGA-CSP-MCM, die technischen Indikatoren werden Generation für Generation weiterentwickelt, das Chip-Bereich- und Paketflächenverhältnis ist näher und näher an 1, elektrische Leistung und Zuverlässigkeit verbessern sich allmählich, das Volumen ist kleiner und dünner.
1.MCM (Mehrchipkomponente)
Tatsächlich ist es eine Chipkomponente, die neueste Technologie. Es handelt sich um eine Verpackungstechnologie, die mehrere Halbleiterchips auf einem Verdrahtungssubstrat montiert. Dadurch werden IC-Verpackungsmaterialien und -Prozesse eliminiert und Materialien gespart. , bei gleichzeitiger Reduzierung des notwendigen Herstellungsprozesses, so streng genommen ist das Produkt eine Montage mit hoher Dichte
Öffnen Sie Tencent News, um mehr Bilder zu sehen
2. CSP (Chip-Level-Paket)
CSP-Paket ist Chip-Level-Paket. Wie wir alle wissen, sind Chips im Wesentlichen klein. Daher kann CSP-Paket der neuesten Generation der Speicherchip-Verpackungstechnologie das Chip-Bereich-Paket-Verhältnis von mehr als 1:1.14, ziemlich nahe machen. Die ideale Situation von 1:1 wird von der Industrie als höchste Form von Einzelchip bewertet. Verglichen mit THE BGA Package Board, kann das CSP Paket die Speicherkapazität um das Dreifache im gleichen Raum erhöhen. Dieses Paket zeichnet sich durch eine geringe Größe, eine große Anzahl von Ein-/Ausgangsklemmen und eine gute elektrische Leistung aus. Es gibt CSP BGA (Ball Grid Array), LFCSP (Lead Frame), LGA (Grid Array), WLCSP (Wafer Level) und so weiter.
1.CSP BGA

2. LFCSP (Leitstruktur)
LFCSP, dieses Paket ähnelt dem Lead Frame, der herkömmliche Kunststoff-Verpackungsschaltungen verwendet, ist aber kleiner und dünner in der Dicke, mit Fingerpads, die bis in den inneren Bereich des Chips reichen. Der LFCSP ist eine Kunststoffverpackung auf Basis eines Bleirahmens. Die interne Verschaltung des Pakets wird in der Regel durch Verdrahtung erreicht, und die externe elektrische Verbindung wird erreicht, indem die peripheren Pins an die Leiterplatte geschweißt werden. Neben Stiften verfügen LFCSPS typischerweise über größere freiliegende Wärmepads, die zur Verbesserung der Wärmeableitung mit der Leiterplatte verschweißt werden können.
3. LGA (Grid Array)
Dies ist ein Grid-Array-Paket, ähnlich wie BGA, nur dass BGA gelötet ist, während LGA jederzeit entsperrt und ersetzt werden kann. Das heißt, es ist im Vergleich zum BGA austauschbar, aber der Austauschprozess muss sehr vorsichtig sein.
4. WLCSP (Wafer Level)

4. BGA (Kugelgitter Array)
Eines der Kugelkontaktarrays, Oberflächenmontagepakete. Auf der Rückseite der Leiterplatte werden kugelförmige Bulks anstelle von Stiften im Anzeigemodus hergestellt, und der LSI-Chip wird auf der Vorderseite der Leiterplatte montiert, die dann mit gegossenem Harz oder Verguss versiegelt wird. Auch bekannt als Bump Display Carrier (PAC). BGA umfasst hauptsächlich: PBGA (Kunststoffpaket BGA), CBGA (Keramikpaket BGA), CCBGA (Keramikzylinderpaket BGA), TBGA (Trägerpaket BGA) und so weiter. Derzeit verwendete BGA-Verpackungsgeräte, je nach Substrattyp, umfassen hauptsächlich CBGA (Keramikgitter-Array-Paket), PBGA (Kunststoffgitter-Array-Paket), TBGA (Trägergitter-Array-Paket), FC-BGA (Flip-Chip-Raster-Array-Paket), EPBG (verstärktes Kunststoffgitter-Array-Paket), etc.
4-1 CBGA (Keramik)

CBGA hat die längste Geschichte in der BGA-Paketfamilie. Die Grundplatte ist mehrschichtige Keramik, und die Metallabdeckplatte wird auf der Grundplatte mit Dichtungslot geschweißt, um den Chip, die Leitung und das Pad zu schützen. Dies ist ein Oberflächenmontagepaket mit einem Satz von Löten an der Unterseite für einfachen Zugriff.
4-2FCBGA
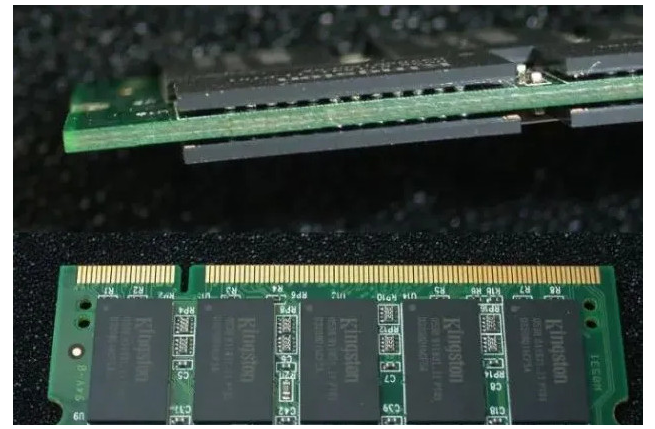
FCBGA realisiert die direkte Verbindung zwischen Chiplötkugel und BGA-Substrat durch Flip-Chip. In BGA-Produkten kann eine höhere Packungsdichte erreicht und eine bessere elektrische und thermische Leistung erreicht werden.
4-3PBGA

BGA-Paket, verwendet es BT-Harz/Glaslaminat als Substrat, Kunststoff-Epoxidformplastik als Dichtungsmaterial. Diese Art von Verkapselungschip ist empfindlich gegen Feuchtigkeit und eignet sich nicht für Geräteverkapselung mit hohen Anforderungen an Luftdichtigkeit und Zuverlässigkeit.
4-4 SBGA

SBGA verwendet ein fortschrittliches Substratdesign, einschließlich Kupferlamellen für eine verbesserte Wärmeableitung, während zuverlässige Montageprozesse und Materialien verwendet werden, um eine hohe Zuverlässigkeit und überlegene Leistung zu gewährleisten. Durch die Kombination von hoher Leistung und geringem Gewicht wird ein typisches 35mm² SBGA-Paket auf eine Höhe von weniger als 1,4mm montiert und wiegt nur 7,09.
5.PGA (Needle Grid Array)

Stiftverkapselung anzeigen. In einem Plug-in-Paket sind die vertikalen Pins auf der Unterseite in einem Array angeordnet. Das Verpackungssubstrat ist im Grunde ein mehrschichtiges Keramiksubstrat. Verwendet für High-Speed große logische LSI Schaltungen. Pins befinden sich an der Unterseite des Chips, typischerweise quadratisch, und der Abstand von der Mitte zum Pin beträgt im Allgemeinen 2.54mm. Die Anzahl der Pins variiert von 64 bis 447. Es gibt im Allgemeinen zwei Arten: CPGA (Ceramic Pin Grid Array Package) und PPGA (Plastic Pin Grid Array Package).
6. QFP (Quad Flat Package)
Diese Art von Paket ist ein quadratisches flaches Paket, normalerweise quadratisch, mit vier Seiten der Stifte. Dieses Paket implementiert, dass der CPU Chip Pin Abstand ist sehr klein, Pin ist sehr dünn. Im Allgemeinen nimmt große oder sehr große integrierte Schaltung dieses Paket an, die Anzahl der Stifte ist im Allgemeinen mehr als 100. Aufgrund der kleineren Packungsgröße werden parasitäre Parameter reduziert, die für Hochfrequenzanwendungen geeignet sind. Solche Pakete sind: In diesem Prozess, CQFP (Keramik Quad Flat Package), PQFP (Kunststoff Quad Flat Package), SSQFP (Selbst Binder Quad Flat Package), TQFP (Slim Quad) Flat Package), SQFP (Shrink Quad Flat Package)
1. LQFP (dünn)
Das ist ein dünner QFP. Bezieht sich auf den QFP mit einer Gehäusedicke von 1.4mm, der Name, der von der japanischen Elektronikmaschinenindustrie gemäß der neu entwickelten QFP-Formspezifikation verwendet wird.
2. TQFP (Thin Square)
7. LCC (bleifreier oder bleifreier Chipträger)
Ein keramischer Chipträger mit Stiften, einer eines Oberflächenpakets, mit Stiften, die von den vier Seiten des Gehäuses führen. Es ist ein Paket für High Speed hf IC, auch bekannt als Keramik QFN oder QFN-C.
1. CLCC (Flügelstift)
2. Am wenigsten entwickelte Länder
C-förmiger Stiftchipträger, der Stift wird von der Oberseite des Chips herausgezogen und in eine C-förmige Form gebogen
3.PLCC
Die Stifte werden von den vier Seiten der Verpackung gezogen und sind t-förmig und aus Kunststoff gefertigt. Stiftmittenabstand war 1,27mm und Stiftnummer reichte von 18 bis 84. Es ist einfacher zu bedienen als QFP, aber schwieriger, das Aussehen nach dem Schweißen zu überprüfen.
8. SIP (Single-in-Line Encapsulation)
Eine einzelne Inline-Paketleitung führt von einer Seite des Pakets in einer geraden Linie. Normalerweise ein Durchgang, die Stifte führen von einer Seite der Verpackung und sind in einer geraden Linie aufgereiht. Bei Montage auf einer Leiterplatte steht das Paket seitlich. Pin-Mittelabstand ist normalerweise 2.54mm, Pin-Zahl variiert von 2 bis 23, von denen die meisten kundenspezifische Produkte sind. Die Formen der Verpackungen variieren.
9. SOIC (kleiner IC)
SOIC ist ein kleines integriertes Schaltungspaket. Die Anzahl der externen Leitungen darf 28-Formstücke nicht überschreiten. Im Allgemeinen gibt es zwei Arten von Verkapselung: breiter Körper und schmaler Körper. Dies ist etwa 30-50% weniger Platz als das gleiche DIP-Paket. Die Dicke wird um ca. 70%.
10. SOP (kleine Verpackung)
SOP-Verpackungen sind eine Form der Komponentenverpackung. Allgemeine Verpackungsmaterialien sind: Kunststoff, Keramik, Glas, Metall und so weiter, jetzt die grundlegende Verwendung von Kunststoffverpackungen. Es hat eine breite Palette von Anwendungen, hauptsächlich in einer Vielzahl von integrierten Schaltungen verwendet. Dann kamen TSOP (dünnes kleines Profil Paket), VSOP (sehr kleines Profil Paket), SSOP (reduziertes Profil Paket), TSSOP (dünnes reduziertes Profil Paket), MSOP (Mikroprofil Paket), QSOP (Viertel Größe Profil Paket), QVSOP (Viertel Größe sehr kleines Profil Paket) und andere.
1. SSOP (reduzierter Typ)
2. TSOP (dünnes kleines Formpaket)
3. TSSOP (Dünnreduktion)
11. SOT (kleiner Transistor)
SOT ist eine Art SMD-Paket. Für Geräte mit weniger als 5-Pin (3pin, 4pin) wird in der Regel das SMD-Paket übernommen. Kleine Größe, viele Transistoren werden in diesem Paket verwendet.
Dies ist auch ein Transistorpaket. Im Allgemeinen haben beide Seiten Stifte, die Anzahl der Stifte ist 3, 4, 5, die meisten nicht mehr als 7.
12. DIP (Doppeldrahtpaket)
DIP-Pakete werden auch als Dual-Inbegriffenpakete oder Dual-Inbegriffenpakete bezeichnet. Die meisten kleinen und mittleren integrierten Schaltungen verwenden diese Form der Verpackung, Pin-Nummer ist in der Regel nicht mehr als 100. Chips in diesem Paket haben zwei Reihen von Leitungen. Stifte können direkt an eine DIP-Struktur-Spanmuffe oder an eine Schweißposition mit der gleichen Anzahl von Löchern geschweißt werden. Seine Eigenschaft ist, PCB-Board-Bohrschweißen leicht zu realisieren, gute Kompatibilität mit dem Motherboard.
1. CerDIP (Keramisches duales Inline-Paket)
Cerdip Keramik Dual In-Line Paket für ECL RAM, DSP (Digital Signal Processor) und andere Schaltungen. Cerdip mit Glasfenster wird für ULTRAVIOLET löschbare EPROM- und Mikrocomputerschaltungen mit eingebautem EPROM usw. verwendet.
2. PDIP (Kunststoffverpackung)
Diese Art von Kunststoff double-to-in-line-Paket ist ziemlich üblich. Geeignet für die Montage von Leiterplatten durch Bohrungen. Einfache Bedienung, kann IC-Socket Debugging verwenden. Aber die Packungsgröße ist viel größer als der Chip, Verpackungseffizienz ist sehr niedrig. Viel effektiver Einbaubereich.
13. TO (Transistorform Paket)
IC Packaging Board TO ist ein Transistorformpaket. Das eine ist ein Transistor-Gehäusetyp, der eine Oberflächenmontage ermöglicht, und das andere ist ein rundes Metallgehäuse ohne Oberflächenmontage-Komponenten. Dieses Paket ist weit verbreitet, viele Transistoren, MOS-Röhren, Thyristoren und so weiter werden dieses Paket verwendet.