1. Aus der Perspektive von SMT-Verarbeitung und Schweißen, Entwicklung von BGA-Verpackungen
Aus der Perspektive des smt-Schweißens ist die Montagetoleranz von BGA-Chips 0.3mm, die viel niedriger ist als die vorherige QFP-Chip-Montagegenauigkeitsanforderung von 0.08mm. Im Allgemeinen werden SMT Patch Proofing und Platzierung in einem Raum von der Größe eines kleinen Fingers oder sogar kleiner durchgeführt, dann bedeutet eine größere Platzierungstoleranz eine höhere Zuverlässigkeit und Platzierungsgenauigkeit.
Dann nehmen wir an, dass eine große integrierte Schaltung 400-I/O-Elektrodenpins hat, der gleiche Stiftabstand 1.27mm ist, und der traditionelle QFP-Chip hat 4-Seiten, jede Seite hat 100-Pins, dann die endgültige. Die Seitenlänge ist mindestens 127mm, so dass die gesamte Chipoberfläche 160 (Quadratzentimeter) sein sollte.
Wenn wir das BGA-Paket zur Verarbeitung verwenden, die Elektrodenstifte der SMT-Chip are evenly arranged under the chip in a 20*20 row, und die Seitenlänge muss nur 25 sein.Höchstens 4mm, and the volume is less than 7 (square centimeters). .
Aus der obigen Analyse können wir zwei große Verbesserungen schließen:
Eins: Die Anzahl der Chiplötstifte sinkt
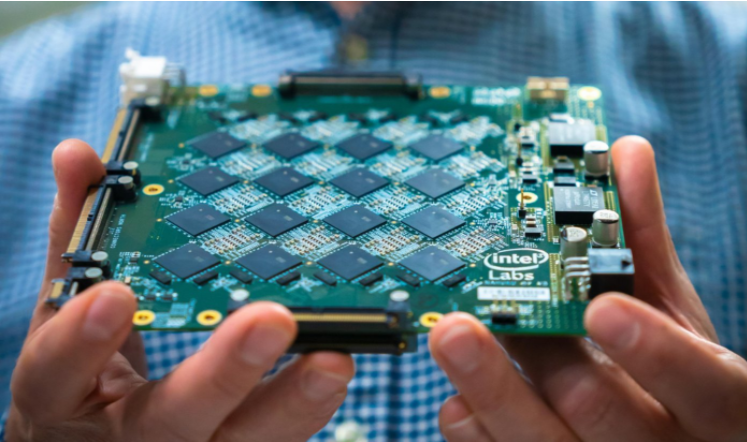
Wie das Sprichwort sagt: "Je mehr Sie tun, desto mehr Fehler machen Sie." Im Gegenteil, wir reduzieren die Anzahl und Verfahren des Schweißens so wenig wie möglich, so dass die Fehlerwahrscheinlichkeit geringer wird. Daher ist die Verringerung der Anzahl der gelöteten Stifte eine wichtige Methode, die die Qualität und Zuverlässigkeit des Schweißens verbessern kann. Es kann indirekt gesagt werden, dass BGA-Verpackungen enorme technische Vorteile und Entwicklungspotenziale gegenüber herkömmlichen QFP-Verpackungen haben.
2: Schweißvolumen wird kleiner
Von der Hirnschnittstelle von Tesla CEO Elon Musk bis zum Hautdisplay sehen wir nicht nur technologischen Fortschritt, sondern auch eine Anwendung hochintelligenter und miniaturisierter Produkte. Es gibt einen Computer, der ein paar Kilogramm am Himmel wiegt, so dass die Änderung des Lötvolumens auch einem zukünftigen Entwicklungstrend entspricht, und es ist auch ein großer Spätaufsteiger-Vorteil der BGA-Verpackung.
Daher, ob es sich um das PCBA-Paket von Arbeit und Materialien oder den zukünftigen Entwicklungstrend handelt, muss unsere Entwicklung von BGA-Verpackungen hell sein.
Zweitens der Hauptgrund für das unzureichende Zinn auf den Lötstellen der Smt Patch Verarbeitung
In der SMT-Patch-Verarbeitung ist das Löten ein wichtiges Glied, das mit der Leistung und dem Aussehen der Leiterplatte zusammenhängt. In der eigentlichen Produktion und Verarbeitung kann es aus einigen Gründen zu schlechtem Löten kommen, wie z.B. gewöhnlichen Lötstellen. Nicht voll, wirkt sich direkt auf die Qualität der SMT Patch Verarbeitung aus. Was ist also der Grund, warum das Blech bei der SMT Patch Verarbeitung nicht voll ist? Im Folgenden werden die Produktinspektionsanforderungen der Weilishi smt Patch Verarbeitung vorgestellt.
Die Hauptgründe für das unzureichende Zinn auf den Lötstellen der Smt Patch Verarbeitung:
1. Die Benetzungsleistung des Flusses in der Lötpaste ist nicht gut, und es kann die Anforderungen der guten Verzinnung nicht erfüllen;
2. Die Aktivität des Flusses in der Lötpaste reicht nicht aus, um die Oxide auf den PCB-Pads oder SMD-Lötpositionen zu entfernen;
3. Die Flussausdehnungsrate des Flusses in der Lötpaste ist zu hoch, und Hohlräume sind anfällig, zu erscheinen;
4. Das PCB-Pad oder SMD-Lötposition hat eine ernsthafte Oxidation, die den Zinneffekt beeinflusst;
5. Unzureichende Menge an Lötpaste an den Lötstellen führt zu unzureichendem Löten und Leerstellen;
6. Wenn an einigen Lötstellen nicht genügend Zinn vorhanden ist, kann der Grund sein, dass die Lötpaste vor Gebrauch nicht vollständig gerührt wurde und das Flussmittel und das Zinnpulver nicht vollständig geschmolzen werden können;
7. Die Vorwärmzeit ist zu lang oder die Vorwärmtemperatur ist während des Reflow-Lötens zu hoch, wodurch die Flussaktivität in der Lötpaste versagt;
Zur Zeit, die meisten Hersteller von SMT-Chips adopt advanced testing equipment to monitor the quality of the production process. Während des Reflow-Lötprozesses, AOI-Inspektionsausrüstung wird im Allgemeinen für die Qualitätskontrolle verwendet. Aufgrund der hohen Kosten der automatischen Parametereinstellung und Rückmeldung im Qualitätskontrollprozess, manuelle Einstellungen sind erforderlich. Unter diesen Umständen, Noch notwendiger ist es für elektronische Patch-Unternehmen, einige praktische und effektive Spezifikationen und Systeme zu formulieren., strikte Umsetzung der festgelegten Spezifikationen, und Prozessstabilität durch manuelle Überwachung erreichen. Bei der Formulierung von Qualitätskontrollspezifikationen für elektronische Patchpreise, Die Reaktionsfähigkeit der Bediener und die Steuerung der Ausrüstung sind sehr wichtig.