Porosität ist in der Regel ein Problem im Zusammenhang mit Schweißverbindungen. Besonders bei Verwendung Leiterplattentechnologie zum Reflowen der Lotpaste, bei bleifreien Keramikspänen, most of the large pores (>0.0005 Zoll/0.01 mm) are between the LCCC solder joints and the printed circuit board solder joints At the same time, in der Schweißnaht in der Nähe des LCCC Schlosses, es gibt nur wenige kleine Poren. Das Vorhandensein von Poren beeinflusst die mechanischen Eigenschaften der Schweißverbindung, und wird die Stärke beschädigen, Duktilität und Ermüdungslebensdauer der Verbindung. Denn das Porenwachstum verschmilzt zu dehnbaren Rissen und verursacht Ermüdung. Die Poren erhöhen auch die Spannung und Kovarianz des Lots, die auch die Ursache des Schadens ist. Die SMT-Chipverarbeitungsanlage in Shanghai wies darauf hin, dass, zusätzlich, das Lot schrumpft während der Erstarrung, Die Delamination des Abgases und des eingeschlossenen Flusses beim Löten galvanischer Durchgangslöcher sind auch die Gründe für die Porosität.
Im PCB-Lötverfahren ist der Mechanismus der Porenbildung komplizierter. Im Allgemeinen werden die Poren durch den Abgas des Flusses verursacht, das in das Lot in der Sandwichstruktur während des Reflows eingeschlossen ist (2,13) Die Bildung von Poren wird hauptsächlich durch die Lötbarkeit des metallisierten Bereichs bestimmt und ändert sich mit der Abnahme der Flussaktivität, der Zunahme der Metalllast des Pulvers und der Zunahme des Deckungsbereichs unter der Führungsverbindung.
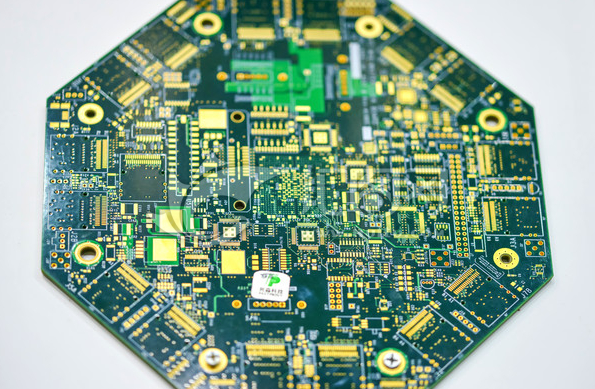
Verringerung der Größe der Lötpartikel kann nur die Porosität erhöhen. Darüber hinaus, Die Porenbildung hängt auch mit der Zeitverteilung zwischen der Koaleszenz von Lötpulver und der Eliminierung von festen Metalloxiden zusammen. Je früher die Lotpaste verschmilzt, je mehr Hohlräume entstehen. Allgemein, Der Anteil der großen Poren steigt mit der Zunahme der Gesamtporen. Verglichen mit der Situation, die sich aus den Analyseergebnissen der Gesamtporen ergibt, Diese lehrreichen Faktoren, die Poren verursachen, haben einen größeren Einfluss auf die Zuverlässigkeit von Schweißverbindungen. Some circuit board welding companies pointed out that methods to control the formation of pores include:
1. Verbesserung der Lötbarkeit von Leiterplattenkomponenten/Unterseite des Hemdes;
2. Verwenden Sie Fluss mit höherer Flussaktivität;
3. Reduzieren Sie Lotpulveroxide;
4.Verwenden einer inerten Heizatmosphäre.
5. Verlangsamen Sie den Vorwärmprozess vor dem Reflow. Verglichen mit der obigen Situation folgt die Porenbildung in der BGA-Versammlung einem etwas anderen Muster. Im Allgemeinen. Bei der BGA-Baugruppe mit Zinn 63-Lötblöten werden die Poren hauptsächlich während der Montagephase auf Platinenebene erzeugt. Auf der vorverzinnten Leiterplatte nimmt die Menge der Poren im BGA-Stecker mit der Flüchtigkeit des Lösungsmittels, der Metallzusammensetzung und der Zunahme der Reflow-Temperatur zu, und sie nimmt auch mit der Abnahme der Partikelgröße zu.; Dies lässt sich durch die Viskosität erklären, die die Austragsrate des Flusses bestimmt. Gemäß diesem Modell verhindert ein Flussmittel mit einer höheren Viskosität bei der Reflow-Temperatur, dass das Flussmittel aus dem geschmolzenen Lot entladen wird. Daher erhöht die Erhöhung der Menge des eingeschlossenen Flusses die Entladungsrate. Die Möglichkeit von Gas, was zu einer größeren Porosität in der BGA-Baugruppe führt. Ohne die Lötbarkeit der festen Metallisierungszone zu berücksichtigen, scheint der Effekt der Aktivität des Flusses und der Reflow-Atmosphäre auf die Porenerzeugung vernachlässigbar zu sein. was darauf hindeutet, dass die Faktoren, die Poren in BGA verursachen, einen größeren Einfluss auf die Zuverlässigkeit von Schweißverbindungen haben als die aus den Analyseergebnissen der Gesamtporen aufgezeigten. Die Auswirkungen sind ähnlich wie die Situation der leeren Stadt im SMT-Prozess.
Wenn sich die Lotpaste in einer beheizten Umgebung befindet, wird der Lotpastenfluss in fünf Stufen unterteilt. Zunächst beginnt das Lösungsmittel, das verwendet wird, um die erforderliche Viskosität und Siebdruckleistung zu erreichen, zu verdampfen, und der Temperaturanstieg muss langsam sein (etwa 3°C pro Sekunde), um Sieden und Spritzen zu begrenzen, um die Bildung von kleinen Zinnperlen zu verhindern. Darüber hinaus sind einige Komponenten empfindlicher auf innere Belastungen. Wenn die Außentemperatur der Leiterplattenkomponenten zu schnell ansteigt, verursacht dies einen Bruch.
Das Flussmittel ist aktiv und die chemische Reinigungswirkung beginnt. Das wasserlösliche Flussmittel und das nicht-saubere Flussmittel haben die gleiche Reinigungswirkung, aber die Temperatur ist etwas anders. Entfernen Sie Metalloxide und bestimmte Verunreinigungen von den zu verklebenden Metall- und Lotpartikeln. Gute metallurgische Zinnlöteverbindungen erfordern "saubere" Oberflächen
Wenn die Temperatur weiter ansteigt, schmelzen die Lötpartikel zunächst einzeln und beginnen den Prozess der Verflüssigung und Oberflächenabsorption von Zinn. Diese deckt alle möglichen Oberflächen ab und beginnt Lötstellen zu bilden.
Diese Phase ist die wichtigste. Wenn die einzelnen Lötpartikel alle geschmolzen sind, sie verbinden sich zu flüssigem Zinn. Zur Zeit, Die Oberflächenspannung beginnt, die Oberfläche des Lötfüßes zu bilden. Wenn der Spalt zwischen dem Bauteilstift und dem PCB-Pad übersteigt 4 Mio, Es ist höchstwahrscheinlich aufgrund der Leiterplattenoberfläche Spannung trennt das Blei vom Pad, die einen offenen Kreislauf an der Zinnpunkt verursacht. In der Kühlphase, wenn die Abkühlung schnell ist, die Zinnpunktfestigkeit wird etwas größer sein, aber es sollte nicht zu schnell sein, um Temperaturbelastungen innerhalb des Bauteils zu verursachen.