PCB wird hauptsächlich zum Verbinden und Fixieren von integrierten Schaltungen und anderen elektronischen Komponenten verwendet, so dass Signale zwischen verschiedenen elektronischen Komponenten zirkuliert werden können, so ist es bekannt als "die Mutter der elektronischen Systemprodukte". In den frühen Tagen, Leiterplatten konnte nicht in Massenproduktion hergestellt werden, da die Materialien und Verarbeitungsmethoden unreif waren. Bis die Transistoren Anfang der 1950er Jahre herauskamen, Leiterplatten waren auch weit verbreitet. Allerdings, heute, mit der Weiterentwicklung der Software- und Hardwareausrüstung und der kräftigen Entwicklung der Mobilkommunikation der fünften Generation, Artificial Intelligence (AI), Schleife, Netzwerkberechnung, und Smart City Technologien, die Erhöhung der Frequenz und Übertragungsgeschwindigkeit Leiterplatte die Leistungsanforderungen steigen.
Die Herstellungsverfahren für Leiterplatten can be divided into five major processes:
Material, Stapeln, Verbindung von Verbindungslöchern, Oberflächenveredelung und andere, führt hauptsächlich die ersten drei Elemente ein: Für den Materialteil sind die Materialien, die heute bei der Herstellung von Leiterplatten verwendet werden, hauptsächlich Verbundwerkstoffe, die später hinzugefügt werden. Einige Verstärkungsmaterialien Verstärkung und Füllstoffe verbessern die mechanischen Eigenschaften. Es ist einfach, Materialien in Leiter und Nichtleiter zu unterteilen, und die verwendeten Materialien beeinflussen die dielektrische Konstante (DK) und den Dissipationsfaktor DissipationsFactor (Df), die einen bestimmten Einfluss auf die Geschwindigkeit und Qualität des Übertragungssignals haben. Aufprall. Die zweite ist die Stapelstruktur, das heißt die Stapelmethode zwischen Schichten. Die traditionelle Methode besteht darin, den Kern mit Prepreg zu pressen, ihn entsprechend der Anzahl der Schichten zu pressen, die vom Benutzer benötigt werden, und dann Bohren zu verwenden, um Durchgänge für jede Schicht herzustellen. Die Verbindung zwischen ihnen; und der moderne Ansatz besteht darin, mit Folie auf der inneren Schicht des Kerns aufzubauen, und die Anzahl der Schichten kann auch nach den Bedürfnissen der Benutzer überlagert werden. Nach Abschluss der Stapelung ist es dann möglich, in die Form der Ermittlung der Verbindungslöcher einzugehen.
Traditionell, beim Stapeln, Jede Schicht muss durch Löcher verbunden werden. Allerdings, zu viele Löcher werden zu einer Störquelle in Hochgeschwindigkeitsprodukte für Leiterplatten, so müssen sie gebohrt werden. Die Toleranz der Maschine, die Drehzahl des mechanischen Bohrers, die Geschwindigkeit des Bohrvorschubs, etc. muss beachtet werden; jedoch, heute High-Density Inverter (HDI PCB) and each layer interconnect technology Every Layer Inter Connect (ELIC) use laser drilling to connect each layer. Danach, Galvanik wird in der Verbindungsform einer Vielzahl von verschiedenen Löchern durchgeführt, so dass sich das elektronische Signal zwischen verschiedenen Schichten bewegt, und die üblichen Lochtypen umfassen Durchgangslöcher, Stufenlöcher, Blinde Löcher, und vergrabene Löcher. Um den aktuellen Anforderungen an Hochgeschwindigkeits- und Hochfrequenzsysteme gerecht zu werden, wie niedrige dielektrische Konstante und ultra-niedriger Dissipationskoeffizient, Impedanz, Verlust, etc.
Die Leiterplatte hat begonnen, sich in Richtung fortschrittlicherer Technologie zu bewegen, die auch als fortschrittliche Hochfrequenz-Leiterplatte und Hochgeschwindigkeits-Leiterplatte bezeichnet werden kann. Unter ihnen sind die wichtigsten Beurteilungsindikatoren, die abgedeckt werden, die Anzahl der Schichten, die Linienbreite und den Linienabstand, die Kupferdicke sowie der Zustand und die Ausrichtungsfähigkeit der Durchkontaktierungen.
Im Allgemeinen, weil die Anzahl der Schichten der Leiterplatte stellt die Anzahl der unabhängigen Verdrahtungsschichten dar, je mehr Schichten, je besser die Technologie, aber je größer die Auswirkung auf den Ertrag; Linienbreite und Linienabstand sind ebenfalls wichtige Indikatoren, in der Regel die Leiterplatte kann auf Mikrometerebene fallen; in der Platine, wenn die Kupferdicke unten ungleichmäßig ist, das Dielektrikum wird auch ungleichmäßig, Daher sollte der Abweichung und Toleranz der Kupferdicke besondere Aufmerksamkeit geschenkt werden; im Teil des Durchgangslochs, Die aktuelle Galvanik-Technologie besteht darin, alle Löcher mit Kupferbeschichtung zu füllen, und der Standard zur Bewertung der Fähigkeit der Löcher basiert auf dem Seitenverhältnis, das Verhältnis der Dicke der Leiterplatte zur Öffnung darstellt. Wenn das Verhältnis des Seitenverhältnisses größer ist, es repräsentiert den Vorstand. Dicker, Kleinere Löcher tragen wesentlich zur allgemeinen Fräsdichte bei, aber eine Herausforderung für die Galvanik darstellen; Die letzte Auswertungsmetrik konzentriert sich auf die Ebenenausrichtung.
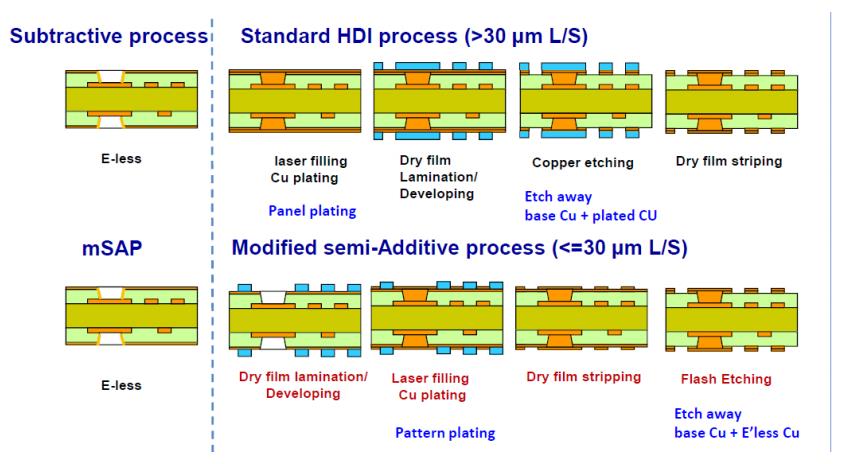
Register action Layer (RDL) and Flip Chip Ball Brid Array (FCBGA) technology are the latest technology, die Anzahl der Schichten kann 8 bis 20 Schichten erreichen, die Dicke des Mediums beträgt etwa 6 bis 10 Mikrons, und die Linienbreite und der Linienabstand sind etwa 12-30 Mikrons. Porengröße beträgt etwa 15 Mikrons. Die Vorteile des Panels sind geringe Kosten, geringe vertikale Höhe, keine Einheitengrenze, hohe Dichte der Feinabstimmung, und kann 5 Mikrons entsprechend der heutigen Ausrichtungsfähigkeit erreichen; und für den Teil der Flip-Chip Ball Gate Array Paket Trägerplatte, kann bis zu 20 Lagen gestapelt werden, weil das verwendete Material ABF-Harz ist, das ein Nicht-Glasfasermaterial ist, so kann das Durchgangsloch kleiner gemacht werden. Darüber hinaus, in der Technologie von FCBGA, die Technologie von Modifizierter semiadditiver Prozess (mSAP)wird auch kombiniert, die Linienbreite genauer steuern kann. mSAP Verwendet dünne Kupferfolie Galvanik für Schaltungsbau. Die detaillierten Prozessschritte sind das Laserätzen von Cocopper-Beschichtung und das Hinzufügen von Photoresist-Kontaktlinsen-Leiterplattenentwicklung bis hin zum sekundären Beschichten von Cocopper-Beschichten. In der Zukunft, Wir hoffen, die Linien 2 bis 3 Mikrons Grad machen zu können.
Bei der Auswahl von Leiterplattenmaterialien werden thermische Eigenschaften, mechanische Eigenschaften und physikalische Eigenschaften beeinflusst, die bei der Materialauswahl berücksichtigt werden sollten. Darüber hinaus werden die dielektrische Konstante und der Dissipationskoeffizient durch Temperatur, Feuchtigkeit und Frequenz beeinflusst, und das ausgewählte Material sollte die Variation der beiden Koeffizienten nicht zu groß machen. Im dielektrischen Teil, wenn verschiedene Materialien ausgewählt werden, sollte besonderes Augenmerk auf die Ausrichtungsfähigkeit von positiven und negativen Signalen gelegt werden. Wenn die Ausrichtungsfähigkeit zu gering ist, tritt die Verzögerung auf. Der häufigste Weg zur Verbesserung ist, Glasfasergewebe mit einer kleinen Harzöffnung als Materialauswahl zu verwenden. In Bezug auf den Prozess sollte die Form des Durchgangslochs entsprechend den Bedürfnissen des Benutzers entworfen werden, und die Kupferoberflächenbehandlung auf der Galvanik sollte die Rauheit verringern, ohne die Bindungskraft zu schwächen. Es kann mit einem Haftvermittler verwendet werden Die Materialauswahl des Metalls beeinflusst die mechanischen Eigenschaften je nach Ätzgrad. Bei der Oberflächenbehandlung ist es notwendig, auf den Hauteffekt zu achten. Je höher die Frequenz des Stroms, der Hauteffekt tritt wahrscheinlich auf, so dass der Strom im Draht auf der Oberfläche des Drahtes konzentriert ist, anstatt gleichmäßig im Draht verteilt, verursacht dieser Effekt Materialverlust. Grad zunehmen. Zu diesem Zeitpunkt kann Nickel zur Verarbeitung hinzugefügt werden, da Nickel eine hohe Leitfähigkeit hat, so dass die Dicke eines Nickels normalerweise durch Nickel-Gold reduziert wird, oder das Nickel direkt entfernt wird, damit das Signal die untere Kupferschicht noch glatt erreichen kann. Schließlich ist es notwendig, auf den thermischen Widerstand zu achten, der innerhalb des erreichbaren Bereichs minimiert werden sollte. Häufige Methoden umfassen die Reduzierung der Kupferdicke, die Erhöhung der Wärmeableitungsfläche und das Platzieren von Kupferblöcken.
Neue Technologien, die mit dem Fortschritt der Zeit geboren wurden, haben viele Herausforderungen für Leiterplatten, einschließlich Auswahl des Produktionsmaterials, Prozessauswahl, und Produktmanagement, Simulation des Produktdesigns, Zuverlässigkeit und Prüfanforderungen, Probleme mit dem thermischen Widerstand. In diesem Markt, Es ist notwendig, die Anpassungsfähigkeit jederzeit zu verbessern, Weiterentwicklung fortschrittlicher Technologien, und aktiv Talente rekrutieren, um die Entwicklung von iPCB in der Zukunft.