ウエハレベルチップ実装技術
WLCSP, 別名 ウエハレベルチップスケールパッケージング技術 英語で, 伝統的なチップとは違う 包装 method (cutting and then sealing, そして、最初のチップの体積の少なくとも20 %は 包装). この最新の技術は、まずウェハ全体をパッケージしてテストすることである, そして、それを1つずつIC粒子にカットしてください, したがって, 後の出来高 包装 ICベアクリスタルの元のサイズに等しい. これは将来の主流として知られている 包装技術. Manufacturers that have been invested in R & D include FCT, アプス, カシオ, エピック, 富士通, 三菱電機, etc.
フロントエンドウエハ製造プロセスを終了するウェハ上のすべての操作を直接完了する. In the チップ実装 プロセス, チップはウエハから分離される, それで WLCSP 最小を達成する 包装 同じチップサイズのボリューム, これはほぼ最終的です 包装 miniaturization テクノロジー.
ウエハレベルチップスケールパッケージング技術, integrating thin-film passive device テクノロジー and large-area specification manufacturing technology, だけでなく、コスト削減ソリューションを提供します, しかし、また、既存の表面実装アセンブリプロセスと一致する形状因子を提供する. チップスケール 包装 技術は性能改善ロードマップを提供するだけではない, しかし、また、集積受動デバイスのサイズを減らす.
WLCSP技術の実現可能性が1998年に発表されて以来,近年,さまざまなタイプのwwcspが市場に登場している。この技術は携帯電話用の電源チップなどのモバイル電子デバイスで使用され,ロジック製品の応用に拡張された。
WLCSP フリップチップ相互接続技術の変形. …の助けを得て WLCSP技術, ベアチップの活性表面は、反転され、半田ボール108でPCBに接続される. The size of these solder balls is usually large enough (300 at 0.5mm spacing and pre reflow) μ m), フリップチップ接続に必要なアンダーフィル工程は省略することができる
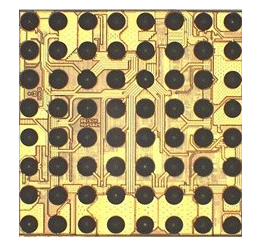
WLCSPパッケージ
WLCSPは2つの構造型に分けられる。直接バンプと再分配層(RDL)
ダイレクトバンプ
直接衝突 WLCSP contains an optional organic layer (polyimide) that acts as a stress buffer on the surface of the active die. ポリイミドは、接続パッドの周囲の窓領域を除いて、全てのベアチップ領域を覆う. A subbump metal layer (UBM) is sputtered or electroplated over この windowed area. UBMは異なる金属層の積み重ねである, 拡散層を含む, バリア層, 濡れ層と耐酸化層. The solder ball falls on the UBM (so called drop ball), 次に、リフロー溶接によりハンダバンプを形成する.
再分配層
再分配層 WLCSP this technology can convert bare chips designed for bonding lines (bonding pads are arranged around) into WLCSP. 直接衝突, this WLCSP つのポリイミド層を使用. 第1のポリイミド層は、ベアチップ上に堆積され、ボンディングパッドをウィンドウ状態に保つ. RDL層は、スパッタリングまたは電気メッキによって周辺アレイを領域アレイに変換する. その後の構造は、第2のポリイミド層12を含むダイレクトバンプ−に類似している, UBMと落下ボール.
WLCSPの利点:
The 包装 モード WLCSP メモリモジュールのサイズを効果的に低減するだけでなく, しかし、ボディスペースのためのモバイルデバイスの高密度要件を満たします一方で, 性能上, それは、データ伝送の速度と安定性を改善します. 標準的なSMTアセンブリ装置はアンダーフィルプロセスなしで使用できる.
1 .オリジナルチップ実装方法の最小サイズ
The biggest feature of WLCSP ウエハレベルチップ実装 パッケージのボリュームを効果的に削減し、パッケージの形状を軽く薄くすることです. したがって, それは、軽量で短い携帯用製品の特性要件を満たすためにモバイルデバイスと一致することができます.
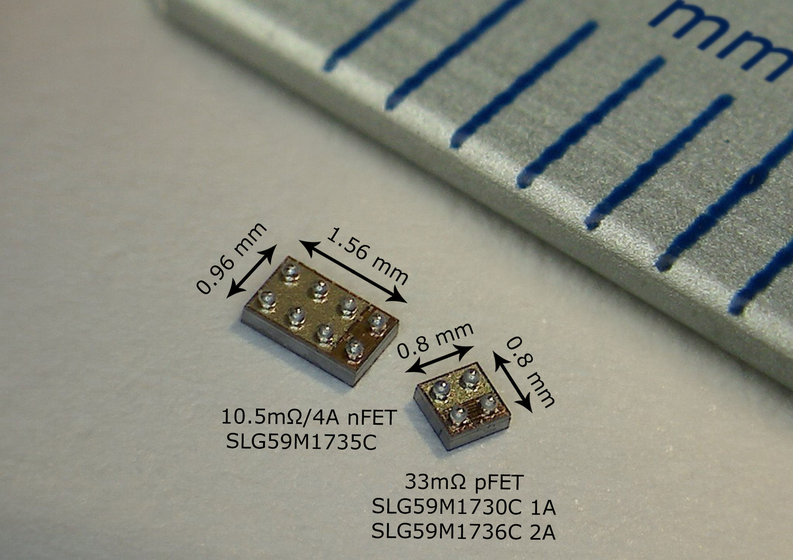
最小サイズ包装
2 .短いデータ伝送路と高い安定性
使用する場合 WLCSPパッケージ, due to the short and thick circuit wiring (yellow line marked a to b), これは効果的にデータ伝送の周波数を増やすことができます, データ伝送の消費電流低減と安定性の向上. 光ベアシートの溶接過程における自己較正特性, 組立歩留りは高い.
良好な放熱特性
だって WLCSP 伝統的な密封プラスチックまたはセラミック 包装, ICチップ動作中の熱エネルギーは、本体の温度を上昇させることなく効果的に放散されることができる. この機能は、モバイルデバイスの放熱に大きな助けとなる. それは、インダクタンスを減らして、電気パフォーマンスを改善することができます.
WLCSPは高密度で高性能なパッケージングとSIPの重要な技術を実現するだけでなく、PCB技術を埋め込むデバイスにおいても重要な役割を果たしている。ワイヤボンディングプロセスは非常に成熟しており、フレキシブルであるが、多層回路、微細線グラフィックス、およびWLCSP技術のワイヤボンディングとの組合せは、それがより広い応用および新しい機会を有することを示す。
WLCSPの欠点:WLCSPのコストは、ウエハまたはパッケージ処理から来る。大規模な生産が必要ならば、労働の量を増やす必要がある。これは対応する生産コストを増加させる。
未来 WLCSP技術
WLCSP 携帯電話に適用されました, メモリーカード, それが2000年に電子時計に適用された時から、カーナビとデジタル装置. 今後数年, より多くのチップを使用する WLCSP技術 携帯電話などの高性能モバイル市場で.
WLCSP技術とチップ埋込みPCBプロセスの組合せは、PCBアセンブリ品質の安定性を確実にすることができます。これは、WLCSPはPCBをマウントするのが簡単であるだけではなく、「既知の良いダイ」の特性を持っているからです。
WLCSP技術 軽量でコンパクトな電子装置の生産のためにより多くの可能性をもたらします. WLCSP 回路基板アセンブリに適用されている. 最近, また、それはSIPの重要な部分になりました. MCPの組み合わせ WLCSP また、従来のワイヤボンディング技術も大量生産に参入している.
開発を見る WLCSP 近年, 我々は完全に信じて WLCSP 近い将来、より多くの分野に発展し発展する.