sip系統內封裝是指通過不同的科技將不同種類的組件混合到同一個封裝體中,從而形成系統集成封裝形式。我們經常混淆系統級封裝sip和片上系統SoC這兩個概念。到目前為止,在IC晶片領域,SoC系統晶片是最高的晶片; 在IC封裝領域,SIP系統級封裝是最高級別的封裝。 SIP涵蓋SOC,SOC簡化了SIPSoC,這與SIP非常相似,因為兩者都尋求將包含邏輯組件、記憶體組件甚至無源組件的系統綜合為一個單元。 然而,就發展方向而言,兩者有很大不同:SoC是從設計的角度出發的,旨在將系統所需的組件集成到單個晶片中,而SIP是從封裝的角度出發,將具有不同功能的晶片集成到電子結構中。
SIP系統級不僅僅是一種封裝,它代表了一種先進的系統設計思想,它是研究人員的創新平臺,它涉及到晶片、系統、資料、封裝等諸多問題,涉及面非常廣泛,是一個比較寬泛的領域,所以從不同角度進行研究,瞭解SIP的內涵是非常必要的,
以下是SIP科技的一些當前概念:
1-SIP通過將每個功能晶片的裸核和分立組件集成在同一基板上,實現整個系統功能。 它是一種可以實現系統級晶片集成的電晶體科技。
2-SIP是指由多個晶片和無源組件(或無源集成組件)形成的系統功能集中在單個封裝體中,形成類似的系統設備。
3-隨著SOC的特徵尺寸變得更小,將類比、射頻和數位功能集成在一起變得更加困難。 另一種解決方案是將幾個不同的裸晶片封裝為一個,從而實現系統級封裝(SIP)。
4-SIP是一種集成了多種電路晶片來完成系統功能的封裝,是提高集成度的另一種管道,除了减少晶片的線寬外,與之相比可以大大降低成本和節省時間。
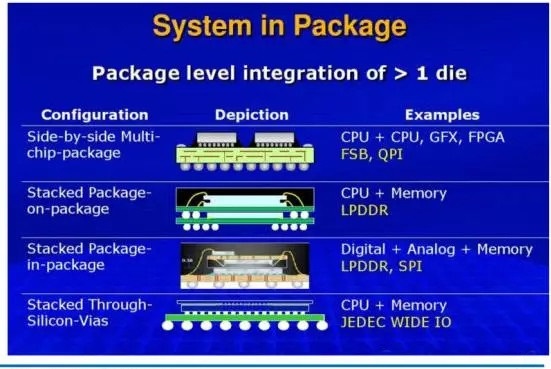
事實上,SIP是多晶片封裝(MCP)或晶片尺寸封裝(CSP)的演變,可以稱為級聯MCP和堆疊CSP。 特別是,CSP將是最佳的集成無源元件科技,因為它的生產成本較低,但SIP強調封裝應該包含一些系統功能。
SIP的科技要素是封裝載體和組裝過程。 SIP與傳統封裝結構的區別在於與系統集成相關的兩個步驟:系統模塊的劃分和設計,以及實現系統組合的載體。 傳統封裝中的載體(即襯底)只能起到互連的作用,而SIP的載體包括電路單元,電路單元屬於系統的組成部分。
模塊劃分是指將一個功能模組與電子設備分離,既有利於後續整機的集成,也便於SIP封裝。 以藍牙模組為例,其覈心是基帶處理器,一端與系統CPU介面,另一端與實體層硬體(調製解調、收發、天線等)介面。
組合載體包括高密度多層封裝基板和多層膜技術等先進科技。 在晶片組裝領域,板載晶片(COB)和片上晶片(COC)是主流科技。 COB是一種器件與有機或陶瓷襯底之間的互連科技。 現有科技包括引線鍵合和倒裝晶片。 CoC是一種單封裝中的多晶片堆疊結構,即疊層晶片封裝科技。
SIP科技現時廣泛應用於三個方面:一是在射頻/無線電方面。 例如,功能齊全的單晶片或多晶片SIP將RF基帶功能電路和閃存晶片封裝在模塊中。 第二個是感測器。 矽基感測器科技發展迅速,應用廣泛。 三是在網絡和電腦技術方面。
iPCB.com將大多數客戶對資訊成本的理解分享到一起進行討論。