Chipverpackungstechnologie auf Waferebene
WLCSP, auch bekannt als Chip-Waage-Verpackungstechnologie auf Waferebene auf Englisch, unterscheidet sich vom traditionellen Chip Verpackung method (cutting and then sealing, und mindestens 20% des Volumens des Originalchips wird nach Verpackung). Diese neueste Technologie soll zuerst den gesamten Wafer verpacken und testen, und dann in IC-Partikel eins nach dem anderen schneiden, Daher, die Lautstärke nach Verpackung ist gleich der ursprünglichen Größe des IC nackten Kristalls. Es ist bekannt als der zukünftige Mainstream der Verpackungstechnik. Manufacturers that have been invested in R & D include FCT, Aptos, Casio, episch, Fujitsu, Mitsubishi Elektronik, etc.
Es schließt direkt alle Vorgänge auf dem Wafer ab, der den Front-End-Wafer-Herstellungsprozess beendet. In the Chipverpackung Prozess, Der Chip wird vom Wafer getrennt, so dass WLCSP kann das Minimum erreichen Verpackung Volumen mit gleicher Chipgröße, das ist fast das Finale Verpackung miniaturization Technologie.
Chip-Waage-Verpackungstechnologie auf Waferebene, integrating thin-film passive device Technologie and large-area specification manufacturing technology, bietet nicht nur kostensparende Lösungen, aber auch Formfaktoren, die mit dem bestehenden Montageprozess für die Oberflächenmontage übereinstimmen. Späneskala Verpackung Technologie bietet nicht nur eine Roadmap zur Leistungsverbesserung, reduziert aber auch die Größe der integrierten passiven Geräte.
Seit die Machbarkeit der WLCSP-Technologie im 1998 angekündigt wurde, sind in den letzten Jahren verschiedene Arten von WLCSP auf dem Markt erschienen. Diese Technologie wurde in mobilen elektronischen Geräten wie Stromversorgungschips für Mobiltelefone verwendet und auf die Anwendung von Logikprodukten erweitert.
WLCSP ist eine Variante der Flip-Chip-Verbindungstechnik. Mit Hilfe von WLCSP-Technologie, Die aktive Oberfläche des blanken Chips wird invertiert und mit Lötkugeln mit der Leiterplatte verbunden. The size of these solder balls is usually large enough (300 at 0.5mm spacing and pre reflow) μ m), Der für die Flip-Chip-Verbindung erforderliche Unterfüllprozess kann entfallen
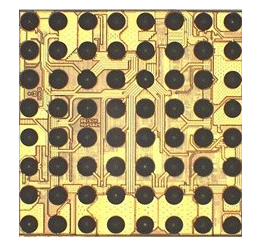
WLCSP-Verpackungen
WLCSP kann in zwei Strukturtypen unterteilt werden: Direct Bump und Redistribution Layer (RDL)
Direkter Stoß
Der direkte Stoß WLCSP contains an optional organic layer (polyimide) that acts as a stress buffer on the surface of the active die. Polyimid deckt den gesamten blanken Chipbereich mit Ausnahme des Fensterbereichs um das Verbindungspad ab. A subbump metal layer (UBM) is sputtered or electroplated over dies windowed area. UBM ist ein Stapel verschiedener Metallschichten, einschließlich Diffusionsschicht, Barriereschicht, Benetzungsschicht und Oxidationswiderstandsschicht. The solder ball falls on the UBM (so called drop ball), und dann wird die Lötbildung durch Reflow-Schweißen gebildet.
Umverteilungsebene (RDL)
Umverteilungsebene (RDL) WLCSP this technology can convert bare chips designed for bonding lines (bonding pads are arranged around) into WLCSP. Im Gegensatz zu direkten Stößen, this WLCSP verwendet zwei Polyimidschichten. Die erste Polyimidschicht wird auf dem blanken Chip abgelagert und hält das Klebepad im Fensterzustand. Die RDL-Schicht wandelt das periphere Array durch Sputtern oder Galvanisieren in ein Area Array um. Die nachfolgende Struktur ähnelt einem direkten Stoß, der eine zweite Polyimid-Schicht enthält, UBM und ein fallender Ball.
Vorteile von WLCSP:
The Verpackung Modus der WLCSP reduziert nicht nur effektiv die Größe des Speichermoduls, erfüllt aber auch die hohen Dichteanforderungen mobiler Geräte für Körperraum; Andererseits, in Bezug auf die Leistung, es verbessert die Geschwindigkeit und Stabilität der Datenübertragung. Standard SMT Montageausrüstung kann ohne Unterfüllprozess verwendet werden.
1. Mindestgröße der ursprünglichen Chipverpackungsmethode:
The biggest feature of WLCSP Chipverpackung auf Waferebene Es ist, das Paketvolumen effektiv zu reduzieren und die Paketform leichter und dünner zu machen. Daher, Es kann mit mobilen Geräten kombiniert werden, um die charakteristischen Anforderungen von leichten und kurzen tragbaren Produkten zu erfüllen.
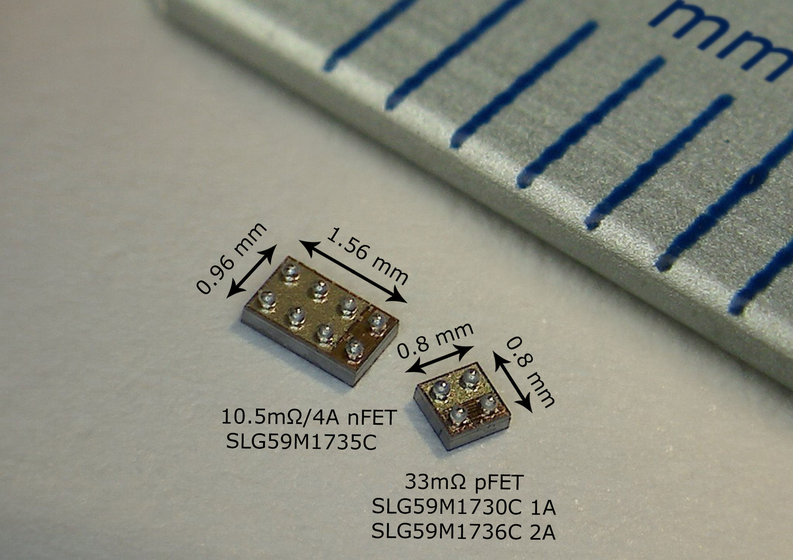
Mindestgröße Verpackung
2. Kurzer Datenübertragungsweg und hohe Stabilität:
Bei Verwendung WLCSP-Verpackung, due to the short and thick circuit wiring (yellow line marked a to b), Es kann die Frequenz der Datenübertragung effektiv erhöhen, Reduzierung des Stromverbrauchs und Verbesserung der Stabilität der Datenübertragung. Aufgrund der Selbstkalibrierungseigenschaften von hellem blankem Blech im Schweißprozess, die Montageausbeute ist hoch.
3. Gute Wärmeableitungseigenschaften
Weil WLCSP hat weniger traditionelle versiegelte Kunststoff oder Keramik Verpackung, Die Wärmeenergie während des IC-Chipbetriebs kann effektiv abgeführt werden, ohne die Temperatur des Hauptkörpers zu erhöhen. Diese Funktion ist eine große Hilfe für die Wärmeableitung von mobilen Geräten. Es kann Induktivität reduzieren und elektrische Leistung verbessern.
WLCSP kann nicht nur die wichtige Technologie der hochdichten und leistungsstarken Verpackung und des Schlucks realisieren, sondern auch eine Schlüsselrolle in der Geräteeinbettungstechnologie spielen. Obwohl der Drahtbondprozess sehr ausgereift und flexibel ist, zeigen die Mehrschichtschaltung, die Feinliniengrafik und die Kombination mit Drahtbonding der WLCSP-Technologie, dass es breitere Anwendungen und neue Möglichkeiten haben wird.
Nachteile von WLCSP: Die Kosten für WLCSP kommen aus der Wafer- oder Verpackungsverarbeitung. Wenn eine Großproduktion benötigt wird, muss die Menge an Arbeitskräften erhöht werden. Entsprechend steigen die Produktionskosten.
Die Zukunft der WLCSP-Technologie
WLCSP wurde in Mobiltelefonen angewendet, Speicherkarten, Autonavigatoren und digitale Geräte seit dem Einsatz in elektronischen Uhren in 2000. In den nächsten Jahren, es wird mehr Chips mit WLCSP-Technologie im Hochleistungsmobilmarkt wie Mobiltelefone.
Die Kombination aus WLCSP-Technologie und Chipeinbettungs-PCB-Prozess kann die Stabilität der PCB-Montagequalität gewährleisten. Dies liegt daran, dass WLCSP nicht nur einfach zu montierende Leiterplatte ist, sondern auch die Eigenschaften einer "bekannten guten Matrize" aufweist.
WLCSP-Technologie bringt mehr Möglichkeiten für die Herstellung von leichten und kompakten elektronischen Geräten. WLCSP wurde auf Leiterplattenmontage angewendet. Kürzlich, es ist auch ein wichtiger Bestandteil von SIP geworden. MCP-Kombination WLCSP Auch die konventionelle Drahtbondtechnik ist in die Serienfertigung eingetreten.
Die Entwicklung von WLCSP in den letzten Jahren, wir können voll und ganz glauben, dass WLCSP wird sich in naher Zukunft weiter entwickeln und auf weitere Bereiche ausweiten.