Explanation of IC packaging terms (1)
1. BGA (ball grid array)
A display of spherical contacts, eines der Aufputzpakete. Auf der Rückseite der gedruckten Leiterplatte, spherical bumps are made according to the display method for
Instead of pins, Ein LSI-Chip ist auf der Vorderseite des gedruckten Leiterplatte, und dann mit gegossenem Harz oder Verguss versiegelt. Also called convex
Point display carrier (PAC). Pins können 200 überschreiten, das ist ein Paket für Multi-Pin LSI.
Der Paketkörper kann auch kleiner als QFP ((Quad Flat Paket)). Zum Beispiel, 360-Stifte mit einem Stiftmittelabstand von 1.5mm
BGA is only 31mm square; while the 304-pin QFP mit einem Stiftmittelabstand von 0.5mm ist 40mm Quadrat. And BGA doesnât
Worry about pin deformation like QFP.
Dieses Paket wurde von Motorola Company of the United States entwickelt. Es wurde zuerst in tragbaren Telefonen und anderen Geräten angenommen, und wird in Zukunft in den Vereinigten Staaten verfügbar sein.
Kann in PCs populär gemacht werden. Anfangs, the BGA pin (bump) center distance was 1.5mm, und die Anzahl der Stifte war 225. Now also
Einige LSI manufacturers are developing 500-pin BGAs.
Das Problem mit BGA ist die visuelle Inspektion nach Reflow-Löten. Es ist noch nicht klar, ob eine effektive visuelle Inspektionsmethode verfügbar ist. Manche denken,
Durch den großen Mittelabstand des Schweißens, Die Verbindung kann als stabil angesehen werden und kann nur durch Funktionsprüfung verarbeitet werden.
Amerikanisch Motorola Company bezieht sich auf das mit gegossenem Harz versiegelte Paket als OMPAC, and the package sealed by potting method is called
GPAC (see OMPAC and GPAC).
2. BQFP (quad flat package with bumper)
Four-side pin flat package with cushion. Einer der QFP Pakete. Protrusions (buffer pads) are provided at the four corners of the package body to
Prevent bending and deformation of the pins during transportation. American Halbleiter manufacturers mainly use microprocessors and ASICs in circuits
This package. Der Stiftmittelabstand beträgt 0.635mm, and the pin number is about 84 to 196 (see QFP).
3. Butt welding PGA (butt joint pin grid array)
Ein anderer Name für surface mount PGA (see surface mount PGA).
4. C-(ceramic)
Indicates the mark of die Keramik package. Zum Beispiel, CDIP steht für Keramik DIP. Es ist eine Marke, die in der Praxis häufig verwendet wird.
5. Cerdip
Ceramic dual in-line package sealed with glass, für ECL RAM verwendet, DSP (digital signal processor) and other circuits. With
Cerdip of glass window is used for ultraviolet erasable EPROM and microcomputer circuit with EPROM inside. Pin Center
The distance is 2.54mm, und die Anzahl der Pins ist von 8 bis 42. In Japan, this package is expressed as DIP-G (G means glass seal).
6. Cerquad
Eines der Oberflächenmontagepakete, the ceramic QFP unter hermetischer Abdichtung, wird verwendet, um logische LSI-Schaltungen wie DSP zu verpacken. Mit Fenster
Cerquad Der Port wird zum Einkapseln von EPROM-Schaltungen verwendet. Die Wärmeableitung ist besser als Kunststoff QFP, und es verträgt 1.5ï½under natural air cooling conditions
2W power. Aber die Verpackungskosten sind 3- bis 5-mal höher als die von Kunststoff QFP. Der Stiftmittelabstand ist 1.27mm, 0.8mm, 0.65mm, 0.5mm,
Verschiedene Spezifikationen wie 0.4mm. Die Anzahl der Pins reicht von 32 bis 368.
7. CLCC (ceramic leaded chip carrier)
A ceramic chip carrier with pins, eines der Aufputzpakete. Die Stifte sind von den vier Seiten der Verpackung gezeichnet und haben eine T-Form.
Es wird verwendet, um das ultraviolette löschbare EPROM und die Mikrocomputerschaltung mit EPROM mit Fenstern einzukapseln. This package is also called
QFJ, QFJ-G (see QFJ).
8. COB (chip on board)
Chip-on-board packaging is one of the bare chip mounting technologies.
Die elektrische Verbindung der Platine wird durch das Drahtnähverfahren realisiert, und die elektrische Verbindung zwischen dem Chip und dem Substrat wird durch das Drahtnähverfahren realisiert, und es ist mit Harz bedeckt.
Schutz zur Gewährleistung der Sicherheit. Obwohl COB die einfachste Bare-Chip-Montagetechnologie ist, its packaging density is far inferior to TAB and rewind
Welding technology.
9. DFP (Doppelflachpaket)
Double-sided lead flat package. It is another name for SOP (see SOP). Früher gab es diesen Begriff, aber es wird im Grunde jetzt nicht verwendet.
10. DIC (dual in-line ceramic package)
Another name for ceramic DIP (including glass seal) (see DIP).
11. DIL (dual in-line)
Another name for DIP (see DIP). Europäisch Halbleiter Hersteller verwenden oft diesen Namen.
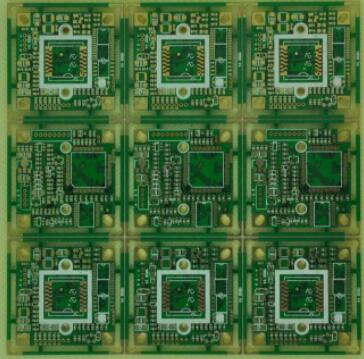
12. DIP (dual in-line package)
Dual in-line package. Eines der Plug-in-Pakete, Die Stifte sind von beiden Seiten der Verpackung gezeichnet, und die Verpackungsmaterialien sind Kunststoff und Keramik.
DIP ist das beliebteste Plug-in-Paket, Das Anwendungsspektrum umfasst Standard-Logik-ICs, Speicher-LSIs, und Mikrocomputerschaltungen.
Der Stiftmittelabstand beträgt 2.54mm, und die Anzahl der Pins ist von 6 bis 64. Die Packungsbreite beträgt in der Regel 15.2mm. Einige haben eine Breite von 7.52mm
And the 10.16mm packages are called skinny DIP and slim DIP (narrow DIP) respectively. Aber in den meisten Fällen, kein Unterschied gemacht wird.
Einfach zusammen als DIP bezeichnet. Darüber hinaus, ceramic DIP sealed with low-melting glass is also called cerdip (see cerdip).
13. DSO (dual small out-lint)
Two-sided lead small outline package. Another name for SOP (see SOP). Einige Halbleiter Hersteller verwenden diesen Namen.
14. DICP (dual tape carrier package)
Two-sided lead-carrying package. One of TCP (Tape Carrier Package). Die Stifte werden auf dem Isolierband hergestellt und führen von beiden Seiten der Verpackung heraus. Due to benefit
It uses TAB (automatic tape load welding) technology, und die Verpackung Umriss ist sehr dünn. Es wird oft im Flüssigkristallanzeigetreiber LSI verwendet, aber die meisten von ihnen sind kundenspezifische Produkte.
Darüber hinaus, die 0.5mm dickes Speicher LSI Buch Paket ist in der Entwicklungsphase. In Japan, according to EIAJ (Electronic Mechanics of Japan)
The industry association standard stipulates that DICP is named DTP.
15. DIP (dual tape carrier package)
Same as above. The Japanese Electronic Machinery Industry Association standard names DTCP (see DTCP).
16, FP (flat package)
Flat package. Eines der Aufputzpakete. Another name for QFP or SOP (see QFP and SOP). Some Halbleiter manufacturers adopt
Use this name.
17, flip-chip
Flip-soldering the chip. Eine der Bare-Chip-Verpackungstechnologien, Metallstöße werden im Elektrodenbereich des LSI-Chips erzeugt, and then the metal bumps
It is connected to the electrode area on the printed Leiterplatte durch Druckschweißen. Der Footprint des Pakets ist im Grunde der gleiche wie die Chipgröße. Is all packaging technology
The smallest and thinnest type in surgery.
Allerdings, wenn der Wärmeausdehnungskoeffizient des Substrats von dem des LSI-Chips abweicht, Es wird eine Reaktion an der Kreuzung geben, was die Zuverlässigkeit der Verbindung beeinträchtigt.
Geschlecht. Daher, Es ist notwendig, Harz zu verwenden, um den LSI-Chip zu verstärken, und ein Substratmaterial mit im Wesentlichen dem gleichen Wärmeausdehnungskoeffizienten verwenden.
18. FQFP (fine pitch quad flat package)
Small pin center distance QFP. Bezieht sich in der Regel auf eine QFP mit einem Bleimittelabstand kleiner als 0.65mm (see QFP). Part of the conductor manufacturer adopts
Use this name.
19. CPAC (globe top pad array carrier)
American Motorola Company's nickname for BGA (see BGA).
20, CQFP (quad fiat package with guard ring)
Four-side lead flat package with guard ring. Einer der Plastik QFPs, Die Stifte sind mit einem Harzschutzring maskiert, um Biegen und Verformungen zu verhindern.
Before assembling the LSI on the Leiterplatte, cut the lead from the guard ring and make it into a seagull wing shape (L shape). This package
It has been mass-produced by Motorola in the United States. Der Stiftmittelabstand beträgt 0.5mm, und die Anzahl der Stifte ist etwa 208 höchstens.
21, H-(with heat sink)
Indicates a mark with a radiator. Zum Beispiel, HSOP bedeutet SOP mit Kühlkörper.
22, pin grid array (surface mount type)
Surface mount PGA. Normalerweise ist PGA ein Steckerpaket mit einer Stiftlänge von ca. 3.4mm. Surface mount PGA in the package
There are display-like pins on the bottom, deren Länge von 1 ist.5mm bis 2.0mm. Mounting uses the method of touch-welding with the Leiterplatte, so it is also called
For butt welding PGA. Weil der Stiftmittelabstand nur 1 beträgt.27mm, die halb kleiner ist als die des Plug-in-Typs PGA, die Packung kann anders hergestellt werden.
Wie groß, and the number of pins is more than that of the plug-in type (250ï½528), Es ist ein Paket für große Logik LSI. The encapsulated substrate has multilayer ceramics
Porcelain substrate and glass epoxy resin printing base. Die Verpackung von mehrschichtigen Keramiksubstraten wurde in die Praxis umgesetzt.
23, JLCC (J-leaded chip carrier)
J-förmiger Stiftchipträger. Another name for CLCC with window and ceramic QFJ with window (see CLCC and QFJ). Part and half
The name adopted by the conductor manufacturer.
24, LCC (Leadless chip carrier)
Leadless chip carrier. Bezieht sich auf ein Oberflächengehäuse, bei dem die vier Seiten des Keramiksubstrats nur mit Elektroden ohne Leitungen in Berührung kommen. Ist hoch
Hochgeschwindigkeits- und Hochfrequenz-IC-Gehäuse, also known as ceramic QFN or QFN-C (see QFN).
25, LGA (land grid array)
Contact display package. Das ist, Ein Paket mit Array-State-Elektrodenkontakten ist auf der Unterseite hergestellt. Stecken Sie einfach die Buchse bei der Montage ein. Now
Practical ceramic LGA with 227 contacts (1.27mm center distance) and 447 contacts (2.54mm center distance) for high-speed logic
LSI circuit.
Verglichen mit QFP, LGA kann mehr Ein- und Ausgangspins in einem kleineren Gehäuse aufnehmen. Darüber hinaus, due to the impedance of the lead
Small, sehr geeignet für High-Speed LSI. Allerdings, aufgrund der komplizierten Produktion und hohen Kosten der Steckdosen, sie werden im Grunde jetzt nicht viel benutzt. Expected
Its demand will increase in the future.
Erläuterung der Begriffe der IC-Verpackung (2)
26, LOC (lead on chip)
Lead-on-chip packaging. Eine der Verpackungstechnologien von LSI, eine Struktur, bei der das vordere Ende des Führungsrahmens über dem Chip liegt, and the chipâs
Protruding solder joints are made near the center, und Drahtnähte wird für elektrische Verbindung verwendet. Compared with the original lead frame placed near the side of the chip
Compared with the structure, Der Chip im gleichen Größenpaket ist ca. 1mm breit.
27, LQFP (low profile quad flat package)
Thin QFP. Bezieht sich auf die QFP mit einer Packungskörperdicke von 1.4mm, das ist eine neue QFP formulated by the Japanese Electronic Machinery Industry Association
The name used for the form factor.
28, L-QUAD
One of ceramic QFP. Aluminiumnitrid, das für die Verpackung von Substraten verwendet wird, hat eine 7-8-fache Wärmeleitfähigkeit als Aluminiumoxid, und hat eine bessere Wärmeableitung.
Der Rahmen des Pakets ist Aluminiumoxid, und der Chip wird durch Vergießen versiegelt, dadurch die Kosten. Ist ein Paket entwickelt für Logik LSI,
Zulässige W3-Leistung unter natürlichen Luftkühlbedingungen. 208-pin (0.5mm center distance) and 160-pin (0.65mm
Center distance) LSI logic package, und begann die Massenproduktion im Oktober 1993.