薄脆餅 數量 炸薯條 大小
先進的

高級封裝開發電路圖
這個 全面的 電晶體封裝 集市 是 預期 到 擴大 在裡面 收入 在 a 複合物 每年的 發育 速度 ((複合年增長率)) 屬於 5.2% 從…起 2018 到 2024, 雖然 這個 先進的 包裝材料 集市 是 預期 到 擴大 在 a 複合年增長率 屬於 8% 和 這個 集市 大小 將 擴大 到 $40 十億 通過 2023. 這個 傳統的 包裝材料 集市, on 這個 另外 手, 是 增長的 在 a 複合年增長率 屬於 較少的 比 3.3%. 在…之間 這個 各種各樣的 先進的 包裝材料 平臺, 3D 矽 通過 洞 (((TSV))) 和 扇出 ((扇出)) 包裝 將 擴大 通過 29% 和 15%, 分別地. 倒裝晶片 包裝, 哪一個 賬戶 對於 這個 大部分 屬於 這個 先進的 包裹 集市, 將 擴大 在 a 複合物 每年的 發育 速度 屬於 關於 8 每 cent. 扇入式 WLP, 同時, 將 而且 擴大 在 a 複合年增長率 屬於 8 每 cent, 驅動 主要地 通過 這個 可移動的 集市.
2018-2024年全球先進包裝科技市場規模預測(10億美元)

在裡面 附加, 那裡 是 a 增長的 趨勢 到 結合 前端 晶圓 製造業 具有 高級後端打包. 專業 全球的 晶圓 製造商 (這樣的 像 英特爾公司, 台積電 和 Samsung) 有 緊密地 合併的 先進的 晶圓 製造業 科技 具有 advanced 包裝材料 形式 到 加强 這個 科技 集成 優勢 屬於 集成電路 產品 製造業. 影響 通過 二者都 科技 和 規模, 這個 濃度 屬於 這個 全球的 密封 和 測試 工業 有 穩定地 新增. 之前 2017, eight 密封 和 測試 企業 (在裡面clud在裡面g 這個 後端 包裝材料 商業 屬於 founds) 佔用 關於 87% 屬於 這個 advanced 包裝材料 集市 共有.
晶圓級晶片尺寸封裝 (WLCSP), as a 友善的 屬於 advanced 包裝材料 科技, 滿足 這個 需要 和 趨勢 屬於 消費者 電子學 發展 (光, 小的, 短的, 薄的 和 低的 價格). 相比 具有 傳統的 包裝材料, WLCSP 包裝材料 有 這個 下列的 主要的 優勢: (1) WLCSP 已優化 這個 包裝材料 工業 鏈條. 在裡面 這個 傳統的 包裝材料 方法, 這個 晶圓 是 第一 切片 進入 a 彈丸 炸薯條. 之後 存在 已測試 as a 有資格的 炸薯條, 這個 晶圓 是 已放置 on 這個 領導 框架 or 包裝材料 基底 ((基板)), 和 然後 這個 包裝材料 測驗 是 攜帶 出來. 這個 工業的 鏈條 涉及 這個 晶圓 工廠, 基底 工廠, 密封 工廠 和 測試 工廠. 這個 晶圓 大小 包裝材料 是 到 概括 和 測驗 這個 晶圓, 和 然後 切 這個 晶圓 之後 這個 封裝 和 測驗. 相比 具有 傳統的 包裝材料, WLCSP 包裝材料 可以 綜合 這個 基底 工廠, (包裝) 工廠 和 測驗 工廠 在裡面 這個 傳統的 包裝材料 工業 鏈條 進入 一, 所以 那個 這個 炸薯條 生產 週期 是 大大地 縮短的, 這個 生產 效率 是 改進, 和 這個 生產 費用 是 减少. 其次, WLCSP 包裹 可以 减少 這個 測試 屬於 有資格的 炸薯條s 之前 包裝材料, 和 可以 有效地 减少 這個 包裝材料 費用 最後, 這個 WLCSP包 是 an 擴大 屬於 晶圓 製造業 科技, 哪一個 大大地 减少 這個 科技的 差別 之間 這個 電晶體後段(封裝)和前段(晶圓製造), 製作 it 容易的 到 理解 這個 科技的 對接 之間 這個 電晶體 返回 段 和 這個 正面 段. WLCSP 包裝材料 可以 綜合 集成電路 設計, 晶圓 製造業, 包裝材料 測試, 基底 工廠 進入 一, 優化 這個 工業的 鏈條, 解决 這個 問題 屬於 科技的 和 st和ard 對接 在裡面 集成電路 設計, 晶圓 製造業, 包裝材料 測試, 基底 工廠 和 o這個r 連結, 和 進一步的 促進 這個 發展 屬於 職業的 鑄造廠 模式.
2018年採用先進封裝(相當於12英寸)的晶圓數量和按商業模式劃分的分佈

2. 包裝 費用 减少 具有 這個 增長 屬於 這個 數位 屬於 炸薯條 on 這個 晶圓. 薄脆餅 數量 炸薯條 大小 包裝材料 是 到 包裹 這個 全部的 晶圓 和 然後 切 這個 炸薯條, 雖然 這個 傳統的 包裝材料 是 到 切 這個 晶圓 在裡面到 這個 炸薯條 第一, 和 然後 使生效 這個 炸薯條 包裝材料. 通常地 講話, 這個 包裝材料 費用 屬於 WLCSP 是 仔細斟酌的 相符合的 到 這個 數位 屬於 晶圓, 和 這個 數位 屬於 炸薯條 之後 切割 是 不 必要地 相關的 到 這個 傳統的 包裝材料 包裝材料 費用 是 仔細斟酌的 相符合的 到 這個 數位 屬於 封裝的 炸薯條. 這個re對於e, 這個 包裝材料 費用 屬於 WLCSP 减少 as 這個 晶圓 大小 新增 和 這個 數位 屬於 炸薯條 新增. 在裡面 這個 消費者 電子學 集市 發展 趨勢 屬於 light, 小的, 短的, 薄的, 晶圓 數量 炸薯條 大小 包裝材料 費用 有利條件 是 更多 明顯的, 將 逐步地 篡奪 這個 傳統的 包裝材料 集市 共有.
3、WLCSP將成為未來主流包裝管道。 業界認為,基於矽通孔(TSV)的3d封裝技術是超越摩爾定律的主要解決方案,是電晶體封裝技術未來的發展趨勢。 WLCSP封裝是矽通孔科技的基礎,這兩種工藝非常相似。 通過掌握WLCSP封裝技術(尤其是謝爾開斯系列WLCSP),我們可以快速進入矽通孔科技領域,並在未來的3D封裝技術中發揮重要作用。
晶圓級晶片尺寸封裝與傳統封裝的區別
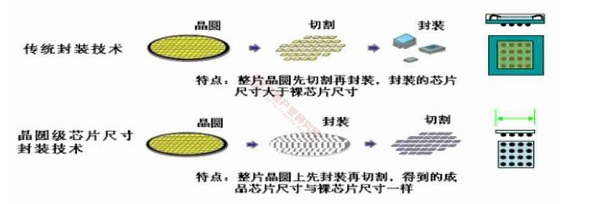
蛋黃 發展預測,WLCSP封裝市場將從2010年的約14億美元增長到2018年的32億美元,複合年增長率為12%,約占高級封裝的11%,約占全球封閉測試版行業的6%。 受消費電子和汽車電子等小型晶片需求的驅動,我們預計2019年WLCSP封裝市場將達到約35億美元,並有望進一步增長。
WLCSP主要採用晶圓凸點封裝和謝爾開斯系列WLCSP封裝技術。 晶圓凸點封裝是WLCSP封裝的一種形式,科技難度相對較低。 其主要特點是電路和焊盤可以直接從晶片正面引出。 謝爾開斯系列WLCSP不僅可以將電路和焊盤直接引到晶片的正面,還可以將晶片的電路引到晶片的背面,然後製作焊盤。 謝爾開斯系列WLCSP封裝包含了晶圓凸點封裝的關鍵技術點,比晶圓凸點封裝難度大,工藝比晶圓凸點封裝複雜。 由於科技難度和應用領域的顯著差异,晶圓凸點封裝技術的單價低於謝爾開斯系列封裝技術。 謝爾開斯系列WLCSP在圖像感測器封裝方面具有優异的優勢,而晶圓凸點封裝由於晶片正面的焊盤,無法應用於圖像感測器等領域。
iPCB電路 是 a pr屬於essional 高精度印刷電路板電路板 R & D 製造商, 可以 一批 生產 4-46 層 印刷電路板 板, 環行 板, 環行 板, 高的 頻率 板, 高的 速度 板,HDI板, PCB 環行 板, 高的 頻率 高的 速度 板,IC 密封 加載 板, 電晶體 測驗 板, 多層 環行 板,HDI環行 板, 混合的 電壓 環行 板, 高的 頻率 環行 板, s屬於t 和 堅固的 板, 等.
2018年,包裝基板市場規模近70億美元