2021年ウェハ級チップサイズパッケージ(WLCSP)技術の応用現状と市場の将来性分析。
先進的なICパッケージとは、当時の最先端のパッケージ形式と技術を指す。現在、フリップチップ(FC)構造パッケージ、ウェハレベルパッケージ(WLP)、2.5 Dパッケージ、3 Dパッケージは高級パッケージのカテゴリとされている。
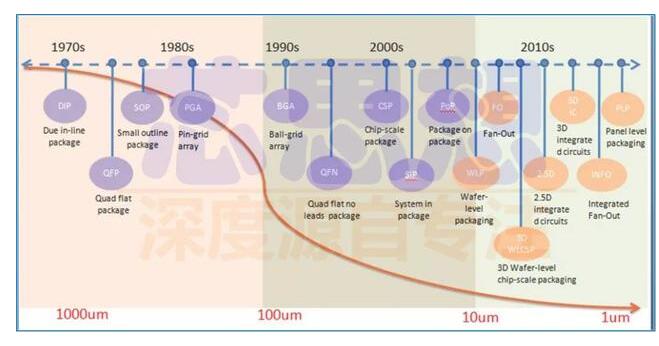
ハイレベルパッケージ開発回路図
2018年から2024年にかけて、半導体パッケージ市場全体の収入は5.2%の複合年成長率(CAGR)で成長すると予想されているが、先進パッケージ市場は8%の複合年成長率で成長し、2023年には市場規模は400億ドルに成長すると予想されている。一方、従来の包装市場の成長率は3.3%未満だった。様々な先進的なパッケージプラットフォームでは、3 Dシリコン貫通孔(TSV)とファンアウト(fan-out)パッケージがそれぞれ29%と15%増加する。先進パッケージ市場の大部分を占めるフリップチップパッケージは、約8%の複合年成長率で成長する。同時に、主にモバイル市場に後押しされ、WLPにおけるファンの複合年成長率も8%に達する。
2018-2024年の世界先進包装技術市場規模予測(10億ドル)

ウェハレベルのチップサイズパッケージ(WLCSP)は先進的なパッケージ技術として、消費電子の発展の需要と傾向(軽、小、短、薄、低価格)を満たしている。従来のパッケージと比較して、WLCSPパッケージは以下の主要な優位性を持っている:(1)パッケージ産業チェーンを最適化した。従来のパッケージ方法では、ウェハは最初にチップ状に切断される。合格チップとしてテストした後、ウェハをリードフレームまたはパッケージ基板(基板)上に置き、パッケージテストを行う。産業チェーンはウエハ工場、基板工場、密封工場、試験工場に関連している。ウェハサイズパッケージは、ウェハをカプセル化してテストし、カプセル化してテストした後にウェハを切断します。従来のパッケージと比べて、WLCSPパッケージは従来のパッケージ産業チェーンにおける基板工場、パッケージ工場、テスト工場を一体化することができ、それによってチップの生産周期を大幅に短縮し、生産効率を高め、生産コストを削減することができる。第二に、WLCSPパッケージはパッケージ前の合格チップのテストを減らすことができ、パッケージコストを効果的に下げることができる、最後に、WLCSPパッケージはウェハ製造技術の延長であり、半導体後段(パッケージ)と前段(ウェハ製造)間の技術差を大幅に減少させ、半導体後段と前段間の技術接合を容易にする。WLCSPパッケージは集積回路設計、ウエハ製造、パッケージテスト、基板工場を一体化し、産業チェーンを最適化し、集積回路設計、ウエハ製造、パッケージテスト、基板工場などの一環の技術と標準ドッキング問題を解決し、専門的なエージェントモデルの発展をさらに推進することができる。
2018年に先進的なパッケージ(12インチ相当)を採用し、ビジネスモデル別に販売されたウェハ数

2.ウェハ上のチップ数が増加するにつれてパッケージコストが減少する。ウェハレベルのチップサイズパッケージは、ウェハ全体をパッケージ化してからチップを切断するものであり、従来のパッケージは、まずウェハをチップに切断してからチップパッケージを実施するものである。一般的に、WLCSPのパッケージコストはウェハの数に基づいて測定され、切断後のチップの数は従来のパッケージコストと必ずしも関連しておらず、パッケージのチップの数に基づいてパッケージコストを測定している。そのため、WLCSPのパッケージコストは、ウェハサイズの増加とチップ数の増加に伴って減少する。消費電子市場の発展傾向の中で、軽、小、短、薄、ウエハ級チップサイズパッケージのコスト優位性はさらに明らかになり、伝統的なパッケージの市場シェアを徐々に奪い取ることになる。
3.WLCSPは将来主流のパッケージ方式になるだろう。業界では、シリコンスルーホール(TSV)に基づく3 dパッケージ技術はムーアの法則を超えた主要なソリューションであり、半導体パッケージ技術の将来の発展傾向であると考えられている。WLCSPパッケージはシリコンスルーホール技術の基礎であり、この2つのプロセスは非常に似ている。WLCSPパッケージ技術(特にShellcaseシリーズWLCSP)を習得することで、シリコンスルーホール技術の分野に急速に進出し、将来の3 Dパッケージ技術に重要な役割を果たすことができます。
ウェハレベルのチップサイズパッケージと従来のパッケージの違い
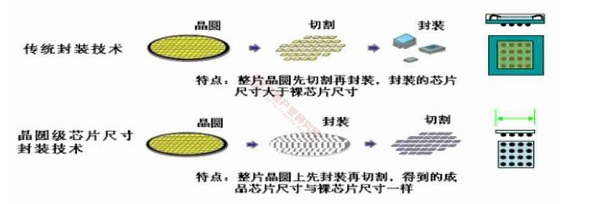
Yole Developmentは、WLCSPパッケージ市場は2010年の約14億ドルから2018年の32億ドルに成長し、複合年間成長率は12%で、先進パッケージの約11%を占め、世界のパッケージ業界の約6%を占めると予測している。消費電子やカーエレクトロニクスなどの小型チップ需要の後押しを受けて、2019年のWLCSPパッケージ市場は約35億ドルに達し、さらなる成長が期待されている。
WLCSPは主にウェハバンプパッケージとShellcaseシリーズWLCSPパッケージ技術を採用している。ウェハバンプパッケージは、技術的難易度が比較的低いWLCSPパッケージ形式である。主な特徴は、回路とパッドがチップの正面に直接引き出すことができることです。ShellcaseシリーズWLCSPは、回路とパッドを直接チップの表面に誘導するだけでなく、チップの回路をチップの裏面に誘導し、パッドを作成することもできます。ShellcaseシリーズWLCSPパッケージには、ウェハバンプパッケージよりも難しく、プロセスもウェハバンプパッケージよりも複雑であるウェハバンプパッケージの重要な技術点が含まれています。技術的難易度と応用分野の顕著な違いにより、ウェハバンプパッケージ技術の単価はShellcaseシリーズパッケージ技術よりも低い。ShellcaseシリーズWLCSPはイメージセンサパッケージに優れているが、ウェハバンプパッケージはチップ表面にパッドがあるため、イメージセンサなどの分野には適用できない。
IPCB Circuitは専門的な高精度PCB基板の研究開発メーカーであり、4-46層PCB基板、回路基板、回路基板、高周波基板、高速基板、HDI基板、PCB基板、高周波高速基板、IC封止ローディング基板、半導体テスト基板、多層回路基板、HDI回路基板、ハイブリッド電圧回路基板、高周波回路基板、ハードディスクなどを量産することができる。
2018年、包装基板市場規模は70億ドル近く