Définition et fonctions du substrat IC
Définition de substrat IC: substrat utilisé pour encapsuler une puce IC nue.
Fonction substrat IC
(1) transporter une puce semi - conductrice IC.
(2) le circuit interne est utilisé pour la connexion entre la puce et la carte.
(3) protéger, fixer, soutenir la puce IC, fournir un canal de dissipation de chaleur, est un produit intermédiaire pour la puce de communication et PCB.
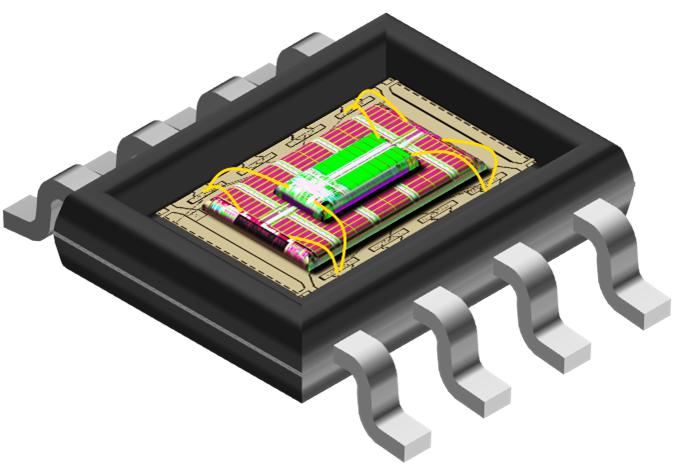
Encapsulation IC
IC Substrates est né: au milieu des années 1990, à moins de 20 ans. L'apparition de nouvelles formes d'encapsulation haute densité de circuits intégrés (ci), telles que BGA (Ball Grid Array Encapsulation) et CSP (Chip Size Encapsulation), a donné naissance à un nouveau type de support d'encapsulation nécessaire, le substrat d'encapsulation IC.
* développement de semi - conducteurs: valve - Transistor - assemblage via - package de surface (SMT) - package au niveau de la puce (CSP, BGA) - package système (SIP)
* La technologie des circuits imprimés et des semi - conducteurs est interdépendante, intime, perméable et étroitement alignée, les circuits imprimés peuvent réaliser l'isolation électrique et la connexion électrique entre diverses puces, composants, fournissant les caractéristiques électriques requises.
Paramètres techniques nombre de couches, 2 ~ 10 couches;
Épaisseur de la carte PCB, généralement 0,1 ~ 1,5 mm;
Tolérance d'épaisseur minimale de la carte PCB * 0 micron;
Ouverture minimale, via 0,1 mm, microporosité 0,03 mm;
* largeur / Espacement minimum de motif, 10 ~ 80 microns;
Largeur minimale de l'anneau, 50 microns;
* tolérance de profil, 0 ~ 50 microns;
* trou borgne enterré, impédance, capacité de résistance enterrée;
* revêtement de surface, nickel / or, or doux, or dur, nickel / palladium / or, etc.
* Taille de la plaque, 150 × 50 mm (un seul support IC);
C'est - à - dire que le substrat IC nécessite une couche de noyau plus fine, haute densité, nombre de pieds élevé, petit volume, trous, disques, fils plus petits et ultra - mince. Par conséquent, il est nécessaire d'avoir des techniques d'alignement inter - couches précises, des techniques d'imagerie de motifs, des techniques de placage, des techniques de perçage et des techniques de traitement de surface. Des exigences plus élevées sont imposées pour la fiabilité des produits, l'instrumentation des équipements, la gestion des matériaux et de la production. Le seuil technologique des substrats de circuits intégrés est donc élevé et la recherche et le développement sont difficiles.
Les difficultés techniques que le substrat IC doit surmonter par rapport à la fabrication traditionnelle de PCB sont les suivantes:
(1) Technologie de production de panneau de noyau le panneau de noyau est mince et facilement déformable, en particulier lorsque l'épaisseur de la plaque est de 0,2 mm, il est nécessaire d'utiliser la structure de la plaque, le gonflement et le rétrécissement de la plaque, le paramètre laminaire, le système de positionnement sandwich et d'autres technologies pour réaliser un contrôle efficace de l'épaisseur de gauchissement et de pressage du panneau de noyau ultramince.
(2) Technologie microporeuse
* inclus: processus d'ouverture de masque d'étain soudé, processus de micro - trou borgne perforé au laser, processus de remplissage de cuivre de trou borgne.
* Le procédé conformalssk (conformalsk) est utilisé pour effectuer une compensation raisonnable des ouvertures de trous borgnes laser et pour déterminer directement l'ouverture et la position des trous borgnes à l'aide d'un anneau de cuivre ouvert.
* indicateurs impliqués dans le forage au laser des micropores: forme du trou, rapport de taille de pores supérieur et inférieur, érosion latérale, projection de fibre de verre, colle résiduelle au fond du trou, etc.
* Les indicateurs impliqués dans le placage de cuivre de trou borgne comprennent: capacité de remplissage, cavité de trou borgne, Arc tombant, fiabilité du placage de cuivre, etc.
* Actuellement, la taille des micropores est de 50 à 100 microns, le nombre de trous stratifiés atteint 3, 4 et 5 ordres de grandeur.
(3) Formation graphique et technologie de placage de cuivre
Technologie et contrôle de compensation de mode; Technologie de production de fines fleurs; Technologie de contrôle de l'uniformité de l'épaisseur de cuivre plaqué; Technologie de contrôle de micro - érosion de fines fleurs.
* L'exigence actuelle d'espacement de largeur de motif est de 20 ~ 50 microns. L'exigence d'uniformité de l'épaisseur du revêtement de cuivre est de 18 * microns et l'uniformité de la gravure est de 90%.
(4) Processus de résistance de soudage * Comprend le processus de trou de bouchon, la technologie d'impression de résistance de soudage, etc.
* La différence de hauteur entre les surfaces de soudure des substrats IC est inférieure à 10 microns et la différence de distance entre les surfaces de soudure et les surfaces des plots est inférieure à 15 microns.
(5) Technologie de traitement de surface
* uniformité de l'épaisseur nickelée / dorée; Deux processus de dorure doux et dur sur la même plaque; Processus de nickelage / palladium / dorure.
* revêtement de surface de revêtement intérieur, technologie de traitement de surface sélectif.
(6) capacité d'essai et technique d'essai de fiabilité de produit
* Equipé de nombreux équipements / instruments de test différents de l'usine de PCB traditionnelle.
* maîtriser des techniques de test de fiabilité différentes de celles habituelles.
(7) en général, la production de substrats IC implique plus de dix aspects de la technologie:
Compensation dynamique graphique; Le processus de placage graphique réalise l'uniformité de l'épaisseur du placage de cuivre; Contrôle de l'expansion et de la contraction du matériau tout au long du processus; Processus de traitement de surface, placage sélectif d'or doux et dur, processus de placage nickel / palladium / or;
* production de plaquettes de plaque de noyau;
* Technologie de détection de haute fiabilité; Traitement microporeux;
* Si empiler micro 3, 4, 5, processus de production;
* pression de stratification multiple; Laminé 4 fois; Forage 5 fois; Plaqué 5 fois.
* Formation de motif de câblage et gravure;
* Système d'alignement de haute précision;
* processus de trou de bouchon de soudure, processus de micropores remplis de placage;
Classification des substrats IC
Par la forme de l'encapsulation
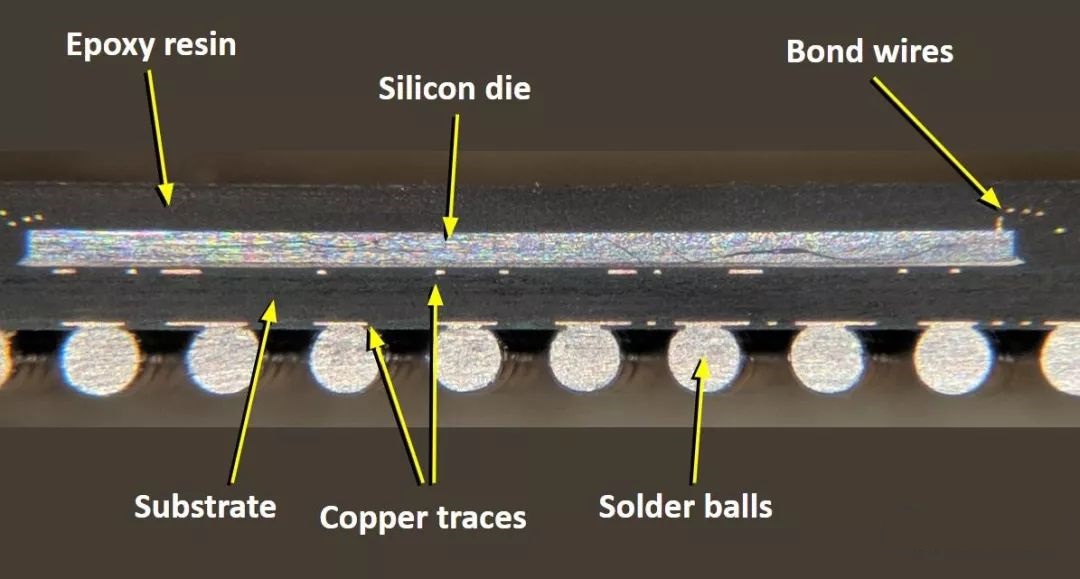
Les tendances Packaging
(1) Société BGA
* ballgridairy, BGA, boîtier à matrice sphérique.
* La carte de ce paquet dissipe la chaleur, la performance électrique est bonne, la broche de puce peut être augmentée de manière significative, applicable au paquet d'IC au - dessus du nombre de broches 300 (pincount).
(2) Société CSP
* CSP, Chip level Packaging, Chip level Size packaging.
* est un boîtier à puce unique, léger et de petite taille, dont la taille de boîtier est presque identique ou légèrement supérieure à la taille de l'IC lui - même, utilisé pour stocker des produits, des produits de communication, des produits électroniques avec un nombre de broches pas élevé.
(3) plaqué cristal carte PCB
* flipchip (FC) est un type de boîtier dans lequel la face avant de la puce est retournée (FLIP) et les bosses sont directement connectées au PCB.
Un tel substrat présente les avantages d'une faible perturbation du signal, d'une faible perte du circuit de connexion, d'une bonne performance électrique et d'une efficacité de dissipation thermique élevée.
(4) module multi - puce
* module multi - puces (MCM) Plusieurs puces avec des fonctions différentes dans le même boîtier.
* C'est la meilleure solution pour l'électronique vers la lumière, mince, courte et sans fil sous haute vitesse. Pour les ordinateurs centraux d'ordre supérieur ou l'électronique de performance spéciale.
* parce qu'il y a plusieurs puces dans le même paquet, interférence de signal, dissipation de chaleur, conception de fil mince, etc., il n'y a pas de solution plus complète, appartient au développement actif du produit.
Par caractéristiques des matériaux
(1) Carte PCB rigide. PCB de chargement scellé
* Le substrat d'emballage organique rigide est fait de résine époxy, résine BT, résine ABF. Sa valeur de production représente la majeure partie du substrat d'encapsulation IC. Le cte (coefficient de dilatation thermique) varie de 13 à 17 PPM / C.
(2) Carte souple scellée pour charger le PCB.
* Le substrat d'emballage est constitué d'un substrat flexible en résine Pi (polyimide), PE (polyester), Cte de 13 à 27 PPM / C.
(3) base en céramique
* avec de l'alumine, du Nitrure d'aluminium, du carbure de silicium et d'autres matériaux céramiques comme substrat d'encapsulation. Le cte est petit, 6 à 8 PPM / C.
Connu pour la technologie de connexion
(1) mode de dégagement pour engager la plaque porteuse
* Le fil d'or relie l'IC au PCB.
(2) panneau de jonction
* tab - fixation automatique des bandes
* la broche interne de la puce est connectée à la puce et la broche externe est connectée à la carte d'emballage.
(3) superposition cristal lié PCB.
* puce filp, la plaquette est un point convexe filp et est directement connectée au substrat IC.